經(jīng)過(guò)幾十年的發(fā)展,LED性能已經(jīng)得到了極大的進(jìn)步,由于它具有發(fā)光效率高,體積小,壽命長(zhǎng)等優(yōu)點(diǎn),將成為新一代照明光源,被人們公認(rèn)為是繼白熾燈之后照明領(lǐng)域的又一次重大革命。目前LED已經(jīng)在照明、裝飾、顯示和汽車(chē)等諸多領(lǐng)域得到了廣泛的應(yīng)用,而其應(yīng)用前景和應(yīng)用領(lǐng)域還在被不斷的開(kāi)發(fā)和擴(kuò)展。在LED的產(chǎn)業(yè)鏈中,封裝是十分重要的一個(gè)部分,它決定著LED芯片的光、熱、壽命和二次配光等特性。LED最初的封裝形式主要是如圖1的T1和T1—3/4。隨著芯片發(fā)光功率的提高,以及應(yīng)用領(lǐng)域的擴(kuò)大,其原有的封裝結(jié)構(gòu)無(wú)論是在散熱,還是在集成度上都不再撓滿(mǎn)足LED不斷發(fā)展的需要。伴隨著電子封裝技術(shù)的不斷發(fā)展,表面貼裝(SMT)封裝技術(shù)開(kāi)始成為L(zhǎng)ED封裝技術(shù)的主流,基于SMT技術(shù)封裝的器件稱(chēng)為SMD,表面貼裝的SMD—LED在集成度、散熱性和可靠性E都比以前的封裝結(jié)構(gòu)有很大的提高。
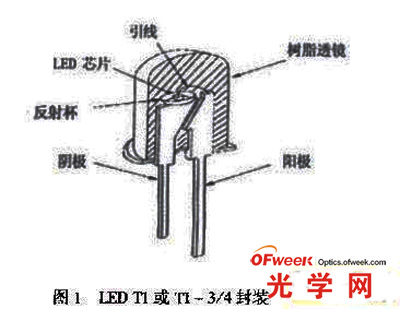
目前基于SMT的LED封裝主要用導(dǎo)線(xiàn)架(leadfame)和模塑料(moulding compound)形成的結(jié)構(gòu)作為芯片的封裝基體,導(dǎo)線(xiàn)架起熱傳導(dǎo)和電極引線(xiàn)的作用:而模塑料作為支撐結(jié)構(gòu),其結(jié)構(gòu)如圖2(a)所示。由于這種結(jié)構(gòu)比較復(fù)雜,限制了它不能做得很小。因此對(duì)更小尺寸的封裝(如、SMD0603,SMl30402),通常是將LED芯片直接貼裝在PEB板上.如圖2(b)。由于這種結(jié)構(gòu)沒(méi)有反射腔,其發(fā)光效率很低;該結(jié)構(gòu)存在的另一個(gè)問(wèn)題是PCB的導(dǎo)熱性能很差,例如FR4的導(dǎo)熱系數(shù)只有0.3W/k。這將會(huì)限制高亮度LED的工作功率。而隨著電子產(chǎn)品集成度的不斷提高,對(duì)小尺寸LED的封裝產(chǎn)晶需要越來(lái)越大。因此本文提出了一種結(jié)合MEMS工藝的硅基LEO芯片封裝技術(shù)。它具有封裝尺寸小的優(yōu)點(diǎn),同時(shí)解決了直接將芯片貼裝在PEB上而引起的發(fā)光效率低、熱阻高的缺點(diǎn)。文章首先討論了反射腔對(duì)LED芯片發(fā)光效率的影響,對(duì)反射腔的結(jié)構(gòu)參數(shù)與LED發(fā)光效率之問(wèn)的關(guān)系進(jìn)行了詳細(xì)的分析,最后設(shè)計(jì)了封裝工藝流程。
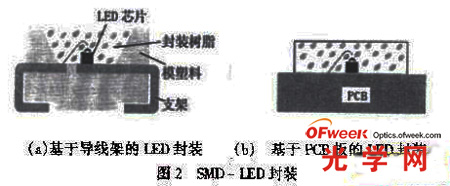
1 硅基封裝的LED光學(xué)特性分析
MEMS技術(shù)是隨著半導(dǎo)體和微電子技術(shù)的發(fā)展麗發(fā)展起來(lái)的一項(xiàng)新興的細(xì)微加工技術(shù),加工尺寸從毫米到微米數(shù)量級(jí),甚至亞微米的微小尺寸:其加T藝主要分為表面工藝和體工藝。基于硅基的體工藝又稱(chēng)為體硅工藝,體硅工藝呵以在硅基體上形成高深寬比的凹稽。由于MEMS的加工尺寸很小,因此利用該技術(shù)形成的微小凹槽作為L(zhǎng)ED芯片封裝的反射腔(如圖3),將會(huì)克服目前LED芯片直接封裝在PCB板上而引起發(fā)光效率低的問(wèn)題;同時(shí)由于硅具有良好的導(dǎo)熱特性,因此可以降低目前封裝中熱阻高的問(wèn)題,從而提高LED芯片的發(fā)光效率和可靠性。圖4(a)和(b)給出了當(dāng)LED芯片直接貼裝在PCB板上和貼裝在有凹槽的硅基上的發(fā)光特性。從圈中可以看出,LED貼裝在帶有凹槽的硅基上以后其發(fā)出光的發(fā)散性能得到了很大的改善,LED的發(fā)光強(qiáng)度提高了75%以上。

凹槽形成的反射腔對(duì)IED的發(fā)光特性起著顯著的改善,不同的反射腔形狀對(duì)LED的發(fā)光特性有幣同的影響。對(duì)圖3分析可得,反射腔的形狀主要由刪槽的開(kāi)口尺寸L,凹槽的深度h和發(fā)射角θ決定。利用TIacepro軟件建立如圖3所示的模型,分別改變L、h和θ的值,求出各自對(duì)應(yīng)情況下LED的光強(qiáng),就可以分析出反射腔的形狀與LED發(fā)光特性之間的關(guān)系。進(jìn)而為凹槽的足寸設(shè)計(jì)提供理論上的指導(dǎo)。
圖5為L(zhǎng)ED發(fā)射光與反射的反射角θ之間的關(guān)系,從圖中可看出當(dāng)反射角為52度的時(shí)候反射光強(qiáng)取得最大。從理論上講,硅凹槽反射角應(yīng)該設(shè)計(jì)為52度。但是,考慮到對(duì)(100)硅進(jìn)行腐蝕的時(shí)候,其(111)面和(100)面會(huì)自動(dòng)形成一個(gè)54.7度的角,而通過(guò)仿真分析結(jié)果可以計(jì)算。當(dāng)反射角為54.7度的時(shí)候。LED的反射光強(qiáng)只比反射角為52度的時(shí)候小12%,而且光強(qiáng)分布也比較接近。因此在腐蝕凹槽的時(shí)候可以直接采用硅的(100)面和(111)面形成角度作為反射角,這可以極大的簡(jiǎn)化加工工藝,降低制造成本,而且對(duì)LED光強(qiáng)的影響也不是很大。

圖6(a)和(b)分別給出了反射腔的深度h和開(kāi)口L與LED光強(qiáng)的關(guān)系,從圖中可得,反射腔的深度越深,光強(qiáng)越大;開(kāi)12t越小,光強(qiáng)越火。但是在反射角確定的情況一F,深度和開(kāi)r_l的寬度是相互制約的。當(dāng)深度一定的時(shí)候,開(kāi)口越小,則槽的底部會(huì)越小、,而槽的底部受芯片尺寸的約束。因此開(kāi)口有一個(gè)極限最小值。隅理,當(dāng)開(kāi)幾一定的時(shí)候,深度越深,底部幾寸越小,罔此深度有一個(gè)檄大值,所以在設(shè)計(jì)槽的K寸的時(shí)候應(yīng)該結(jié)合芯片的尺寸進(jìn)行綜合考慮。本文中所采用的芯片尺寸為0 4x0 4 x 0 15mm。
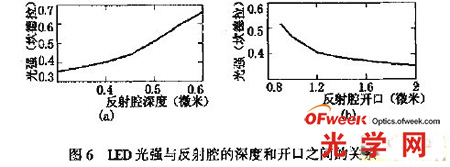
2 工藝流程設(shè)計(jì)
基于MEMS的LED芯片封裝主要包括兩個(gè)大的部分,第一個(gè)部分是加工帶有反射腔的硅基體;第二部分是LED芯片的貼片、引線(xiàn)等通用工藝。由于該封裝結(jié)構(gòu)的第二個(gè)部分和標(biāo)準(zhǔn)的LED封裝工藝相同,因此本文卡要詳細(xì)的介紹第一部分的主要工藝流程(如圖7)。

首先準(zhǔn)備一片具有(100)晶向的硅片(a);通過(guò)熱氧化在硅的表面形成層二氧化硅;光刻二氧化硅,形成需要的開(kāi)口尺寸和形狀(b);用KOH腐蝕硅基體形成需要的凹槽,通過(guò)腐蝕液的濃度和腐蝕時(shí)間控制槽的深度(c):除占表面殘余的二氧化硅;對(duì)硅基進(jìn)行背碰腐蝕,生成通孔(d);利用電鍍的方法在通孔內(nèi)沉積金屬導(dǎo)電材料(e);在硅的表面濺射會(huì)屬層作為反射面,光刻金屬表面和引線(xiàn)區(qū),形成封裝電極(f)。接下來(lái)就可以進(jìn)行LED的貼片等后續(xù)工藝。
3 結(jié)論
本文提出了一種基于MEMS工藝的LED芯片封裝技術(shù),利用Tracepro軟件仿真分析了反射腔的結(jié)構(gòu)參數(shù)對(duì)LED光強(qiáng)的影響,通過(guò)分析指出。利用各向異性腐蝕硅形成的角度作為反射腔的反射角,可以改善LED芯片的反光性能和發(fā)光效率。仿真結(jié)果顯示反射腔的深度越大,則反射效率越高,腔的開(kāi)口越小,反射效率越高。文章最后給出該封裝結(jié)構(gòu)的工藝流程設(shè)汁。通過(guò)分析表明,基于MEMS工藝LED封裝技術(shù)可以降低器件的封裴尺寸,提高發(fā)光效率。

