韓國(guó)首爾2021年5月6日 /美通社/ -- 日前,三星半導(dǎo)體已開發(fā)出了能將邏輯芯片(Logic Chip)和4枚高帶寬內(nèi)存(HBM,High Bandwidth Memory)封裝在一起的新一代2.5D封裝技術(shù)“I-Cube4”。

三星半導(dǎo)體I-Cube4技術(shù)
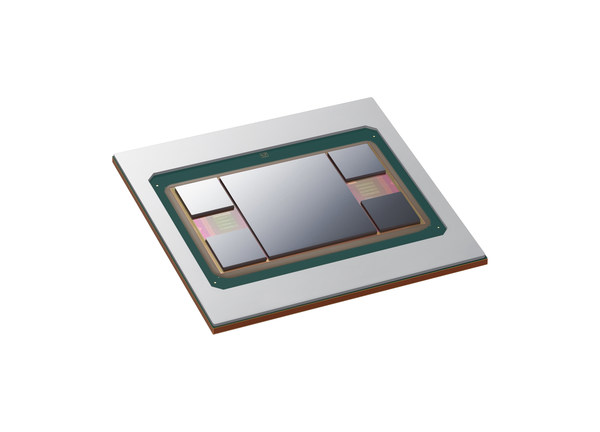
新一代2.5D封裝技術(shù)“I-Cube4”
“I-Cube4”全稱為“Interposer-Cube4”,作為一個(gè)三星的2.5D封裝技術(shù)品牌,它是使用硅中介層,將多個(gè)芯片排列封裝在一個(gè)芯片里的新一代封裝技術(shù)。
硅中介層(Interposer)指的是在高速運(yùn)行的高性能芯片和低速運(yùn)行的PCB板之間,插入的微電路板。 硅中介層和放在它上面的邏輯芯片、HBM通過(guò)硅通孔(TSV,Through Silicon Via)微電極連接,可大幅提高芯片的性能。使用這種技術(shù),不僅能提升芯片性能,而且還能減小封裝面積。因此,它將廣泛應(yīng)用于高速數(shù)據(jù)傳輸和高性能數(shù)據(jù)處理的領(lǐng)域,比如高性能計(jì)算(HPC,High Performance Computing)、人工智能/云服務(wù)、數(shù)據(jù)中心等。尤其是三星半導(dǎo)體采用了獨(dú)特的半導(dǎo)體制造工藝技術(shù),能防止超薄中介層在100微米(μm)狀態(tài)下變形,并采用不含密封劑的獨(dú)特結(jié)構(gòu),以改善散熱性能。
“專注于高性能計(jì)算領(lǐng)域的新一代封裝技術(shù)的重要性正在日益凸顯。”三星半導(dǎo)體(Foundry)市場(chǎng)戰(zhàn)略部總經(jīng)理姜文素專務(wù)表示,“基于‘I-Cube2’的量產(chǎn)經(jīng)驗(yàn),和‘I-Cube4’極具商業(yè)性的差別化技術(shù)競(jìng)爭(zhēng)力, 三星將盡快研發(fā)出搭載6個(gè)、8個(gè)HBM的新技術(shù),并將其推向市場(chǎng)。”值得一提的是,2018年,三星向市場(chǎng)展示了將邏輯芯片和2個(gè)HBM集成一體的“I-Cube2”解決方案;2020年,三星發(fā)布了 三星發(fā)布了新一代極具差異化的“X-Cube”技術(shù),可以將邏輯芯片和和SRAM進(jìn)行垂直3D堆疊。

