互連——有時(shí)是納米寬的金屬線,將晶體管連接到 IC 上的電路中——需要進(jìn)行大修。而隨著芯片廠向摩爾定律的外圍邁進(jìn),互連也正成為行業(yè)的瓶頸。
“大約 20-25 年來(lái),銅一直是互連的首選金屬。然而,我們正在達(dá)到銅的規(guī)模正在放緩的地步,”IBM 的 Chris Penny 上個(gè)月在IEEE 國(guó)際電子設(shè)備會(huì)議 (IEDM)上告訴工程師。“而且有機(jī)會(huì)找到替代導(dǎo)體。”
根據(jù) IEDM 2022 上的研究報(bào)告,釕是領(lǐng)先的候選材料,但它并不像將一種金屬換成另一種金屬那么簡(jiǎn)單。它們?cè)谛酒系男纬蛇^(guò)程必須顛倒過(guò)來(lái)。這些新互連將需要不同的形狀和更高的密度。這些新互連還需要更好的絕緣,以免信號(hào)消耗電容奪走它們的所有優(yōu)勢(shì)。
即使互連的位置也將發(fā)生變化,而且很快就會(huì)發(fā)生變化。但研究開始表明,這種轉(zhuǎn)變帶來(lái)的好處是要付出一定代價(jià)的。
釕、頂部通孔和氣隙(air gaps)
在銅的替代品中,釕受到追捧。但研究表明,用于構(gòu)建銅互連的舊配方對(duì)釕不利。銅互連是使用所謂的鑲嵌工藝構(gòu)建的。第一家芯片制造商使用光刻技術(shù)將互連的形狀雕刻到晶體管上方的介電絕緣層中。然后他們沉積了一個(gè)襯里(liner)和一個(gè)阻擋層(barrier)材料,以防止銅原子漂移到芯片的其余部分而弄臟東西。然后銅填充溝槽。事實(shí)上,它填充得太多了,所以多余的部分必須擦掉。
Penny 告訴 IEDM 的工程師,所有這些額外的東西,襯里和屏障,都會(huì)占用空間,占互連體積的 40-50%。因此,互連的導(dǎo)電部分正在變窄,尤其是在互連層之間的超細(xì)垂直連接中,增加了電阻。但是 IBM 和三星的研究人員已經(jīng)找到了一種方法來(lái)構(gòu)建不需要襯里或種子的緊密間隔、低電阻的釕互連。該工藝稱為間隔物輔助光刻蝕刻光刻(spacer assisted litho-etch litho-etch)或SALELE,顧名思義,它依賴于極紫外光刻的雙重幫助。它不是填充溝槽,而是從層或金屬中蝕刻出釕互連,然后用電介質(zhì)填充間隙。
研究人員使用又高又薄的水平互連實(shí)現(xiàn)了最佳電阻。然而,這會(huì)增加電容,犧牲掉好處。幸運(yùn)的是,由于 SALELE 構(gòu)建稱為通孔的垂直連接的方式——在水平互連的頂部而不是在它們的下方——細(xì)長(zhǎng)的釕線之間的空間可以很容易地充滿空氣,這是最好的絕緣體。對(duì)于這些又高又窄的互連,“增加氣隙的潛在好處是巨大的……多達(dá) 30% 的線路電容減少,”Penny 說(shuō)。
SALELE 工藝“提供了 1 納米工藝及更高工藝的路線圖,”他說(shuō)。
埋軌、背面供電
早在2024 年,英特爾就計(jì)劃徹底改變?yōu)樾酒系木w管供電的互連位置。該方案稱為背面功率傳輸,采用功率傳輸互連網(wǎng)絡(luò)并將其移動(dòng)到硅下方,因此它們從下方接近晶體管。這有兩個(gè)主要優(yōu)點(diǎn):它允許電流流過(guò)更寬、電阻更小的互連,從而減少功率損耗。它還為信號(hào)傳輸互連釋放了晶體管上方的空間,這意味著邏輯單元可以更小。
回看過(guò)去的發(fā)展,為了從 SoC 獲取電源和信號(hào),我們通常將最上層的金屬(距離晶體管最遠(yuǎn))連接到芯片封裝中的焊球(也稱為凸塊)。因此,要讓電子到達(dá)任何晶體管做有用的工作,它們必須穿過(guò) 10 到 20 層越來(lái)越窄和曲折的金屬,直到它們最終能夠擠過(guò)最后一層局部導(dǎo)線。
這種分配電源的方式從根本上說(shuō)是有損的。在路徑的每個(gè)階段,都會(huì)損失一些能量,而一些能量必須用于控制傳遞本身。在當(dāng)今的 SoC 中,設(shè)計(jì)人員的預(yù)算通常允許損耗導(dǎo)致封裝和晶體管之間的電壓降低 10%。因此,如果我們?cè)诠╇娋W(wǎng)絡(luò)中達(dá)到 90% 或更高的總效率,我們的設(shè)計(jì)就走上了正確的軌道。
從歷史上看,這種效率是可以通過(guò)良好的工程實(shí)現(xiàn)的——有些人甚至可能會(huì)說(shuō),與我們今天面臨的挑戰(zhàn)相比,這很容易。在當(dāng)今的電子產(chǎn)品中,SoC 設(shè)計(jì)人員不僅必須管理不斷增加的功率密度,而且還要處理隨著每一代新產(chǎn)品的出現(xiàn)而以急劇加速的速度損耗功率的互連。
損耗的增加與我們制造納米線的方式有關(guān)。該工藝及其相關(guān)材料可以追溯到大約 1997 年,當(dāng)時(shí) IBM 開始用銅而不是鋁制造互連,行業(yè)也隨之發(fā)生了轉(zhuǎn)變。在此之前,鋁線一直是很好的導(dǎo)體,但沿著 摩爾定律曲線再走幾步,它們的電阻很快就會(huì)過(guò)高,變得不可靠。銅在現(xiàn)代 IC 規(guī)模上更具導(dǎo)電性。但是,一旦互連寬度縮小到 100 納米以下,即使是銅的電阻也開始出現(xiàn)問(wèn)題。如今,最小的制造互連線約為20 納米,因此電阻現(xiàn)在是一個(gè)緊迫的問(wèn)題。
它有助于將互連中的電子想象成臺(tái)球桌上的全套球。現(xiàn)在想象一下,將它們從桌子的一端推向另一端。少數(shù)會(huì)在途中相互碰撞和彈跳,但大多數(shù)會(huì)沿直線行駛。現(xiàn)在考慮把桌子縮小一半——你會(huì)得到更多的碰撞,球會(huì)移動(dòng)得更慢。接下來(lái),再次縮小它,將臺(tái)球的數(shù)量增加十倍,你就會(huì)遇到芯片制造商現(xiàn)在面臨的情況。真實(shí)的電子不一定會(huì)發(fā)生碰撞,但它們彼此足夠接近以施加散射力,從而破壞通過(guò)電線的流動(dòng)。在納米尺度上,這會(huì)導(dǎo)致導(dǎo)線中的電阻大大增加,從而導(dǎo)致顯著的功率傳輸損耗。
增加電阻并不是一個(gè)新的挑戰(zhàn),但我們現(xiàn)在看到的每個(gè)后續(xù)工藝節(jié)點(diǎn)的增加幅度是前所未有的。此外,管理這種增加的傳統(tǒng)方法不再是一種選擇,因?yàn)榧{米級(jí)的制造規(guī)則施加了很多限制。我們可以任意增加某些電線的寬度以對(duì)抗增加的阻力的日子已經(jīng)一去不復(fù)返了。現(xiàn)在設(shè)計(jì)人員必須堅(jiān)持某些特定的線寬,否則芯片可能無(wú)法制造。因此,該行業(yè)面臨互連電阻較高和芯片空間較小的雙重問(wèn)題。
還有另一種方法:我們可以利用位于晶體管下方的“空”硅。Imec也率先提出了一種稱為“埋入式電源軌”或 BPR 的制造概念。該技術(shù)在晶體管下方而不是上方建立電源連接,目的是創(chuàng)建更粗、電阻更小的軌道,并為晶體管層上方的信號(hào)傳輸互連騰出空間。
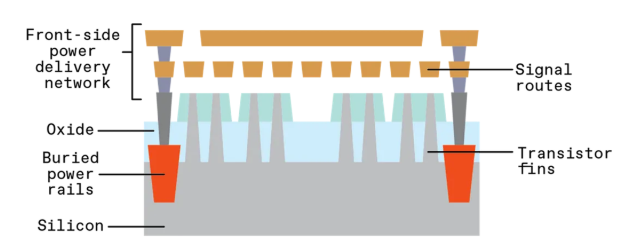

要構(gòu)建 BPR,您首先必須在晶體管下方挖出深溝,然后用金屬填充。在你自己制造晶體管之前你必須這樣做。所以金屬的選擇很重要。這種金屬需要承受用于制造高質(zhì)量晶體管的加工步驟,溫度可達(dá) 1,000 °C 左右。在那個(gè)溫度下,銅是熔化的,熔化的銅會(huì)污染整個(gè)芯片。因此,我們對(duì)具有更高熔點(diǎn)的釕和鎢進(jìn)行了實(shí)驗(yàn)。
由于晶體管下方有很多未使用的空間,您可以將 BPR 溝槽做得又寬又深,這非常適合傳輸功率。與直接位于晶體管頂部的薄金屬層相比, BPR 的電阻可以降低 1/20 到 1/30。這意味著 BPR 將有效地允許您為晶體管提供更多功率。
此外,通過(guò)將電源軌從晶體管的頂部移開,您可以為信號(hào)傳輸互連騰出空間。這些互連形成基本電路“單元”——最小的電路單元,例如 SRAM 存儲(chǔ)器位單元或我們用來(lái)組成更復(fù)雜電路的簡(jiǎn)單邏輯。通過(guò)使用我們釋放的空間,我們可以將這些單元縮小 16% 或更多,最終可以轉(zhuǎn)化為每個(gè)芯片上更多的晶體管。即使特征尺寸保持不變,我們?nèi)詴?huì)將摩爾定律更進(jìn)一步。
不幸的是,看起來(lái)僅僅掩埋局部電源軌是不夠的。您仍然必須從芯片的頂部向下向這些電源軌傳輸電源,這會(huì)降低效率和一些電壓損失。
幸運(yùn)的是,Imec 同時(shí)開發(fā)了一種補(bǔ)充解決方案以進(jìn)一步改善功率傳輸:將整個(gè)功率傳輸網(wǎng)絡(luò)從芯片的正面移至背面。這種解決方案被稱為“背面功率傳輸”,或更通俗地稱為“背面金屬化”。它涉及將晶體管下方的硅減薄到 500 nm 或更小,此時(shí)您可以創(chuàng)建納米尺寸的“硅通孔”或 納米 TSV。這些是垂直互連,可以通過(guò)硅的背面連接到埋入軌道的底部,就像數(shù)百個(gè)微型礦井一樣。
3D IC的麻煩
在IEDM 2022上,Imec 的研究人員想出了一些方法來(lái)使背面電源更好地工作,方法是找到移動(dòng)電源傳輸網(wǎng)絡(luò)端點(diǎn)(稱為埋入電源軌)的方法,使其更靠近晶體管而不破壞這些晶體管的電子特性. 但他們也發(fā)現(xiàn)了一個(gè)有點(diǎn)麻煩的問(wèn)題,在 3D 堆疊芯片中使用時(shí),背面電源可能會(huì)導(dǎo)致熱量積聚。
首先是好消息:當(dāng) imec 研究人員探索埋入式電源軌和晶體管之間需要多少水平距離時(shí),答案幾乎為零。它需要一些額外的處理周期來(lái)確保晶體管不受影響,但他們表明你可以在晶體管溝道區(qū)域旁邊構(gòu)建軌道 - 盡管仍然低于它幾十納米。這可能意味著更小的邏輯單元。
現(xiàn)在是壞消息:在單獨(dú)的研究中,imec 工程師模擬了同一個(gè)未來(lái) CPU 的幾個(gè)版本。有些擁有當(dāng)今使用的那種電力傳輸網(wǎng)絡(luò),稱為前端電力傳輸,其中所有互連,包括數(shù)據(jù)和電源,都構(gòu)建在硅之上的層中。有些有背面供電網(wǎng)絡(luò)。一個(gè)是兩個(gè) CPU 的 3D 堆棧,底部有背面電源,頂部有正面。
二維 CPU 的仿真證實(shí)了背面電源的優(yōu)勢(shì)。例如,與前端輸送相比,它將電力輸送的損失減少了一半。瞬態(tài)電壓降不太明顯。此外,CPU 面積縮小了 8%。然而,背面芯片最熱的部分比正面芯片最熱的部分高約 45%。可能的原因是背面電源需要將芯片減薄到需要將其粘合到單獨(dú)的硅片以保持穩(wěn)定的程度。該鍵充當(dāng)熱流的屏障。

研究人員測(cè)試了一個(gè)場(chǎng)景,其中一個(gè)帶有背面供電網(wǎng)絡(luò)的 CPU [底部灰色] 綁定到另一個(gè)具有前端供電網(wǎng)絡(luò) [頂部灰色] 的 CPU。
真正的問(wèn)題出現(xiàn)在 3D IC 上。頂部 CPU 必須從底部 CPU 獲取能量,但通往頂部的漫長(zhǎng)旅程會(huì)產(chǎn)生后果。盡管底部 CPU 的壓降特性仍優(yōu)于前端芯片,但頂部 CPU 在這方面的表現(xiàn)要差得多。3D IC 的電源網(wǎng)絡(luò)消耗的功率是單個(gè)前端芯片網(wǎng)絡(luò)消耗功率的兩倍多。更糟糕的是,熱量無(wú)法很好地從 3D 堆棧中逸出,底部芯片最熱的部分幾乎是單個(gè)前端 CPU 的 2.5 倍。頂級(jí) CPU 溫度更低,但降幅不大。
不可否認(rèn),3D IC 模擬有些不切實(shí)際,imec 的Rongmei Chen在 IEDM 上告訴工程師。將兩個(gè)其他方面完全相同的 CPU 堆疊在一起是不太可能發(fā)生的情況。(將內(nèi)存與 CPU 堆疊在一起更為常見。)“這不是一個(gè)非常公平的比較,”他說(shuō)。但它確實(shí)指出了一些潛在的問(wèn)題。
背面 PDN 和 BPR 最終將不得不做的不僅僅是有效地傳輸電子。他們將不得不精確控制電子的去向以及有多少電子到達(dá)那里。當(dāng)涉及到芯片級(jí)電源設(shè)計(jì)時(shí),芯片設(shè)計(jì)人員不希望后退多步。因此,我們必須同時(shí)優(yōu)化設(shè)計(jì)和制造,以確保 BPR 和背面 PDN 優(yōu)于——或至少兼容——我們今天使用的節(jié)能 IC 技術(shù)。
計(jì)算的未來(lái)取決于這些新的制造技術(shù)。無(wú)論您是擔(dān)心數(shù)據(jù)中心的冷卻費(fèi)用還是每天必須為智能手機(jī)充電的次數(shù),功耗都是至關(guān)重要的。隨著我們繼續(xù)縮小晶體管和 IC,供電成為一項(xiàng)重大的片上挑戰(zhàn)。如果工程師能夠克服隨之而來(lái)的復(fù)雜性,BPR 和背面 PDN 可能會(huì)很好地應(yīng)對(duì)這一挑戰(zhàn)。
更多信息可以來(lái)這里獲取==>>電子技術(shù)應(yīng)用-AET<<


