在CCM PFC中,通過改善MOSFET技術可以減少開關損耗,甚至可通過SiC技術改善升壓二極管來減少MOSFET的開關損耗。
功率因數(shù)是一個數(shù)值參數(shù),常用來衡量提供給交-直流變換器的輸入功率的質(zhì)量。最近功率因數(shù)補償(PFC)的標準,如IEC 61000-4-3,已經(jīng)大規(guī)模應用到許多系統(tǒng)當中,并且在交-直流電力系統(tǒng)市場中表現(xiàn)出增長態(tài)勢。為了能夠達到這些標準,設計人員可以運用被動式與主動式PFC設計技術,這種設計技術必須符合電力系統(tǒng)中的電網(wǎng)諧波標準。
方法之一就是運用被動PFC的低成本解決方案,但是這一方案需要一個笨重的大體積LC濾波器。主動PFC廣泛用于減少系統(tǒng)濾波器電感線圈的尺寸與重量。因此,增加效率與功率密度是主動PFC方案的關鍵設計因素。對于大功率交-直流變換器來說,連續(xù)傳導模式(CCM)升壓型主動PFC拓撲結(jié)構(gòu)更受歡迎。與非連續(xù)傳導模式(DCM)和臨界傳導模式CRM)不同的是,CCM PFC產(chǎn)生的波紋電流更小,可簡化EMI濾波器設計以及保持小負荷下的穩(wěn)定性。因此CCM PFC不僅廣泛用于服務器與遠程通信的電源供給,而且可用于平面顯示器的電源供給。
按照功率變換器PFC改善功率密度的設計趨勢,設計人員必須減少系統(tǒng)損耗與整個系統(tǒng)的尺寸、重量,或者增加開關頻率,集成有源元件。
一種新型的MOSFET/二極管組合可以實現(xiàn)較高的功效,減少開關損耗。并且通過降低MOSFET的導通電阻,提高其開關速度完成CCM PFC控制器的設計。上述性能的改善,都離不開一種具有低反向恢復電荷(QRR)的SiC肖特基二極管。下面在一個400W CCM PFC應用當中,將其與常用的硅Si二極管/平面型MOSFET的組合方式進行比較,可看出本文所述MOSFET/二極管組合的優(yōu)點。
與DCM升壓電感的恒流相比,CCM下的PFC具備更多優(yōu)勢。通過EMI濾波的電流要比DCM或CRM中小得多,因此這些優(yōu)勢在大功率設計中更為明顯。在一般情況下,MOSFET的功率損耗通常由它的開關損耗決定,事實上開關損耗是由分立升壓二極管的反向回縮特性所引起的,而上述這個根源取決于工作電流與二極管溫度。這些因素導致了二極管與MOSFET功率損耗的增加,進而影響到變流器的性能。
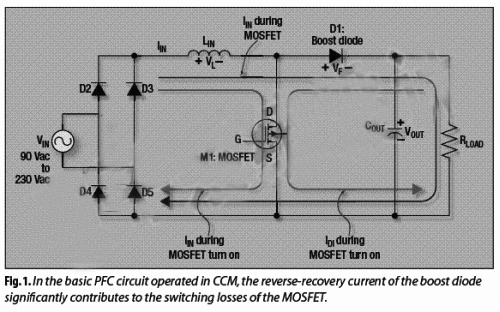
圖1與圖2所示為CCM PFC的工作情況,包括電流和電壓波形,可看出低QRR對PFC二極管的重要性。一開始,二極管D1引入輸入電流,同時還有二極管中的少量積累電荷。在開關導通的過程中,MOSFET M1導通,二極管D1關斷。巨大的導通電流流過MOSFET,除了經(jīng)整流的輸入電流以外還包括D1的反向恢復電流與放電電流。一般情況下,電流的變化率通過M1的封裝電感及其他存在于外部回路的寄生電感進行限制。二極管電流波形的負值區(qū)域便是反向恢復電荷QRR,其中時間間隔長度(t0到t2)是反向恢復時間tRR。在t0與t1之間時,二極管保持正向偏置,因此MOSFET電壓為VOUT+VF。在t1時間,p-n結(jié)附近的積累電荷被耗盡。二極管反向電流持續(xù)存在,直至消除所有殘留的少量積累電荷。在t2時間,這些電流基本上為零,二極管在反向偏置條件下達到穩(wěn)態(tài)。[1]這些由硅Si二極管反向恢復特性所引起功率損耗,限制了CCM PFC的功效與開關頻率。
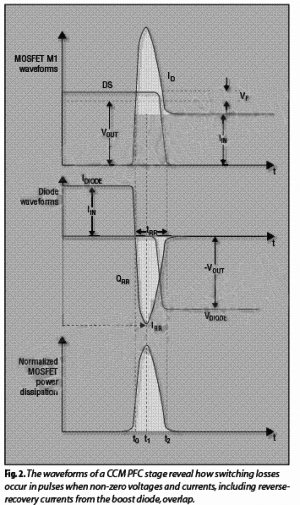
CCM PFC中最值得關注的是減少MOSFET與升壓二極管的傳導性與開關損耗。如果您想設計一高性能的、且具有較小尺寸與較高的工作頻率的CCM PFC,其MOSFET要求如下:較小的導通電阻以減少傳導損耗;低CGD以減少開關損耗;低QG以減少柵極驅(qū)動功率;低熱阻。同樣,升壓二極管要求如下:tRR時間短以減少MOSFET導通損耗;低QRR以減少二極管開關損耗;小VF以減少傳導損耗;溫和的反向回縮特性以減少EMI;低熱阻。
MOSFET比較
圖3所示為Fairchild Semiconductor(飛兆半導體)公司的SuperFET 600-V MOSFET的橫截面,它運用了電荷平衡技術(右),另一個是傳統(tǒng)的平面型MOSFET(左)。一開始便引起我們注意的差異是SuperFET元器件內(nèi)部的加厚p型柱。SuperFET所提供的低導通電阻所起的作用(>90%)在于N-型漂移區(qū)。加厚P型柱的作用是限制MOSFET輕摻雜外延區(qū)的電場。相比傳統(tǒng)的平面MOSFET,n-型外延層的電阻率急劇減少,同時保持擊穿電壓不變。高壓MOSFET的導通電阻降低后,可比傳統(tǒng)的

MOSFET的開關特性隨著它的寄生電容的改變而改變。例如高壓SuperFET有源面積的減小直接導致輸入電容的減小,因此減少了柵極電荷。這導致導通延遲時間變短,需要的驅(qū)動功率變小。當我們比較SuperFET與平面MOSFET的電容時,VDS一接近10V(對SuperFET來說)CGD的值急速地減小,在導通的開關瞬態(tài),較小的輸出電容可減小放電損耗。因為這項技術的目的是使元件能夠承受住高速開關瞬態(tài)下的電壓(dv/dt)與電流(di/dt),這些元器件能夠在較高的頻率下可靠地工作,由于折算電阻的影響其品質(zhì)因數(shù)(FOM)只相當于同等級平面器件的三分之一。
使用SuperFET的好處之一是它的低通導電阻減少了功率損耗。這允許設計人員可以不使用昂貴的冷卻系統(tǒng)并且減少了散熱器的尺寸。它的低柵極電荷同樣使得它更容易且更有效地在高頻下驅(qū)動。這些特性都減少了系統(tǒng)的整體功率損耗。
二極管比較
硅Si肖特基二極管常作為小于300V的中低壓應用,因為在漏電流與正向?qū)▔航当3衷谌菰S的等級之內(nèi)時,它們顯示出很低的開關損耗與正的溫度系數(shù)。然而這類二極管對于高壓應用來說并不理想,因為高壓應用中漏電流與正向?qū)▔航狄叩亩唷1容^起來,SiC肖特基二極管在高壓領域更有吸引力。因為碳化硅的擊穿電場是硅的10倍。此外SiC的寬帶隙容許較高的工作溫度[2]。另外,在開關狀態(tài)轉(zhuǎn)換過程中,SiC肖特基二極管沒有反向恢復電流,這是因為它沒有額外的少數(shù)載流子。雖然寄生結(jié)電容確實產(chǎn)生了位移電流但可以忽略不計。因此在CCM PFC應用中,由于SiC肖特基二極管優(yōu)越的反向回縮特性,可不依賴于元器件的溫度與正向傳導特性,使得SiC肖特基二極管與硅Si二極管相比能夠提供更大的功效。[3-7]
圖4所示為SiC肖特基二極管和硅二極管的反向恢復特性對比。在這個例子中,F(xiàn)airchild公司的速復硅二極管按照tRR和VF區(qū)分為三種類型,隱形二極管具有快速反向回縮特性,超高速元件擁有最低的VF值。通過25℃時的反向恢復測試,硅二極管中出現(xiàn)了大量的反向恢復電流,而SiC肖特基二極管僅僅在電容中出現(xiàn)由p-n結(jié)反向偏壓形成的位移電流。SiC肖特基和硅二極管的V-I特性曲線均為溫度的涵數(shù)。正向電流較低時,溫度升高時VF減小。在這個區(qū)域內(nèi),可觀察到肖特基勢壘兩端的電流呈指數(shù)特性。當正向電流增加時,二極管的體電阻決定其正向偏置特性,并且肖特基二極管的VF隨溫度上升而增大。SiC肖特基二極管的帶隙越大,本征載流子濃度和運行結(jié)溫就越高。就原理而論,硅二極管的最高結(jié)溫為150℃[8],而SiC肖特基二極管有可能達到600℃。運行溫度的增加允許其重量、體積、成本和熱量管理系統(tǒng)復雜性的全面減小。
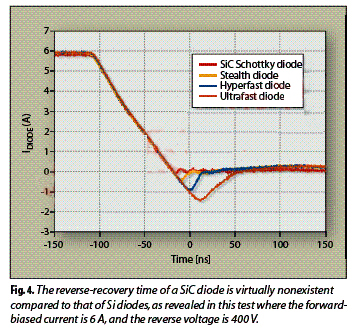
另外,由于SiC肖特基二極管具有正溫度系數(shù),因此與硅二極管相比,它們更適于在較高的電壓下并聯(lián)運行。SiC肖特基二極管的低QRR不僅減少二極管的開關損耗,而且能減少MOSFET的導通損耗,使CCM PFC達到很高的能效。就算SiC二極管中的正向電流比硅二極管大,上述情況仍然成立。在MOSFET的導通瞬間,SiC肖特基二極管優(yōu)越的溫度特性可以降低漏電流峰值。并且設計人員可以使用較小的MOSFET來減低成本。
MOSFET/SiC二極管集成模塊
使用高壓SuperFET和一個SiC肖特基二極管組成的CCM PFC測試電路,具體地說,將Fairchild公司的600-VN溝道SuperFET MOSFET(FCA20N60)和6A SiC肖特基二極管組合,與平面型MOSFET(FQA24N50)和超高速二極管(RURP860)組合進行比較,比較內(nèi)容為開關損耗與功效。此測試電路的工作頻率100kHz,輸出電壓和電流分別為400V與1A。導通時SuperFET的柵電阻是12Ω,關斷時為9.1Ω。
分別測量MOSFET與二極管的電壓和電流來估算元件的功率損耗。并且量測輸入與輸出功率來計算系統(tǒng)的功效。滿負荷下,MOSFET信號波形由高電平向低電平躍遷時,輸入為110Vac,開關損耗通過VDS與ID的交叉區(qū)來測量。SuperFET開關時間大大地降低。平面型MOSFET的關斷損耗為159μJ,SuperFET為125μJ(減小34μJ或21%)。
滿負荷下,MOSFET信號波形由低電平向高電平躍遷時,輸入為110Vac,在二極管與MOSFET中有5.3A的反向恢復電流通過(除電感電流以外),此電流來自于升壓硅二極管。然而SiC肖特基二極管僅僅有1.2A的位移電流,可忽略不計。所以使用硅二極管時MOSFET的開通損耗為73.8μJ,使用SiC肖特基二極管時為28.9μJ(減少44.9μJ或61%)。
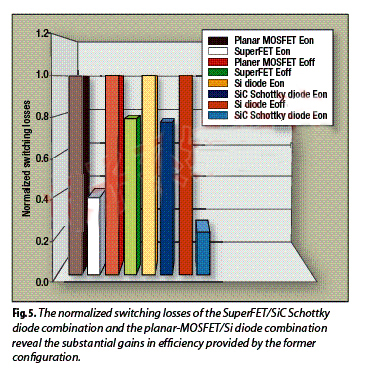
在此次測試中,滿負荷下二極管信號波形由高電平向低電平躍遷時,輸入為110Vac。硅二極管中的反向恢復電流峰值為5.3A,反向恢復電壓峰值為500V。在同樣情況下,SiC肖特基二極管中的反向恢復電流可忽略不計,反向恢復電壓為450V。這兩種MOSFET類型的不同動態(tài)特性形成不同的MOSFET開通損耗。由于SiC二極管的恢復時間為零,因此SiC肖特基二極管的關斷損耗要比硅二極管低大約78%。
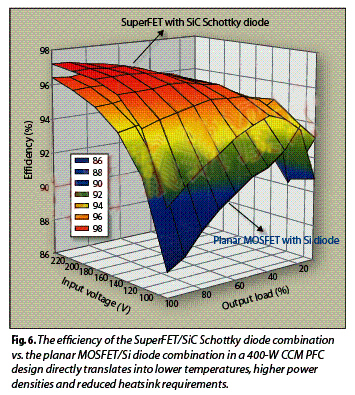
圖5所示為開關損耗一覽,將SuperFET與SiC肖特基二極管組合后,可有效減少開關損耗。與平面型MOSFET相比,SuperFET能夠降低21%的關斷損耗。與速復二極管相比,SiC二極管能夠降低61%的開通損耗。當然,使用SiC肖特基二極管代替速復硅二極管與傳統(tǒng)的MOSFET組合,可以使MOSFET的關斷損耗降低78%,使其開通損耗降低23%。圖6所示為不同器件組合的功效測量結(jié)果。從圖中不難看出,在整個運行范圍中,MOSFET/SiC肖特基二極管的組合對提高功效起到了很重要的作用。甚至在大電流時(滿負荷低輸入電壓),改善的效果也很明顯,在同樣的情況下,MOSFET/SiC肖特基二極管組合的功效比傳統(tǒng)器件高出4%。對于開關損耗的分析證明,通過減小SiC肖特基二極管的反向恢復電荷來減低MOSFET開通損耗,是提高功效的主要途徑。最終結(jié)果是增加了CCM PFC下的功率密度。

