三十多年來,本體硅(bulk silicon)MSOFET工藝一直是晶體管器件所采用的主要CMOS工藝。我們非常熱衷于從縮小晶體管來提高密度和性能。在相同的成本上具有更快的速度、更大的內(nèi)存,是一件多么美妙的事情!越來越多的在工藝上的進步目前已能使完好的特征尺寸升級到90nm技術(shù)節(jié)點。然而,在深層納米尺寸滿足對漏電和性能的需要卻迅速地把傳統(tǒng)的晶體管逼入困境。
要使性能得到繼續(xù)的升級,人們正在采用新型材料和結(jié)構(gòu)來改善傳統(tǒng)的CMOS工藝。在超過32nm及以上的技術(shù)上,面對著功率性能前所未有的挑戰(zhàn),晶體管可能通過一系列的跳躍式創(chuàng)新得到發(fā)展嗎?盡管答案仍在探索之中,從金屬/高K柵堆疊、新型應(yīng)變硅到多柵器件等等新型材料和器件結(jié)構(gòu)競相發(fā)起這場革命。
當晶體管忙于開關(guān)時,微小的晶體管會消耗能量,因此依靠封裝更多的晶體管來提高密度并不湊效。不同工藝的能耗可通過動態(tài)功率來測得:
動態(tài)功率=CVdd2F
C=器件電容
Vdd=電源電壓
F=開關(guān)頻率
此外,作為一種并不完全的開關(guān),即使當它們關(guān)閉時也會漏電,這一點對待機功耗起到作用。
待機功耗=I漏電xVdd
I漏電=漏電電流
當你把10億只晶體管集成到一個100mm2面積的裸片上時,功耗就會迅速增加,且情況正變得更糟。對功耗進行管理是當前從系統(tǒng)、設(shè)計到工藝的所有人員的壓倒一切的活動。降低功耗并不難,難在你要跟性能進行平衡。
短溝道靜電學(xué)
由于工藝和材料的限制,在我們急于壓縮門柵和溝道尺寸之時,源/漏結(jié)點和門柵電介質(zhì)的升級卻不沒能跟上不能步伐。這導(dǎo)致短溝道靜電更加不足,當器件關(guān)閉時,門柵對源-漏的漏電影響更弱(也就是亞門限模式)。隨著在門柵與超出正常界線的源/漏之間的溝道電荷分配的增加(如圖1),會導(dǎo)致亞門限漏電增加,這點可從門限電壓出乎我們意料的降低中反映出來(圖2)。
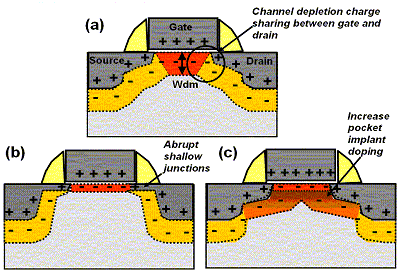
圖1:器件電荷分配的影響有以下三種情況:(a)統(tǒng)一的溝道滲雜;(b)超淺結(jié);(c)高的容器植入摻雜。
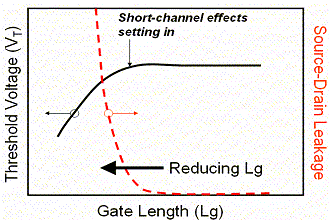
圖2:以門柵極長度(Lg)為函數(shù)的器件閥值電壓(VT)及源/漏漏電的曲線。對于更小的Lg,短溝道效應(yīng)的開始造成VT減少。這一點同時伴隨著源?漏漏電的指數(shù)增長。
要緩減這一狀況,我們可使源和漏結(jié)點(xj)更淺且更陡(圖1b),或者通過增加結(jié)點周圍的溝道摻雜,來屏蔽靜電對源/漏的影響(降低耗盡寬度)(1c)。由于低阻抗超淺結(jié)點特別具有挑戰(zhàn)性,我們在進行伸縮時,大量的增加溝道摻雜來抑制漏電。增加摻雜會帶來兩種不良的副作用,會導(dǎo)致開關(guān)電流(Ion/Ioff)比急劇降低,該比值對于好的開關(guān)應(yīng)被最大化。通過實現(xiàn)低亞門限擺幅(S),靜電的開關(guān)比可(圖3)以最大化。一個簡單的一維MOS電容器的S描述忽略了由[1]給出的源/漏的電荷分配的影響:
S = 1/(亞門限斜率) = 2.3 kT/q (1 + Cdm/Cox) ~ 2.3 kTq (1 + 3Tox/Wdm)
T = 溫度
Cdm = 損耗電容
Cox =門柵電容
Tox =門柵電介質(zhì)厚度。
Wdm = 溝道損耗寬度
取決于柵極與溝道之間的電容耦合(Cdm/Cox),S測量門柵在關(guān)閉與打開溝道之間擺動的良好程度。增加溝道摻雜,而不使門柵電介質(zhì)厚度(Tox)相應(yīng)地減少,會導(dǎo)致S的增加。對于短溝道MOSFET" title="MOSFET">MOSFET,S也可通過門柵與短溝道之間的電荷分配得到增加,這也會受到終接電壓的影響。顯然,在維持良好短溝道控制時,如果缺乏溝道摻雜(Cdm~0),S值就最小(例如,最小化的源/漏門柵電荷分配)。如果不能完全自由地伸縮門柵電介質(zhì)厚度及結(jié)點深度,由于短溝道控制在那時變得極度依賴于越來越多的溝道摻雜,從而使S最小化對于體MOSFET而言就是一個令人畏懼的事情。
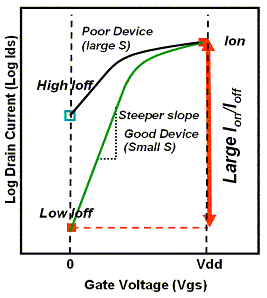
圖3:具有匹配的電流,但具有不同的亞門限斜率的兩個器件之間的亞門限行為。
摻雜的另一個高代價是損傷傳輸速度。具有高溝道摻雜的器件被迫在更高門柵電場進行工作。這增加了具有門柵電介質(zhì)界面溝道載流子的散射,導(dǎo)致載流遷移率(圖4)和折衷的驅(qū)動性能的大幅下降。
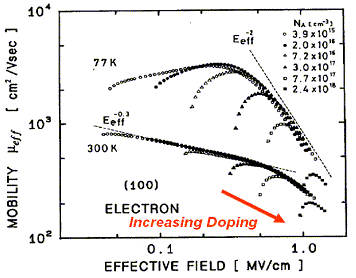
圖4:對于不同溝道摻雜水平(NA)和溫度[2], MOSFET的電子遷移率是有效電場的函數(shù)。
超薄體器件
絕緣上硅(SOI)的異質(zhì)結(jié)構(gòu)為建造具有超薄硅體(硅厚度Tsi《10nm)(圖5)的器件創(chuàng)造了機會。通過由硅電介質(zhì)界面建立的天然靜電屏障,超薄SOI提供一種控制短溝道效應(yīng)的可選手段。由于受到超薄硅溝道的限制,源/漏結(jié)點深度現(xiàn)在就自然的變淺了。
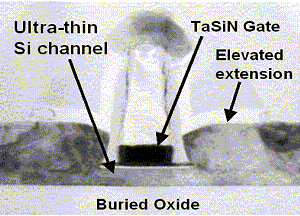
圖5所示為一個具有金屬門柵和高K門柵電介質(zhì)的40nm-Lg全耗盡超薄(UT)SOI器件的透射電子顯微鏡(TEM)圖像。
與體晶體管不同,超薄SOI通過它們的體結(jié)構(gòu)來改進短溝道靜電效應(yīng),這一結(jié)構(gòu)減少了它們對溝道摻雜的依賴(圖6)。要采用溝道摻雜工藝來控制最小體晶體管中的漏電,防止其增長到不可控制的水平,這可通過采用薄Si來計算。由于損耗電容Cdm保持為最小值,通過減少S,可使得開/關(guān)電流的比率最大化 。
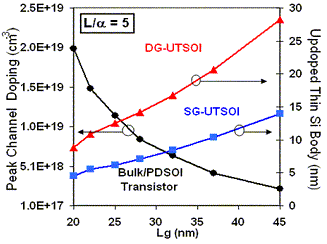
圖6 所示為體MOSFET與超薄(UT)SOI所需的溝道摻雜之間的比較,以為給定Lg實現(xiàn)相同的短溝道控制(SG: 單一門柵,;DG: 雙門柵;PD-SOI: 部分損耗的 SOI)。
由于具有低溝道摻雜或不具溝道摻雜,這樣一個器件的門限電壓可主要通過門柵和電介質(zhì)材料來確定。由于等效的溝道損耗寬度?Wdm?比Tsi更大,因此,溝道是完全損耗的。通過放棄使用溝道摻雜物來控制短溝道效應(yīng),完全損耗的SOI器件能在減少的有效電場進行操作,在此,載流子遷移率更高(圖7)。
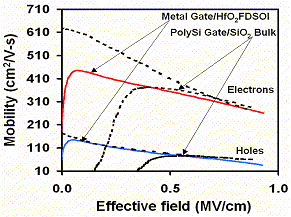
圖7與等效的體晶體管相比,在具有更高遷移率的情況下,F(xiàn)D-SOI器件能以更低的有效電場工作。
取消溝道摻雜也減少了因隨機摻雜物波動引起的可變性。盡管在薄Si體厚度中有變化,與有摻雜體器件相比,F(xiàn)D-SOI器件顯示非常大地改進了器件與器件之間的匹配性能 (圖8)。這對于存儲容量不斷擴大的SRAM和受隨機變化影響的模擬技術(shù)而言則是非常重要的。
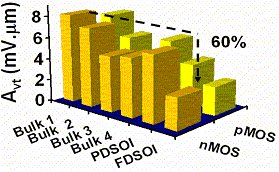
圖8: FD-SOI與其它來自不同工藝的等效器件之間的失配比較(PDSOI:部分損耗的SOI)。
FD-SOI對浮體效應(yīng)的免疫性和最小化源/漏(S/D)結(jié)電容(Cj)以及跟金屬門柵和高K電介質(zhì)的結(jié)合,為低功耗和混合信號應(yīng)用提供了多種優(yōu)點,這些優(yōu)點包括降低的門漏電、良好的線性及低噪音[3](圖9)。
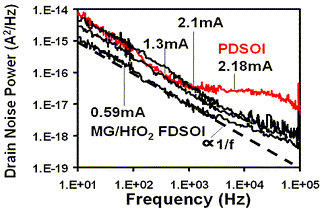
圖9:與PDSOI器件相比,F(xiàn)D-SOI 器件顯示出更低的噪音。
應(yīng)變硅與增強傳輸特性
通過改善短溝道靜電的影響,降低了漏電、可變性及待機功耗。在某種程度上,它甚至改進了傳輸特性。然而, 要充分地降低動態(tài)功耗,而不必對漏電和性能作出折衷,就需要進一步增強傳輸特性。
由于動態(tài)功耗的二次方程式取決于Vdd (CVdd2F), 調(diào)整電源電壓是降低動態(tài)功率的最有效的方法。然而,如果門限電壓并沒有降低, 那么,Vdd的減少會導(dǎo)致晶體管中載流子密度(Qi)的大量損耗。
Qi(max) ~ Cox (Vdd-VT)
由于源/漏漏電呈指數(shù)地依賴于VT(圖2), 要調(diào)整VT就變得十分受到限制。此外,Cox的增加受到Tox的限制, 這一點最終受到門漏電和電介質(zhì)可靠性的限制。 當晶體管被堆疊以減少漏電時,一個類似的問題又出現(xiàn)了(圖10)。在邏輯模塊中的堆疊器件要減少其最大門柵過驅(qū)動的虛擬節(jié)點(Vdd‘-VT),因此,它們會隨著堆疊的增加變得更加弱。
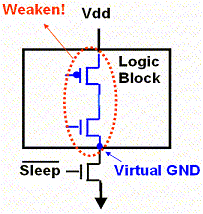
圖10:晶體管堆疊對于實現(xiàn)“休眠”晶體管和電源門控技術(shù)已很常見。
要恢復(fù)相同的電流(I=Qi速率),載流子速率(或遷移率)必須得到增加以彌補Qi損耗。這正是遷移率隨應(yīng)變硅的優(yōu)越而得到增強之處。
隨著英特爾宣布,把應(yīng)力襯底材料和SiGe源/漏的結(jié)合進入90nm 技術(shù)節(jié)點,針對不同工藝的應(yīng)變硅已應(yīng)用到產(chǎn)品之中,被集成以增強他們的CMOS器件[4]。此外,人們還研究了從雙壓力襯底到襯低應(yīng)變硅的許多其它的方法。推動晶體管性能的根本目標是相同的:實質(zhì)性地增強遷移率,我們能在維持電路性能的同時,為降低動態(tài)功耗,而對驅(qū)動電流進行折衷(圖11)。
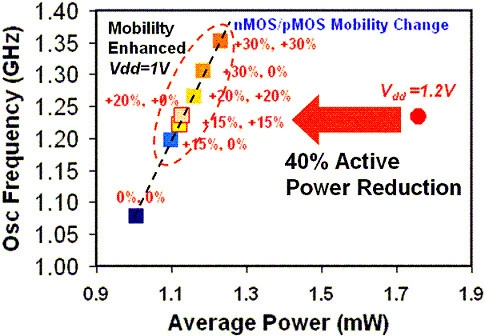
圖11: 振蕩器電路模擬表明:在保持頻率性能的同時提高遷移率,通過把Vdd從1.2V 降到1V,可以減低平均功耗。
這就意味著提高遷移率?傳統(tǒng)的高性能晶體管的發(fā)展推動力?也開始向低功耗管理這個前沿轉(zhuǎn)移,因此,要研究獲得更高遷移率的縮放路徑。
通過工藝技術(shù)把現(xiàn)有各種應(yīng)力材料的優(yōu)勢結(jié)合起來并加以增強,是進一步提高性能的自然方法(圖12, 13) [5]。最終,除了應(yīng)變硅外,可能還需要具有更高遷移率的非硅材料,從而引領(lǐng)工藝及設(shè)計工程師努力開發(fā)新工藝并解決各種設(shè)計復(fù)雜性問題。

圖12:直接制作在在絕緣體上的應(yīng)變硅(襯底應(yīng)變)與嵌入式SiGe源?漏及襯底應(yīng)力材料的結(jié)合,可以實現(xiàn)混合應(yīng)變PMOSFET。
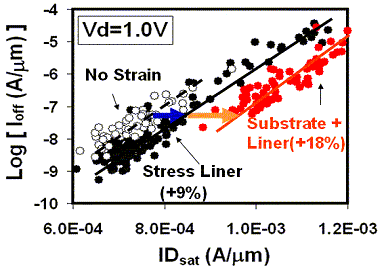
圖13:由應(yīng)力襯低結(jié)合的絕緣體(襯底應(yīng)變硅)上直接制作的應(yīng)變硅增強了的NMOSFET性能。
提高遷移率終于獲得了成功? Lg和溝道遷移率的提升加速了晶體管溝道阻抗(Rch)的降低,而寄生源/漏和接觸電阻(Rsd)要以更慢的速度降低。由于寄生參數(shù)導(dǎo)致越來越多的電壓降,增加Rsd/Rch比率會導(dǎo)致逐漸抵消所增強的晶體管性能,盡管遷移率增加(圖14)[6]。這就意味著,要把寄生電阻急劇降低的新型工藝與提高遷移率同時開發(fā),以避免相互抵消。
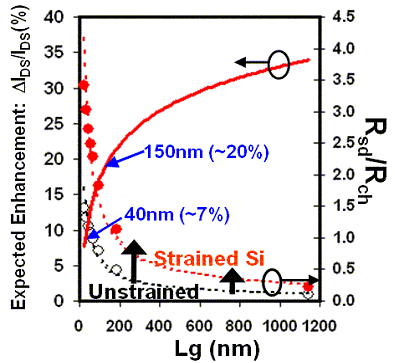
圖14:因遷移率增強,驅(qū)動電流增強及作為Lg應(yīng)變硅函數(shù)之一的Rsd/Rch加速了Rsd/Rch的增長,導(dǎo)致返回的驅(qū)動電流逐漸減小。
本文小結(jié)
我們發(fā)現(xiàn)日益改進的靜電學(xué)及晶體管傳輸有助于形成一種成熟的方法,這種方法能夠降低有源和待機功耗。要做到這一點,新型晶體管結(jié)構(gòu)和材料拓展了性能?功耗設(shè)計空間,使之超躍了傳統(tǒng)的本體硅晶體管。最終,通過構(gòu)成一個由多層系統(tǒng)-電路-器件電源管理生態(tài)系統(tǒng)構(gòu)成的底層,晶體管的創(chuàng)新將會繼續(xù)在定義下一代提高功效的策略時發(fā)揮關(guān)鍵作用。

