目前LED照明發(fā)展已經(jīng)進(jìn)入快車道,但是LED的封裝若無(wú)法在溫度管理、可靠度以及光學(xué)效率方面獲得改善,那全面普及仍是可望而不可及,因此業(yè)界開(kāi)發(fā)出采用COB(Chip On Board)方式的LED封裝來(lái)滿足LED在照明市場(chǎng)應(yīng)用上的需求。COB封裝使用金屬核心印刷電路板(MCPCB)來(lái)達(dá)到最低的熱阻,能夠在70℃散熱片溫度下,以24瓦運(yùn)作達(dá)7,000小時(shí),而不會(huì)有任何效能劣化的情況,此結(jié)果亦已經(jīng)過(guò)實(shí)際測(cè)量結(jié)果的驗(yàn)證。
本文中將對(duì)COB封裝本身以及所搭配散熱片的COB封裝之計(jì)算流體動(dòng)力分析(Computational Fluid Dynamic, CFD)模型建立技術(shù)進(jìn)行討論,同時(shí)采用簡(jiǎn)化或精簡(jiǎn)的CFD仿真模型來(lái)簡(jiǎn)化系統(tǒng)的溫度管理設(shè)計(jì),此封裝顯示出COB技術(shù)由于具備高成本效益以及高設(shè)計(jì)彈性等特性,因此可成為L(zhǎng)ED封裝設(shè)計(jì)工程師另一具有吸引力的替代選擇。
COB封裝可實(shí)現(xiàn)低熱阻/高功率效能
LED由于具有卓越色彩飽和度以及長(zhǎng)效壽命等特點(diǎn),因此目前正逐漸進(jìn)入照明市場(chǎng),采用LED所面臨的挑戰(zhàn)包括溫度管理與較高組裝成本的問(wèn)題,此外,該市場(chǎng)也要求在單位光源下具有較高的亮度輸出。傳統(tǒng)的方法是將LED芯片安裝在基體上以構(gòu)成離散式的LED組件,接著再將這些LED組件安排在印刷電路板(PCB)上形成多重LED光源組合以提升照明度,低功率組件通常使用核心材料為FR4的普通印刷電路板進(jìn)行二次組裝,在高功率應(yīng)用則采用金屬核心PCB來(lái)強(qiáng)化散熱能力,傳統(tǒng)的做法在需要高亮度輸出密度時(shí)會(huì)面臨極限,原因是各個(gè)LED基體所需的空間、相對(duì)較大的焊接點(diǎn)以及LED基體的設(shè)計(jì)方式,經(jīng)常會(huì)對(duì)多芯片電路設(shè)計(jì)于具備低熱阻效能的單一封裝造成限制。

圖1 安華高科技的3.5瓦、10.5瓦COB白光LED模塊ADJD-xDxx
較新的做法是將LED芯片直接安裝在印刷電路板上,因此業(yè)界開(kāi)發(fā)出具備即插即用功能,并且完全整合高效率溫度管理的COB封裝來(lái)解決這些問(wèn)題(圖1)。
COB封裝的主要目的是提供比現(xiàn)有離散式LED組件更好的效能以進(jìn)軍照明市場(chǎng),除了熱阻夠低能改善可靠度表現(xiàn)外,同時(shí)還要簡(jiǎn)化系統(tǒng)的設(shè)計(jì),另外,解決方案的成本也須能與其他光源競(jìng)爭(zhēng)。
COB采用MCPCB取得低熱阻
此新做法是直接將LED芯片安裝在印刷電路板上,封裝使用MCPCB來(lái)取得最低的熱阻,典型的MCPCB架構(gòu)是在金屬平面形成電氣走線,并以薄層加以隔離(表1)。


電氣走線須采鎳金化合物來(lái)提供可焊接的表面,隔離層則要能避免短路同時(shí)又不會(huì)犧牲太多的散熱速率,隔離層的厚度通常相當(dāng)薄,以便將熱阻降到最低,同時(shí)提供良好的黏合情況,厚隔離層可以吸收線路黏合過(guò)程中的超音波功率,選擇鋁核心的主要理由是成本低、散熱能力優(yōu)良以及與其他核心材料比較佳的抗腐蝕性(表2)。
良好的溫度表現(xiàn)
在COB封裝中,由于散熱路徑較短,LED芯片由工作中產(chǎn)生的熱能可以有效傳遞至散熱片(圖2),因?yàn)榫哂羞@樣的特性,COB封裝可以比傳統(tǒng)離散式組件封裝維持更低的LED芯片接面溫度。
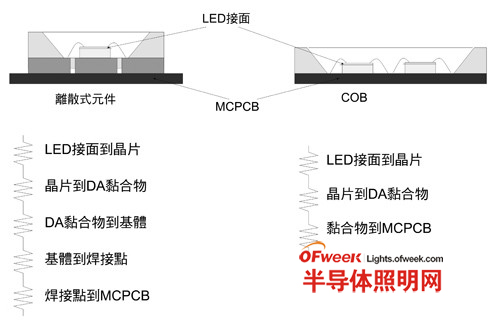
圖2 離散式組件與COB包裝方式的溫度路徑比較
LED接面溫度在LED壽命與效能表現(xiàn)扮演相當(dāng)關(guān)鍵的角色,較低的接面溫度由于劣化程度較低,因此壽命較長(zhǎng),此外,LED在溫度較低時(shí),每單位功率輸入的光輸出也較高。簡(jiǎn)單來(lái)說(shuō),COB封裝可讓終端用戶以更少的溫度管理需求或更低的系統(tǒng)成本,得到比傳統(tǒng)離散式組件封裝更好的效能表現(xiàn)。
圖1的COB封裝尺寸為100毫米長(zhǎng)×18毫米寬,頂部發(fā)光型模塊的厚度為3.6毫米,雖然這樣的尺寸相當(dāng)精簡(jiǎn),但對(duì)于24瓦的設(shè)備來(lái)說(shuō),熱阻也只有2℃/W,此代表若最高可允許接面溫度設(shè)定在120℃,組件將能夠在70℃的電路板溫度下以最高功率運(yùn)作。
可靠度的強(qiáng)化
在目前的LED封裝中,塑料材料由于相當(dāng)容易制造,因此廣泛受到采用,例如塑料成型的反射罩就被用來(lái)將LED芯片側(cè)面所發(fā)出的光反射到所需的方向,而塑料封裝也被用來(lái)保護(hù)芯片并形成光輸出的折射用透鏡。但塑料長(zhǎng)時(shí)間暴露在紫外光與高溫下會(huì)逐漸劣化,黃化效應(yīng)則會(huì)造成反射能力的劣化并影響封裝材料的透光度,造成亮度輸出隨著使用時(shí)間而下降,這樣的劣化問(wèn)題對(duì)LED背光必須穿透大面積照明時(shí)形成挑戰(zhàn),通常照明市場(chǎng)要求最低至少50,000小時(shí)的工作壽命,才能被視為長(zhǎng)效或不須維護(hù)的設(shè)備。
24瓦COB封裝使用金屬反射器以及硅樹(shù)脂封裝來(lái)消除劣化的問(wèn)題(圖3),實(shí)際的可靠度測(cè)量結(jié)果顯示,在高溫情況下工作7,000小時(shí)后并沒(méi)有發(fā)生任何劣化情形,圖4是COB封裝在70℃電路板溫度高溫運(yùn)作下的劣化趨勢(shì)曲線圖。
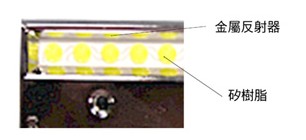
圖3 采用硅樹(shù)脂封裝與金屬反射器的COB包裝結(jié)構(gòu)

圖4 COB包裝LED在高溫運(yùn)作情況下的劣化速度
即插即用組裝方案
目前照明產(chǎn)業(yè)的標(biāo)準(zhǔn)是采用冷陰極燈管(CCFL),它并不需要回焊程序來(lái)安裝,也毋需復(fù)雜的溫度管理系統(tǒng),市場(chǎng)并供應(yīng)有各種不同的CCFL燈管長(zhǎng)度來(lái)滿足不同空間限制的需求。
CCFL的亮度可透過(guò)照明系統(tǒng)更多的燈管來(lái)提升,簡(jiǎn)單的說(shuō),整個(gè)組裝過(guò)程為即插即用,相當(dāng)方便,因此,要讓LED成為更具吸引力的選擇,就必須要讓照明單元或照明設(shè)備制造商由CCFL轉(zhuǎn)用LED的過(guò)程變得平順簡(jiǎn)單。
COB封裝LED模塊采用長(zhǎng)條狀方式設(shè)計(jì),因此能夠依據(jù)照明設(shè)備的尺寸與亮度要求,透過(guò)簡(jiǎn)單的水平或垂直方向堆棧來(lái)滿足需求,每一COB模塊均提供標(biāo)準(zhǔn)底座以進(jìn)行電氣連接,由于需要高色彩飽和度時(shí)通常會(huì)尋求LED解決方案,因此光輸出色彩的選擇也相當(dāng)重要,例如建筑照明需要各種不同的顏色來(lái)裝飾與美化建筑物,而COB封裝的設(shè)計(jì)就帶來(lái)簡(jiǎn)單的做法。電力連接方式與電路安排的改變讓封裝能夠隨時(shí)依照客戶需求的不同來(lái)選用不同的LED芯片組態(tài),在白光LED模塊外,同時(shí)也提供采用類似外觀封裝的24瓦紅、綠與藍(lán)光LED模塊,此外,也透過(guò)客制化的反射器設(shè)計(jì)來(lái)改變光輸出的發(fā)射模式,圖5為具有類似基體的24瓦紅、綠與藍(lán)色頂部發(fā)光與側(cè)面發(fā)光型式的LED模塊。

圖5 COB包裝紅、綠與藍(lán)光LED模塊
COB模塊的安裝可以使用M3螺絲來(lái)達(dá)成,因此可免除使用在傳統(tǒng)離散式LED產(chǎn)品組裝程序中的復(fù)雜回焊程序,溫度管理系統(tǒng)的設(shè)計(jì)也須簡(jiǎn)化,以便吸引照明設(shè)備制造商由CCFL轉(zhuǎn)而采用LED。
COB封裝的溫度特性量測(cè)
就COB封裝以及搭配散熱片的COB封裝進(jìn)行紅外線測(cè)量,測(cè)量樣品與測(cè)量點(diǎn)分別顯示在圖6與圖7,樣品上用來(lái)測(cè)量的特定區(qū)域具備已知散熱率的聚鶜亞胺高溫膠帶黏貼,在此不對(duì)紅外線測(cè)量安排的細(xì)節(jié)多做介紹。
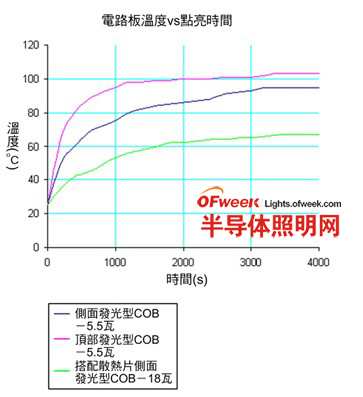
圖6 電路板溫度與點(diǎn)亮?xí)r間長(zhǎng)度的相對(duì)關(guān)系

圖7 COB包裝的測(cè)量樣品與紅外線圖
受測(cè)COB封裝以5.5瓦推動(dòng),搭配散熱片的COB封裝則以18瓦推動(dòng),所有測(cè)量結(jié)果都在電路板達(dá)到溫度飽和后才開(kāi)始進(jìn)行(圖6),由測(cè)量樣品所取得的紅外線圖可參考圖7與圖8。
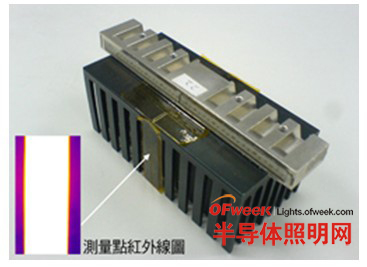
圖8 搭配散熱片COB包裝的測(cè)量樣品與紅外線圖
為確保紅外線測(cè)量結(jié)果的正確性,使用熱電偶來(lái)加以驗(yàn)證,由熱電偶所測(cè)量的結(jié)果相當(dāng)符合(表3)。
表3 模擬與實(shí)驗(yàn)結(jié)果的比較

透過(guò)CFD軟件做溫度仿真
使用CFD軟件Flotherm作為溫度仿真,F(xiàn)lotherm采用有限值法解決方案,并以方程式來(lái)描述物質(zhì)轉(zhuǎn)換、瞬間以及三度空間的流動(dòng)能量。
基本條件假設(shè)
在進(jìn)行CFD分析時(shí),假設(shè)有三維空間、穩(wěn)定狀態(tài)、氣流速度為0.2m/s、空氣特性穩(wěn)定、環(huán)境溫度為25℃、運(yùn)算范圍為400毫米×400毫米×150毫米以及熱透過(guò)正常對(duì)流以及傳導(dǎo)與輻射方式散熱的情況。
COB封裝以及搭配散熱片COB封裝模型的整體閘格單元數(shù)分別接近四十萬(wàn)與一百六十萬(wàn),在閘格設(shè)置建議于散熱片的鰭片之間,至少使用三個(gè)單元。
LED模塊模型建立
芯片、鋁質(zhì)反射器、硅樹(shù)脂封裝、散熱片以及芯片黏著層都以單一立體方塊來(lái)架構(gòu)模型,使用立體方塊的重點(diǎn)是其永遠(yuǎn)包含一或多個(gè)有限數(shù)量的閘單元,此代表每一方塊所代表的物質(zhì)溫度均以每一獨(dú)立閘單元計(jì)算。
在芯片黏著層上總共有五十個(gè)芯片,每個(gè)紅色芯片以0.5毫米寬×0.5毫米長(zhǎng)×0.225毫米高的方塊來(lái)代表,每個(gè)綠色與藍(lán)色芯片則以0.376毫米寬×0.376毫米長(zhǎng)×0.25毫米高代表,并在紅色芯片的頂部以及綠色與藍(lán)色芯片的底部表面加入五十個(gè)不同功率的發(fā)熱源,其中藍(lán)色與綠色芯片采用覆芯片方式。
由于LED的高密度搭配超薄的芯片黏著層,因此要完成模擬需要較長(zhǎng)的計(jì)算時(shí)間,而這樣詳細(xì)的溫度模型在模塊出現(xiàn)于大系統(tǒng)模型下通常不太實(shí)際,因此將詳細(xì)模型簡(jiǎn)化成搭配散熱片COB封裝的精簡(jiǎn)模型,將可以有效縮短計(jì)算時(shí)間。
對(duì)精簡(jiǎn)模型來(lái)說(shuō),芯片黏著層的五十個(gè)芯片以單一正方形方塊取代,表4顯示沒(méi)有使用在精簡(jiǎn)模型中的溫度特性,芯片的新等效溫度特性則由詳細(xì)模型的結(jié)果取得。

此外,介電層、銅箔走線、基體上的焊接材料以及導(dǎo)熱膠帶都加以記錄考慮,這些材料的熱傳導(dǎo)能力由表3中所列出的文件中取得,在具備經(jīng)陽(yáng)極化處理鋁材料散熱片中并考慮了輻射效應(yīng)。
熱阻的計(jì)算
熱流會(huì)垂直通過(guò)芯片、芯片黏著層,介電層接著直通到基體,每個(gè)獨(dú)立芯片就形成并聯(lián)的熱阻,由芯片到基體的整體熱阻值Rjb-T可透過(guò)以下方程序取得:
1/Rjb-T=X/Rjb-R+Y/Rjb-G+Z/Rjb-B (1)
其中X、Y、Z分別為紅、綠與藍(lán)光LED的芯片數(shù),Rjb-R、Rjb-G與Rjb-B的熱阻可以使用以下方程式進(jìn)行計(jì)算:
Rjb=TJunction–TBoard/Power (2)
圖1中包含二十個(gè)紅色芯片、二十個(gè)綠色芯片與十個(gè)藍(lán)色芯片的COB封裝熱阻可由下列方程式表示:
1/Rjb=20/Rjb(R)+20/Rjb(G)+10/Rjb(B)
Rjb=1/[20/Rjb(R)+20/Rjb(G)+10/Rjb(B)] (3)
其中模擬結(jié)果Rjb(R)=100oC/W,Rjb(G)= Rjb(R)則為80oC/W,以這樣的結(jié)果為基礎(chǔ),整體熱阻計(jì)算值為1.74oC/W,接近2oC/W。
CFD模擬的結(jié)果與比較
圖4顯示在相同電路板溫度下仿真與實(shí)驗(yàn)結(jié)果的比較,它包含有頂部發(fā)光型COB封裝,側(cè)面發(fā)光型COB封裝以及搭配散熱片的側(cè)面發(fā)光型COB封裝,其中前兩個(gè)封裝以詳細(xì)模型進(jìn)行,而最后一個(gè)則使用精簡(jiǎn)模型技術(shù),原因是封裝上額外搭配的散熱片須要考慮更多的閘單元,因此會(huì)拉長(zhǎng)計(jì)算時(shí)間,此外,在文中也想要證明精簡(jiǎn)模型的結(jié)果事實(shí)上并不會(huì)與詳細(xì)模型有太大的差異。
圖1的頂部與側(cè)面發(fā)光型COB封裝使用相同的MCPCB設(shè)計(jì),但采用不同的鋁反射器設(shè)計(jì),不過(guò)側(cè)面發(fā)光型COB封裝由于擁有較大的反射區(qū)可協(xié)助散熱,因此預(yù)料側(cè)面發(fā)光型COB封裝的電路板溫度仿真結(jié)果將低于頂部發(fā)光型COB封裝,此推論也經(jīng)由實(shí)際測(cè)量數(shù)據(jù)與仿真結(jié)果取得驗(yàn)證。
圖9與圖10分別提供側(cè)面發(fā)光型COB封裝以及搭配散熱片COB封裝的可視化模擬結(jié)果。
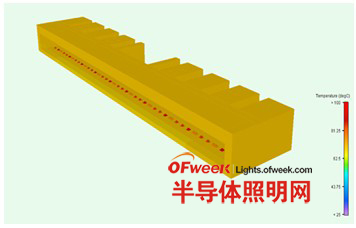
圖9 側(cè)面發(fā)光型COB包裝的可視化結(jié)果

圖10 搭配散熱片側(cè)面發(fā)光型COB包裝的可視化結(jié)果
由圖4可以得知,詳細(xì)與精簡(jiǎn)模型的仿真結(jié)果事實(shí)上都接近于實(shí)際測(cè)量結(jié)果,此清楚的顯示出,模塊封裝的精簡(jiǎn)模型可適用于系統(tǒng)級(jí)設(shè)計(jì),有助于縮短設(shè)計(jì)時(shí)間。
COB封裝符合LED照明應(yīng)用期待
COB封裝技術(shù)帶來(lái)每單位區(qū)域LED光源封裝設(shè)計(jì)上更加精簡(jiǎn)或照明度更高的輸出,低熱阻以及正確的封裝材料選擇帶來(lái)令人驚艷的光輸出以及更長(zhǎng)的壽命,此外,即插即用的功能也讓COB封裝的組裝程序能夠和CCFL類似。
精簡(jiǎn)或簡(jiǎn)化的模型仿真結(jié)果與實(shí)際測(cè)量結(jié)果相當(dāng)接近,此證明可透過(guò)節(jié)省CFD模擬時(shí)間與耗用資源帶來(lái)更快的設(shè)計(jì)周期,照明設(shè)備制造商可在設(shè)計(jì)中使用簡(jiǎn)化的CFD仿真模型來(lái)決定適合的溫度管理系統(tǒng)。
COB LED封裝不僅擁有比傳統(tǒng)離散式LED組件封裝更佳的效能,還能夠簡(jiǎn)化溫度管理來(lái)簡(jiǎn)化系統(tǒng)級(jí)的設(shè)計(jì),可以說(shuō)是幫助LED符合照明市場(chǎng)需求的理想解決方案。

