文獻(xiàn)標(biāo)識(shí)碼: A
DOI:10.16157/j.issn.0258-7998.2016.07.008
中文引用格式: 龔道輝,汪鵬君,康耀鵬. 基于CNFET的單端口三值SRAM單元設(shè)計(jì)[J].電子技術(shù)應(yīng)用,2016,42(7):34-37.
英文引用格式: Gong Daohui,Wang Pengjun,Kang Yaopeng. Design of single-port ternary SRAM cell based on CNFET[J].Application of Electronic Technique,2016,42(7):34-37.
0 引言
隨著CMOS工藝和集成電路技術(shù)的發(fā)展,電路的微型化給人們的生活帶來(lái)極大的方便,同時(shí)對(duì)高集成度和低功耗等特性提出更高的要求。特別是高集成度問(wèn)題,由于特征尺寸縮小使得單位芯片面積上集成的元件數(shù)目急劇增加,集成電路的特征尺寸已經(jīng)進(jìn)入納米量級(jí)。在超大規(guī)模集成電路(Very Large Scale Integration,VLSI)中,有70%以上的硅片面積用于布線(xiàn),進(jìn)一步制約集成度的提高[1]。在納米量級(jí)下,互連線(xiàn)寄生效應(yīng)帶來(lái)的門(mén)延時(shí)、互連線(xiàn)串?dāng)_、功耗增加等問(wèn)題變得更加嚴(yán)重,而多值邏輯(Multi-Valued Logic,MVL)電路的特性為解決這些問(wèn)題提供了新的途徑。多值邏輯突破了傳統(tǒng)二值邏輯信號(hào)取值 “0”、“1”的限制,如多值邏輯最小基的三值邏輯,其信號(hào)可取值“0”、“1”和“2”,因此多值邏輯電路單線(xiàn)信息攜帶量高,空間或時(shí)間利用率充分,有效地降低芯片的布線(xiàn)面積,提高電路的集成度[2]。
多值存儲(chǔ)單元存儲(chǔ)信息量高,0.631n位的三值存儲(chǔ)器與n位的二值存儲(chǔ)器存儲(chǔ)的信息量相同[2],設(shè)計(jì)相同容量存儲(chǔ)器,需要芯片面積更小,電路功耗更低。但隨著電路集成度的提高,互連線(xiàn)寄生效應(yīng)也來(lái)越明顯,從而將降低利用金屬氧化物半導(dǎo)體場(chǎng)效應(yīng)晶體管(Metal-Oxide-Semiconductor Field-Effect Transistor,MOSFET)設(shè)計(jì)的三值存儲(chǔ)器的穩(wěn)定性。然而CNFET化學(xué)性質(zhì)穩(wěn)定、柵壓調(diào)制便捷,以及漏電流小等優(yōu)良特性[2],使得它具有取代傳統(tǒng)CMOS工藝的可能。且近年來(lái),CNFET也逐漸被應(yīng)用到集成電路設(shè)計(jì)領(lǐng)域。本文通過(guò)對(duì)CNFET的物理特性與多值邏輯理論的分析,利用不同閾值電壓的CNFET設(shè)計(jì)三值靜態(tài)SRAM,并分析其功耗及穩(wěn)定性。
1 碳納米場(chǎng)效應(yīng)晶體管
CNFET是由半導(dǎo)體型單壁碳納米管(Single Walled Carbon Nanotube,SWCNT)構(gòu)成[3]。單壁碳納米管是由一層石墨稀片沿某一軸向卷成的直徑為納米量級(jí)的中空?qǐng)A柱。SWCNT制造過(guò)程簡(jiǎn)單,其特性取決于沿管軸卷曲的螺旋角。螺旋角可以由手性矢量來(lái)表示,手性矢量是由一個(gè)整數(shù)對(duì)(n,m)來(lái)表示[3]。根據(jù)n和m的取值情況,可以將碳納米管分為金屬型碳納米管和半導(dǎo)體型碳納米管。當(dāng)n=m或n-m=3i時(shí),碳納米管為金屬型,其它情況為半導(dǎo)體型,其中i為整數(shù)。碳納米管的直徑DCNT,可用如下公式[4]計(jì)算:

其中a0為石墨稀片中碳-碳鍵長(zhǎng),通常a0=0.142 nm。圖1(a)為CNFET的正視圖,與傳統(tǒng)的MOSFET模型類(lèi)似,有柵極、源極、漏極、基極4個(gè)端口。隨著柵極電位的變化,CNFET將導(dǎo)通或截止。圖1(b)為CNFET的俯視圖,柵極下方溝道區(qū)域?yàn)槲磽诫s的本征碳納米管,柵和源/漏極之間為重?fù)诫s碳納米管,以保證導(dǎo)通電阻較小。根據(jù)摻雜物質(zhì)的不同,可以將CNFET分為P型和N型兩類(lèi)。

本征碳納米管導(dǎo)通的閾值電壓Vth為半帶隙的一階近似,它是直徑的反函數(shù)[4]:

其中a為碳原子與碳原子之間的距離,通常a=2.49 ![]() ,Vπ=3.033 eV為碳-碳鍵中的π鍵的鍵能,e為元電荷,DCNT為碳納米管的直徑。手性矢量為(19,0)的碳納米管直徑為1.487 nm,由公式(2)可知其閾值電壓為0.293 mV。隨著手性矢量的改變,CNFET的閾值電壓也將改變。假定手性矢量中m為零,具有不同手性矢量的兩個(gè)CNFET閾值電壓比為:
,Vπ=3.033 eV為碳-碳鍵中的π鍵的鍵能,e為元電荷,DCNT為碳納米管的直徑。手性矢量為(19,0)的碳納米管直徑為1.487 nm,由公式(2)可知其閾值電壓為0.293 mV。隨著手性矢量的改變,CNFET的閾值電壓也將改變。假定手性矢量中m為零,具有不同手性矢量的兩個(gè)CNFET閾值電壓比為:

表明CNFET的閾值電壓與碳納米管手性矢量成反比。
傳統(tǒng)6 T存儲(chǔ)單元中,交叉耦合反相器是存儲(chǔ)邏輯值的基本元件,存儲(chǔ)邏輯值的讀出與寫(xiě)入由讀寫(xiě)控制管來(lái)實(shí)現(xiàn)。存儲(chǔ)單元設(shè)計(jì)需滿(mǎn)足以下基本要求:(a)當(dāng)存儲(chǔ)單元保持?jǐn)?shù)據(jù),交叉耦合反相器能穩(wěn)定保持邏輯值;(b)當(dāng)存儲(chǔ)單元寫(xiě)入或讀出數(shù)據(jù),位線(xiàn)的電壓能更新存儲(chǔ)節(jié)點(diǎn)的數(shù)據(jù)、同時(shí)存儲(chǔ)節(jié)點(diǎn)的數(shù)據(jù)也能改變位線(xiàn)電壓。類(lèi)比傳統(tǒng)二值存儲(chǔ)單元的設(shè)計(jì),三值SRAM需包含交叉耦合三值反相器。圖2為三值反相器[1],需兩個(gè)電源電壓Vdd和Vddl。定義Vdd對(duì)應(yīng)邏輯值 “2”、Vddl對(duì)應(yīng)邏輯值“1”、接地對(duì)應(yīng)邏輯值“0”。N2管驅(qū)動(dòng)能力弱于N1管和P1管,N2管柵極接Vdd,處于弱導(dǎo)通狀態(tài)。當(dāng)輸入端IN為高電平Vdd時(shí),N1管導(dǎo)通、P1管關(guān)閉,輸出端OUT放電到0。當(dāng)輸入端IN為Vddl時(shí),N1和P1管都關(guān)閉,輸出端OUT維持原來(lái)的電平Vddl不變,輸出邏輯值“1”。當(dāng)輸入端IN為0時(shí),N1管關(guān)閉、P1管導(dǎo)通,輸出端OUT充電到Vdd,輸出邏輯值“2”。

將兩個(gè)三值反相器交叉耦合,結(jié)合讀寫(xiě)控制管,可得單端口讀寫(xiě)三值SRAM,如圖3所示,可以存儲(chǔ)邏輯值“0”、“1”和“2”。其中一個(gè)反相器連接T1管,另一個(gè)反相器連接T10管,通過(guò)控制T1與T10的柵極電壓來(lái)實(shí)現(xiàn)SRAM的寫(xiě)操作。節(jié)點(diǎn)Q_B通過(guò)T8、T9管和傳輸門(mén)與位線(xiàn)相連,控制傳輸門(mén)的導(dǎo)通與關(guān)閉,讀取三值SRAM節(jié)點(diǎn)Q的數(shù)據(jù)。由式(1)和式(2)可知,N型CNFET中T1和T10的閾值電壓為0.293 V;T2、T7、T9和T11的閾值電壓為0.557 V;T4和T5的閾值電壓為0.428 V。P型CNFET中T3、T6、T8和T12的閾值電壓為-0.557 V。單端口讀寫(xiě)三值SRAM的工作過(guò)程分為3個(gè)階段:數(shù)據(jù)保持、讀取數(shù)據(jù)和寫(xiě)入數(shù)據(jù)階段。數(shù)據(jù)保持階段如下:(a)當(dāng)三值SRAM保持邏輯值“0”,將W、R和W_B、R_B分別接入低電平和高電平,T1導(dǎo)通,T10、T11和T12截止,將交叉耦合的反相器與位線(xiàn)BL斷開(kāi)。由于T4、T5柵極接入Vdd=0.9 V,T4、T5處于常導(dǎo)通狀態(tài)。T2、T6導(dǎo)通,T3、T7截止,則節(jié)點(diǎn)Q和Q_B的電壓分別為0 V和0.9 V。(b)當(dāng)三值SRAM保持邏輯值“1”,交叉耦合的反相器與位線(xiàn)BL斷開(kāi),由于T4、T5導(dǎo)通,T2、T3、T6和T7截止,則節(jié)點(diǎn)Q和Q_B的電壓都為Vddl=0.45 V。(c)當(dāng)三值SRAM保持邏輯值“2”,交叉耦合的反相器與位線(xiàn)BL斷開(kāi),由于T4、T5導(dǎo)通,T3、T7導(dǎo)通,T2、T6截止,則節(jié)點(diǎn)Q和Q_B的電壓分別為0.9 V和0 V。

2.1 讀操作
三值SRAM讀取數(shù)據(jù)的操作過(guò)程如下:在讀取數(shù)據(jù)前將位線(xiàn)BL預(yù)充電到Vddl=0.45 V。(a)當(dāng)SRAM存儲(chǔ)的數(shù)據(jù)為“0”(即節(jié)點(diǎn)Q為“0”),Q_B節(jié)點(diǎn)電壓為Vdd。此時(shí),T8管關(guān)閉、T9管導(dǎo)通,控制信號(hào)R和R_B分別為高電平和低電平,使傳輸門(mén)導(dǎo)通。將T9管接地信號(hào)讀取為邏輯值“0”,位線(xiàn)BL的電壓放電到0。(b)當(dāng)SRAM存儲(chǔ)的數(shù)據(jù)為“1”(即節(jié)點(diǎn)Q為“1”),Q_B節(jié)點(diǎn)電壓為Vddl。此時(shí),T8、T9管同時(shí)關(guān)閉,控制信號(hào)R和R_B分別為高電平和低電平,使傳輸門(mén)導(dǎo)通。由于T8、T9管的關(guān)閉,位線(xiàn)BL保持原來(lái)的預(yù)充電電壓Vddl不變,讀取的數(shù)據(jù)為“1”。(c)當(dāng)SRAM存儲(chǔ)的數(shù)據(jù)為“2”(即節(jié)點(diǎn)Q為“2”),此時(shí),T8管導(dǎo)通、T9管關(guān)閉,控制信號(hào)R和R_B分別為高電平和低電平,使傳輸門(mén)導(dǎo)通。將T8管接Vdd,讀取邏輯值“2”,位線(xiàn)BL被充電到Vdd。圖4為讀操作的HSPICE仿真結(jié)果,與理論分析完全一致,證明了三值SRAM的讀操作功能正確。
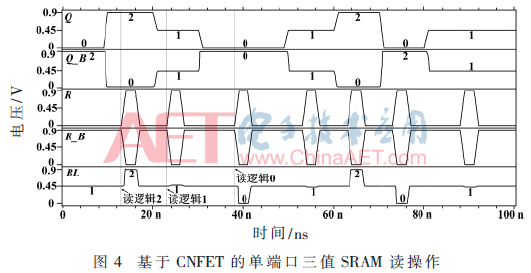
2.2 寫(xiě)操作
SRAM的寫(xiě)操作是將位線(xiàn)BL上的數(shù)據(jù)寫(xiě)入到交叉耦合的反相器中,迫使SRAM節(jié)點(diǎn)Q上的數(shù)據(jù)與BL上的數(shù)據(jù)一致。T2-T4組成的反相器連接T1管,在寫(xiě)入數(shù)據(jù)時(shí),將T1管關(guān)閉,切斷兩個(gè)反相器的交叉耦合,提高寫(xiě)操作的穩(wěn)定性。寫(xiě)入數(shù)據(jù)的操作過(guò)程如下:當(dāng)W、W_B分別為高電平和低電平時(shí),位線(xiàn)BL上的數(shù)據(jù)將寫(xiě)入交叉耦合的反相器。W_B為低電平時(shí)T1管關(guān)閉,T2-T4組成的反相器停止工作,切斷兩個(gè)反相器的交叉耦合,使BL上的數(shù)據(jù)更容易寫(xiě)入。當(dāng)數(shù)據(jù)寫(xiě)入完成后,W_B為高電平,T2-T4組成的反相器開(kāi)始工作,兩個(gè)反相器交叉耦合;同時(shí),W為低電平,使得交叉耦合的反相器與位線(xiàn)BL斷開(kāi),這樣寫(xiě)入的數(shù)據(jù)得以保持。圖5為寫(xiě)操作的HSPICE仿真結(jié)果,與理論分析完全一致。證明了三值SRAM的寫(xiě)操作功能正確。
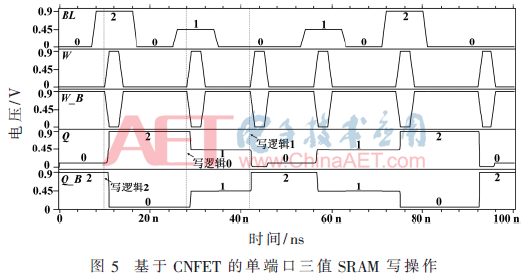
3 實(shí)驗(yàn)結(jié)果與分析
采用斯坦福大學(xué)的32 nm CNFET標(biāo)準(zhǔn)模型庫(kù)[5],利用HSPICE對(duì)單端口三值SRAM進(jìn)行仿真。標(biāo)準(zhǔn)模型庫(kù)主要參數(shù)為:電源電壓Vdd=0.9 V和Vddl=0.45 V,物理溝道長(zhǎng)度Lch=32 nm,本征碳納米管區(qū)彈道散射自由程長(zhǎng)度為L(zhǎng)geff=100 nm。
3.1 靜態(tài)噪聲容限
靜態(tài)噪聲容限(Static Noise Margin,SNM)是衡量存儲(chǔ)單元抗干擾能力的一個(gè)重要參數(shù)。靜態(tài)噪聲容限是指存儲(chǔ)單元所能承受的最大直流噪聲信號(hào)的幅值,若超過(guò)這個(gè)值,存儲(chǔ)結(jié)點(diǎn)的狀態(tài)會(huì)發(fā)生錯(cuò)誤翻轉(zhuǎn)[6]。SNM可以用蝶形曲線(xiàn)來(lái)表示,蝶形曲線(xiàn)是通過(guò)反相器的電壓傳輸特性(Voltage-Transfer Characteristic,VTC)曲線(xiàn)和鏡像的逆變換的電壓傳輸特性曲線(xiàn)繪制得到。圖6是通過(guò)HSPICE仿真得到的蝶形曲線(xiàn)。
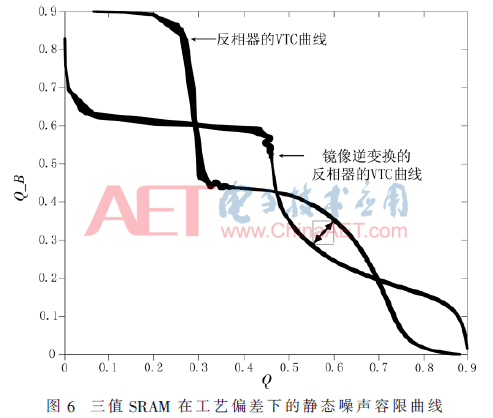
與二值SRAM的蝶形曲線(xiàn)相比,三值SRAM的蝶形曲線(xiàn)具有更多的正方形,最小正方形的對(duì)角線(xiàn)限定三值SRAM的SNM。圖3中T1管不是反相器中的一部分,而是在數(shù)據(jù)通過(guò)T10管寫(xiě)入時(shí),控制兩個(gè)反相器交叉耦合與否,確保數(shù)據(jù)有效寫(xiě)入,提高三值SRAM的穩(wěn)定性和SNM。三值SRAM的數(shù)據(jù)通過(guò)T8和T9管讀出,讀操作過(guò)程中三值SRAM的信號(hào)并未與位線(xiàn)相連,而是利用存儲(chǔ)的信號(hào)控制T8和T9管的導(dǎo)通和關(guān)閉,實(shí)現(xiàn)數(shù)據(jù)的輸出。避免位線(xiàn)上的電壓影響存儲(chǔ)節(jié)點(diǎn)的狀態(tài),提高三值SRAM的穩(wěn)定性。因此,單端口三值SRAM既提高寫(xiě)入數(shù)據(jù)的穩(wěn)定性也提高讀取數(shù)據(jù)的穩(wěn)定性。
碳納米管器件物理特性取決于:碳納米管的直徑、碳納米管之間的間距和柵極下碳納米管的數(shù)量,這些參數(shù)的變化將對(duì)CNFET電路的特性產(chǎn)生很大的影響,而CNFET柵氧化層厚度和溝道長(zhǎng)度的工藝偏差產(chǎn)生的影響則很小,可以忽略[7]。實(shí)驗(yàn)中對(duì)碳納米管的直徑和碳納米管之間寬度的工藝偏差進(jìn)行蒙特卡羅仿真,它們服從偏差為10%的高斯分布。
3.2 功耗與延時(shí)
通過(guò)對(duì)三值SRAM的延遲和功耗進(jìn)行分析。表1給出了本文提出的三值SRAM的讀寫(xiě)延時(shí)及存儲(chǔ)功耗,并與文章[8]的相應(yīng)數(shù)據(jù)進(jìn)行對(duì)比。由表1可以發(fā)現(xiàn)本文所提出的三值SRAM的寫(xiě)延時(shí)比文章[8]至少減少24%,而讀延時(shí)至少減少36%。表中“—”是由于本文讀操作時(shí),位線(xiàn)BL預(yù)充電到“1”,而文章[8]對(duì)應(yīng)的預(yù)充電為“2”,故此處無(wú)讀延時(shí)。表1同時(shí)給出了存儲(chǔ)邏輯電平時(shí)消耗的平均功耗,當(dāng)三值反相器輸出端邏輯值變化到“0”時(shí),N2和N1管分別傳輸?shù)腣ddl和接地0之間存在輸出競(jìng)爭(zhēng);同理,當(dāng)三值反相器輸出端邏輯值變化到“2”時(shí),N2和P1管分別傳輸?shù)腣ddl和Vdd之間存在輸出競(jìng)爭(zhēng),導(dǎo)致了三值SRAM存儲(chǔ)邏輯值“0”和“2”的功耗較高的結(jié)果。

4 結(jié)論
本文利用碳納米管的多閾值特性,設(shè)計(jì)了一種三值單端口SRAM單元。該單元相比二值SRAM不僅提高了存儲(chǔ)信息密度,而且減少了芯片布線(xiàn)面積;采用隔離和切斷交叉耦合技術(shù),提高了讀寫(xiě)數(shù)據(jù)的穩(wěn)定性。HSPICE仿真結(jié)果表明,三值SRAM單元讀寫(xiě)功能正確,與MOSFET的三值SRAM相比,存儲(chǔ)邏輯值消耗的平均功耗降低且工作速度提高。蒙特卡羅仿真驗(yàn)證,三值SRAM的SNM較大,且工藝偏差對(duì)電路的穩(wěn)定性影響較小。基于CNFET的單端口三值SRAM單元設(shè)計(jì)為大容量存儲(chǔ)器的設(shè)計(jì)提供了方向。
參考文獻(xiàn)
[1] SRINIVASAN P,BHAT A S,MUROTIYA S L,et al.Design and performance evaluation of a low transistor ternary CNTFET SRAM cell[C].2015 International Conference on IEEE Electronic Design,Computer Networks&Automated Verification(EDCAV),2015:39-43.
[2] 唐偉童,汪鵬君,鄭雪松.基于CNFET的低功耗三值門(mén)電路設(shè)計(jì)[J].寧波大學(xué)學(xué)報(bào):理工版,2014,27(3):43-49.
[3] LIN S,KIM Y B,LOMBARDI F.CNTFET-based design of ternary logic gates and arithmetic circuits[J].IEEE Transaction on Nanotechnology.2011,10(2):217-225.
[4] DENG J,WONG H S P.A compact SPICE model for carbon-nanotube field-effect transistors including nonidealities and Its application-part I:model of the intrinsic channel region[J].IEEE Transactions on Electron Devices,2007,54(12):3186-3194.
[5] Stanford Nanoelectronics Lab.Stanford CNFET model and Schottky barrier CNFET model[EB/OL].[2015-12-18].http://nano.stanford.edu/model.php?id=23.
[6] 陳鳳嬌,簡(jiǎn)文翔,董慶,等.65 nm SRAM傳統(tǒng)靜態(tài)指標(biāo)的測(cè)試方案及研究[J].固體電子學(xué)研究與進(jìn)展,2012,61(6):613-618.
[7] 王謙,汪鵬君,龔道輝.基于CNFET的三值脈沖式D觸發(fā)器設(shè)計(jì)[J].寧波大學(xué)學(xué)報(bào):理工版,2016,29(1):37-41.
[8] KAMAR Z,NEPAL K.Noise margin-optimized ternary CMOS SRAM delay and sizing characteristics[C].Midwest Symposium on Circuits and Systems,2010:801-804.

