文獻(xiàn)標(biāo)識(shí)碼: A
DOI:10.16157/j.issn.0258-7998.199801
中文引用格式: 郭方金,王維波,陳忠飛,等. 太赫茲固態(tài)放大器研究進(jìn)展[J].電子技術(shù)應(yīng)用,2019,45(8):19-25.
英文引用格式: Guo Fangjin,Wang Weibo,Chen Zhongfei,et al. Research progress of THz solid state amplifier[J]. Application of Electronic Technique,2019,45(8):19-25.
0 引言
廣義上,太赫茲(THz)波指頻率處于100 GHz~10 THz(即對(duì)應(yīng)波長(zhǎng)為3 mm~30 ?滋m)范圍內(nèi)的電磁波。太赫茲波處在毫米波到紅外之間的過(guò)渡區(qū)域,是宏觀經(jīng)典理論向微觀量子理論的過(guò)渡,如圖1所示[1]。由于大功率源以及相關(guān)檢測(cè)設(shè)備的缺乏,這個(gè)頻段很長(zhǎng)一段時(shí)間沒(méi)有被科學(xué)家和工程師進(jìn)行相關(guān)研究,被稱為“太赫茲空隙”(THz gap)[1-6]。
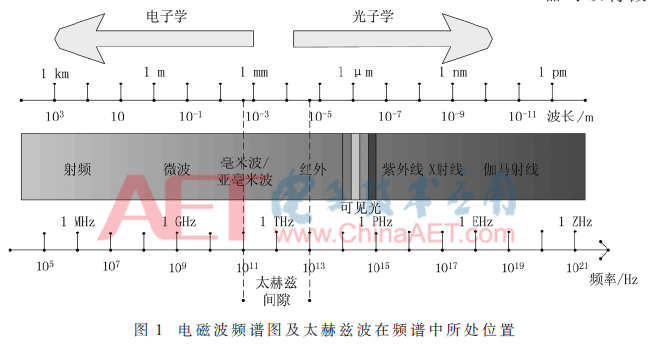
由于處于微波和光波之間的位置,太赫茲波綜合了電子學(xué)以及光子學(xué)的一些特征,同時(shí)又有著它獨(dú)特的特性:(1)穿透性:太赫茲波可以以不同的衰減率穿過(guò)不同介質(zhì)。大氣對(duì)于太赫茲波有著復(fù)雜的吸收作用,在0.1 THz~1 THz之間的太赫茲頻段分布著多個(gè)大氣窗口,如140 GHz、220 GHz、340 GHz、410 GHz、667 GHz等頻率附近為大氣窗口。(2)分辨率:成像分辨率隨著電磁波波長(zhǎng)減小而提高,將太赫茲波用于成像時(shí)分辨率好于微波。(3)光譜學(xué):不同固體和氣體材料對(duì)0.5 THz~3 THz的太赫茲波有不同的光譜特征,許多生物蛋白、半導(dǎo)體中電子和納米結(jié)構(gòu)共振頻率落在太赫茲頻段,使得太赫茲波可以用于材料無(wú)損檢測(cè)。(4)非電離性:因?yàn)樘掌澆ü庾幽芰康停⒉粫?huì)激發(fā)物體電離效應(yīng),使得太赫茲波應(yīng)用具有安全性。
正是因?yàn)橐陨咸匦裕沟锰掌澆ㄔ谔掌澩ㄐ拧⑻掌澇上瘛o(wú)損探測(cè)、雷達(dá)、電子對(duì)抗和精確制導(dǎo)等方面有廣闊的應(yīng)用空間。體積小并且能夠產(chǎn)生足夠輸出功率、頻率靈敏度的太赫茲源是太赫茲技術(shù)發(fā)展面臨的最大瓶頸之一。在電子學(xué)向光學(xué)過(guò)渡的太赫茲頻段,信號(hào)可以由電真空器件、固態(tài)器件以及光學(xué)技術(shù)等多種方法產(chǎn)生,如圖2所示[1]。其中電真空器件能產(chǎn)生足夠高的輸出功率,但是體積較大,工作需要高電壓,使用壽命和長(zhǎng)期可靠性差;光學(xué)太赫茲源具有極寬的輸出頻譜,且可調(diào)諧性能較好,輸出功率也較高;而固態(tài)器件的主要優(yōu)點(diǎn)是體積小、集成度高、可靠性高、規(guī)模化生產(chǎn)后成本低且供電要求低。
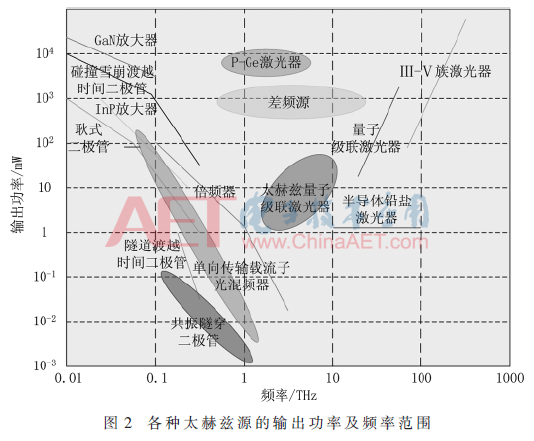
固態(tài)器件主要指采用基于半導(dǎo)體的固態(tài)電子器件構(gòu)成的微電子集成電路,這些電路可以實(shí)現(xiàn)太赫茲源,以及對(duì)太赫茲信號(hào)進(jìn)行混頻、倍頻和放大等功能,實(shí)現(xiàn)對(duì)特定頻率的太赫茲波的產(chǎn)生與探測(cè)。目前通過(guò)固態(tài)器件可以獲得頻率超過(guò)2 THz的太赫茲源和達(dá)到THz的信號(hào)探測(cè)和處理[6]。在太赫茲系統(tǒng)中,由于信號(hào)很微弱,因此增益和輸出功率是THz系統(tǒng)最為重要的資源。放大器可以將微弱的太赫茲信號(hào)進(jìn)行放大,它決定了系統(tǒng)的作用距離、抗干擾能力以及通信質(zhì)量和靈敏度,是太赫茲系統(tǒng)最關(guān)鍵的部件之一,用各類半導(dǎo)體實(shí)現(xiàn)的固態(tài)放大器可以使太赫茲系統(tǒng)集成度高、體積小、重量輕、能耗低。所以,太赫茲固態(tài)放大器成為了最具發(fā)展和應(yīng)用前景的太赫茲電路。
本文將介紹基于化合物半導(dǎo)體的太赫茲固態(tài)放大器的研究進(jìn)展,重點(diǎn)介紹基于GaN HEMT工藝、InP HEMT工藝和InP HBT/DHBT工藝的太赫茲單片放大器研究進(jìn)展。
1 半導(dǎo)體材料和器件分類
按照時(shí)間順序,可以將以Ge、Si為代表的半導(dǎo)體劃為第一代半導(dǎo)體,第一代半導(dǎo)體以大的晶體尺寸和窄的線條寬度為技術(shù)水平標(biāo)志,其產(chǎn)品以大規(guī)模、超大規(guī)模集成電路為代表,覆蓋了絕大部分的電子產(chǎn)品,推動(dòng)了信息社會(huì)的快速發(fā)展。以砷化鎵(GaAs)、InP等Ⅲ-Ⅴ族化合物為代表的半導(dǎo)體可以劃為第二代半導(dǎo)體,第二代半導(dǎo)體以通信速度、信息容量和存儲(chǔ)密度為技術(shù)水平標(biāo)志,其產(chǎn)品形式以微波、光發(fā)射和接收器件為主,大大推動(dòng)了微波、光通信產(chǎn)業(yè)的發(fā)展。以碳化硅(SiC)、GaN、氮化鋁(AlN)以及金剛石為代表的化合物可以劃為第三代半導(dǎo)體,第三代半導(dǎo)體主要以寬禁帶材料為主,禁帶寬度一般介于2 eV~7 eV之間。表1列出了Si、鍺化硅(SiGe)、GaAs、InP以及GaN半導(dǎo)體材料的特性參數(shù),可以看出,與第一代、第二代半導(dǎo)體相比,由于固有的寬禁帶寬度、高熱導(dǎo)率、高二維電子氣濃度、快的電子遷移率、高的擊穿電場(chǎng)等特性,使得以寬禁帶半導(dǎo)體材料為基礎(chǔ)的第三代半導(dǎo)體器件具有大功率密度、抗輻射、耐高溫、超高頻等優(yōu)異性能[7-8]。

用于太赫茲頻段放大器的半導(dǎo)體器件,可以按照半導(dǎo)體材料簡(jiǎn)單地分成兩類,一類是Si基器件,另一類是Ⅲ-Ⅴ族化合物基器件。Si基器件主要為互補(bǔ)金屬氧化物半導(dǎo)體(Complementary Metal Oxide Semiconductor,CMOS)器件和SiGe雙極互補(bǔ)金屬氧化物半導(dǎo)體(Bipolar CMOS,BiCMOS)器件,Ⅲ-Ⅴ族化合物器件主要包括GaAs贗配型高電子遷移率晶體管(Pseudomorphic HEMT,PHEMT)器件、GaAs改性高電子遷移率晶體管(Metamorphic HEMT,MHEMT)器件、InP HEMT器件、InP HBT器件和GaN HEMT器件。
在100 GHz以下頻段,尤其是RF頻段,Si基器件在半導(dǎo)體市場(chǎng)中占據(jù)主導(dǎo)地位,然而在太赫茲頻段應(yīng)用時(shí),Ⅲ-Ⅴ族化合物基器件比Si基器件更有優(yōu)勢(shì),主要表現(xiàn)在:
(1)Ⅲ-Ⅴ族化合物基器件比Si基器件有更高的電子遷移率,所以使得化合物基器件可以工作在更高的頻率;
(2)Ⅲ-Ⅴ族化合物基襯底材料電阻率比Si基襯底材料的電阻率高幾個(gè)數(shù)量級(jí),所以在Ⅲ-Ⅴ族化合物基襯底上制作的傳輸線、電感等損耗更低,尤其對(duì)于功率放大器而言,低電阻率的襯底可以降低器件效率,由于趨膚效應(yīng)引起的寄生參數(shù)和襯底損耗可以使得最大振蕩頻率fMAX下降至少36%~50%,也會(huì)降低器件在高頻的增益[9]。
(3)Ⅲ-Ⅴ族化合物基材料往往是寬帶隙材料,所以Ⅲ-Ⅴ族化合物基器件一般比Si器件具有更大的擊穿電壓。
然而相比Si基器件,Ⅲ-Ⅴ族化合物基器件也有自己明顯的劣勢(shì),主要表現(xiàn)在電路集成度低、成本高、長(zhǎng)期可靠性差、器件模型不夠精確和可用仿真軟件少等。
雖然Si基器件主要應(yīng)用在100 GHz以下頻段,但是隨著工藝的進(jìn)步,器件特征尺寸越來(lái)越小,器件最大振蕩頻率越來(lái)越高,使得Si基器件也可以應(yīng)用在太赫茲頻段。另外,CMOS絕緣襯底上硅(Silicon on Insulator,SOI)技術(shù)和SiGe技術(shù)可以從很大程度上減少襯底損耗,并且SiGe器件也可以提供大的功率密度,這些改善都使得Si基器件在太赫茲頻段的應(yīng)用非常有潛力,只不過(guò)目前從性能上來(lái)說(shuō),Ⅲ-Ⅴ族化合物基器件仍然優(yōu)于Si基器件。
2 基于GaN HEMT器件的太赫茲放大器研究進(jìn)展
20世紀(jì)90年代中期GaN HEMT誕生。GaN是寬禁帶材料,具有電子飽和速度高、擊穿場(chǎng)強(qiáng)高、SiC襯底導(dǎo)熱性好、抗輻照等特點(diǎn),且在AlGaN/GaN界面上存在自極化和壓電等新的物理效應(yīng),其二維電子氣密度高達(dá)2×1013 cm-2,因此GaN HEMT器件具有高功率密度的能力。但是,由于GaN相對(duì)較低的電子遷移率、頻率特性不是很好,因此GaN HEMT器件可以用來(lái)進(jìn)行THz低頻段功率放大器的設(shè)計(jì)。
美國(guó)HRL實(shí)驗(yàn)室在GaN HEMT器件和電路的研究上處于國(guó)際領(lǐng)先地位,該實(shí)驗(yàn)室報(bào)道的用于毫米波、THz頻段的GaN HEMT T型柵器件性能如表2所示,表中列出了3種不同柵長(zhǎng)T型器件的電流增益截止頻率fT、最大振蕩頻率fMAX、擊穿電壓Vbrk和50 GHz處最小噪聲系數(shù)Fmin。其中T4A器件fT=329 GHz和fMAX=558 GHz為目前已知的具有最高電流增益截止頻率和最大振蕩頻率的GaN HEMT器件。

2014年,文獻(xiàn)[10]報(bào)道了HRL實(shí)驗(yàn)室應(yīng)用T3器件設(shè)計(jì)的單級(jí)G波段功率放大器,放大器測(cè)試結(jié)果表明,輸出功率密度296 mW/mm,電路增益4.5 dB,效率3.5%,這是報(bào)道的第一款GaN G波段功率放大器。文獻(xiàn)[11]報(bào)道了采用同樣的T3器件,實(shí)現(xiàn)了一款110~170 GHz的寬帶功率放大器,增益>25 dB,噪聲系數(shù)大約6 dB,飽和輸出功率12 dBm,可以看出GaN HEMT器件不僅具有高的飽和輸出功率,而且具有相對(duì)較小的噪聲系數(shù)。文獻(xiàn)[12]報(bào)道了采用T2器件設(shè)計(jì)的G波段功率放大器,電路采用4級(jí)電路結(jié)構(gòu),每級(jí)管芯大小為4 μm×25 μm,電路在149 GHz處有最大增益8.7 dB,測(cè)得芯片最大輸出功率為18.2 dBm,這是已報(bào)道的G波段最大輸出功率的GaN MMIC功放。
應(yīng)用GaN HEMT器件的太赫茲功率放大器報(bào)道很少,除了HRL實(shí)驗(yàn)室的上述相關(guān)報(bào)道外,大部分報(bào)道集中在太赫茲頻段低端,也就是100 GHz附近。2006年,HRL實(shí)驗(yàn)室在文獻(xiàn)[13]中第一次報(bào)道了W波段GaN功放,從此,關(guān)于W波段的GaN功放報(bào)道逐漸增多。2010年HRL實(shí)驗(yàn)室報(bào)道了一款W波段功放,連續(xù)波條件下飽和輸出功率為842 mW,功率附加效率為14.7%,功率增益為9.3 dB[14]。2015年Quinstar公司報(bào)道了一款寬帶的W波段功放,電路工藝為HRL公司的T2工藝,芯片采用片上行波功率合成網(wǎng)絡(luò),連續(xù)波工作條件下,在75~100 GHz頻段最小輸出功率為2 W,峰值輸出功率為3 W,脈沖工作狀態(tài)下峰值輸出功率為3.6 W。芯片照片如圖3所示[15]。
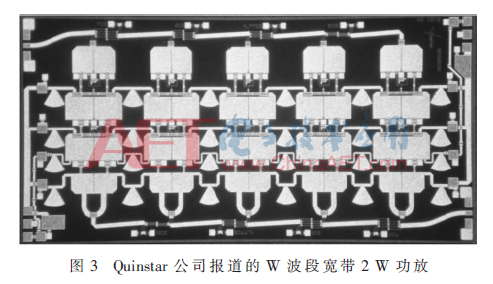
2017年德國(guó)IAF(Fraunhofer Institute for Applied Solid-State Physics)研究所報(bào)道了第一款采用三維柵GaN HEMT器件的W波段功放,采用三維柵結(jié)構(gòu)器件可以有效克服傳統(tǒng)平面柵引起的短溝道效應(yīng)。報(bào)道的功放在86~94 GHz頻段輸出功率為30.6 dBm,功率附加效率為8%,功率增益為12 dB[16]。
2018年美國(guó)加州大學(xué)圣巴巴拉分校報(bào)道了一款N-ploar型GaN HEMT器件,器件柵長(zhǎng)為75 nm,fT=113 GHz,fMAX=238 GHz,工作電壓20 V時(shí),功率密度為8 W/mm@94 GHz,是目前為止報(bào)道的W波段最高功率密度的GaN器件[17]。
與國(guó)外相比,國(guó)內(nèi)在太赫茲GaN功放研究方面也取得了一系列成果,與國(guó)外差距不大。2016年中國(guó)電科55所報(bào)道了一款W波段功放[18],采用0.1 μm GaN HEMT器件,器件fT=90 GHz,fMAX=210 GHz,芯片在90 GHz最大輸出功率為1.17 W,功率附加效率為13 %,功率增益為11 dB,輸出功率密度為2.3 W/mm。2017年中國(guó)電科55所又報(bào)道了一款平衡式W波段功放[19],功放采用0.1 μm GaN HEMT工藝制造,電路采用三級(jí)結(jié)構(gòu),在88~93 GHz頻段,小信號(hào)增益大于15 dB,輸出功率大于2.5 W,91 GHz實(shí)現(xiàn)峰值輸出功率3.1 W,輸出功率密度為3.23 W/mm,這是目前為止國(guó)內(nèi)報(bào)道的最高功率的W波段功放,功放芯片圖和性能曲線如圖4所示。中國(guó)電科13所公布了一款G波段功放產(chǎn)品,在210~220 GHz頻段,小信號(hào)增益大于15 dB,輸出功率大于10 dBm。中國(guó)電科55所研制的一款G波段功放采用50 nm GaN HEMT工藝,在150~170 GHz頻段,小信號(hào)增益大于25 dB,是目前為止國(guó)內(nèi)最高增益的G波段GaN功放。
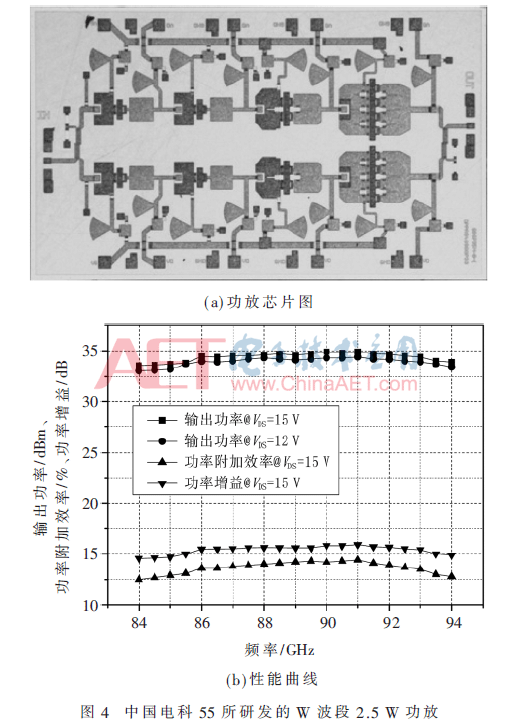
3 基于InP HEMT器件的太赫茲放大器研究進(jìn)展
InP是重要的Ⅲ-Ⅴ族化合物材料之一,是發(fā)展太赫茲頻段芯片的首選材料。由表1可以看出,相比其他材料,InP電子遷移率具有很大優(yōu)勢(shì),但是禁帶寬度較小,所以InP基器件可以用來(lái)進(jìn)行THz高頻、高增益、低噪聲的小信號(hào)放大器設(shè)計(jì)。InP基器件主要分為InP HEMT和InP HBT兩種,憑借優(yōu)異的頻率和增益性能,是用于THz芯片設(shè)計(jì)的最佳選擇。
近年來(lái)基于InP HEMT器件的太赫茲技術(shù)發(fā)展迅速,已經(jīng)開(kāi)發(fā)出了100 nm、50 nm、35 nm、30 nm、25 nm柵長(zhǎng)的典型器件,器件的fT、fMAX不斷提高,fMAX已經(jīng)可以達(dá)到1.5 THz,已經(jīng)研制了頻率在0.48 THz、0.67 THz、0.85 THz和大于1 THz的電路,在InP HEMT電路研究方面,美國(guó)諾格公司(Northrop Grumman)處在行業(yè)領(lǐng)先的位置。
2008年德國(guó)IAF研究所采用50 nm柵工藝技術(shù)制備了210 GHz低噪聲單片電路。該工藝采用溝道InGaAs含量為0.8的MHEMT材料,制備的管芯最大電流密度及最大跨導(dǎo)分別達(dá)到1 200 mA/mm及1 800 mS/mm。其管芯的fT和fMAX分別可達(dá)380 GHz及500 GHz,該電路可在180 GHz~210 GHz頻段內(nèi)增益達(dá)到16 dB,噪聲系數(shù)達(dá)到4.8 dB[20]。美國(guó)諾格公司(Northrop Grumman)2008年研制的35 nm InP HEMT器件,其fMAX達(dá)到了1.2 THz。2011年,諾格公司研制的0.65 THz低噪放在629~638 GHz增益達(dá)10 dB,在640 GHz其飽和輸出功率達(dá)到1.7 mW。該器件采用的是30 nm T型柵,材料是InAs/InGaAs組合溝道,管芯的最大電流密度和最大跨導(dǎo)分別達(dá)到900 mA/mm及2 300 mS/mm,其fT和fMAX分別為0.6 THz和1.2 THz[21]。2015年,諾格公司進(jìn)一步研制的1 THz低噪放,器件采用的是25 nm T型柵,其fT和fMAX分別為0.61 THz和1.5 THz,在1 THz處最大可用增益為3.5 dB。采用該工藝制備的10級(jí)CPW集成電路放大器,每級(jí)采用2 μm×4 μm管芯結(jié)構(gòu),測(cè)試結(jié)果顯示在1 THz處放大器增益為9 dB,在1.05 THz處增益為7 dB,這是目前為止報(bào)道的第一款可以工作在大于1 THz的放大器,電路照片和測(cè)試結(jié)果如圖5所示。該結(jié)果表明InP HEMT基放大器在THz高頻段潛力巨大,是未來(lái)THz放大器發(fā)展的重要方向[22]。2010年諾格公司報(bào)道了一款采用亞50 nm InP HEMT工藝的功放,芯片采用8路片上功率合成的方式,在217.5 GHz~220 GHz實(shí)現(xiàn)了輸出功率大于50 mW,是目前已報(bào)道的最大輸出功率的InP HEMT功放[23]。
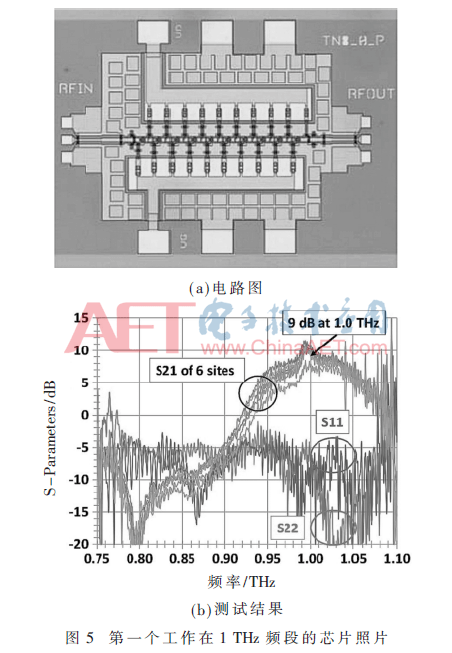
國(guó)內(nèi)在InP HEMT器件和電路方面也進(jìn)行了許多卓有成效的工作,主要研究單位有中國(guó)電子科技集團(tuán)公司第55、第13研究所、中國(guó)科學(xué)院微電子研究所等,2016年中國(guó)電科第55研究所報(bào)道了基于自主70 nm InP HEMT工藝的W波段低噪聲放大器,芯片在75~110 GHz頻段,增益大于20 dB,噪聲系數(shù)小于3.5 dB。中國(guó)電科55所目前已經(jīng)成功開(kāi)發(fā)了35 nm InP HEMT工藝,35 nm InP HEMT器件fT>400 GHz,fMAX>550 GHz。中國(guó)電科13所報(bào)道了基于90 nm InP HEMT工藝的220 GHz低噪聲放大器,增益為20 dB,噪聲系數(shù)為7.5 dB。
總體上,相比國(guó)外,國(guó)內(nèi)無(wú)論是在InP HEMT工藝水平還是電路性能上都差距比較大,今后還要加強(qiáng)在這一方向的研究。
4 基于InP HBT/DHBT器件的太赫茲放大器研究進(jìn)展
InP HBT/DHBT器件由發(fā)射極、集電極和基極組成,目前國(guó)外InP HBT器件發(fā)射極線寬已縮小到250 nm、200 nm、130 nm,fMAX>1 THz。InP HBT器件具有高頻率、高功率的特點(diǎn),因而可以用來(lái)進(jìn)行THz功放的設(shè)計(jì),InP HBT器件還具有相位噪聲低、頻帶寬、集成能力高的特點(diǎn),因而可以用來(lái)進(jìn)行線性功放和超高速電路的設(shè)計(jì),美國(guó)Teledyne公司在THz InP HBT電路研究方面處于行業(yè)領(lǐng)先的位置。
2011年美國(guó)Teledyne公司報(bào)道了130 nm InP DHBT技術(shù),發(fā)射區(qū)結(jié)面積為0.13 μm×2 μm,fT>520 GHz,fMAX>1.1 THz,共發(fā)射極擊穿電壓為3.5 V,這是當(dāng)時(shí)HBT器件的最高水平[24]。2013年Teledyne公司報(bào)道了采用130 nm InP DHBT工藝研制的670 GHz InP HBT放大器,在600~680 GHz頻段增益為20 dB,在片功率測(cè)試表明,585 GHz下飽和輸出功率為-4 dBm,670 GHz時(shí)飽和輸出功率為-7.5 dBm,這是已報(bào)道的工作頻率最高的放大器[25]。2015年,NGAS公司報(bào)道了600 GHz功率放大器,在傳統(tǒng)的200 nm InP HBT器件工藝基礎(chǔ)上將器件結(jié)構(gòu)從InP襯底轉(zhuǎn)移至SiC襯底,有效降低了HBT的結(jié)溫,提高了器件的高頻性能,制作的9級(jí)共發(fā)射極放大器小信號(hào)增益為9 dB,5級(jí)共基極放大器小信號(hào)增益為19 dB,這是目前報(bào)道的工作頻率最高的進(jìn)行了襯底轉(zhuǎn)移的放大器[26]。2014年諾格公司報(bào)道了一款220 GHz頻段的功率放大器,芯片采用250 nm InP HBT工藝,總的發(fā)射極面積為18 μm2,放大器在210~230 GHz頻段實(shí)現(xiàn)增益大約5 dB,在210 GHz實(shí)現(xiàn)最大飽和輸出功率90 mW,功率附加效率10%,這是在該頻段報(bào)道的最大功率附加效率的放大器[27]。2014年Teledyne公司報(bào)道了一款200 GHz左右的功放,功放采用250 nm InP HBT工藝,采用低插損的威爾金森功分器實(shí)現(xiàn)了3級(jí)16路功率單元的合成,芯片在10 dBm注入功率條件下,在210 GHz實(shí)現(xiàn)了23.2 dBm的功率輸出,在235 GHz實(shí)現(xiàn)了21 dBm的功率輸出,功率增益大于11 dB,在206~243 GHz頻段小信號(hào)增益大于24 dB,這是到目前為止第一款報(bào)道的在200 GHz以上頻段實(shí)現(xiàn)大于200 mW的MMIC芯片,代表了目前THz頻段大功率單片的最高水平[28]。
國(guó)內(nèi)在THz InP HBT/DHBT技術(shù)方面起步較晚,研制的電路主要集中在THz低頻段,研究單位主要包括中國(guó)科學(xué)院微電子研究所、中國(guó)電子科技集團(tuán)公司第55、第13研究所。近年來(lái),國(guó)內(nèi)在InP HBT工藝和器件研究方面不斷進(jìn)步,器件fT、fMAX不斷提高,InP HBT功率放大器頻率達(dá)330 GHz左右,中國(guó)電子科技集團(tuán)公司第55研究所代表了國(guó)內(nèi)最高水平[29]。2013年,55所報(bào)道了采用臺(tái)面結(jié)構(gòu)和平面化技術(shù)在3英寸InP襯底上設(shè)計(jì)和制作了InGaAs/InP DHBT,fMAX=325 GHz,擊穿電壓為10.6 V,適合開(kāi)發(fā)THz低頻段電路。2015年,該團(tuán)隊(duì)制作出了共基極四指In-GaAs/InP DHBT,發(fā)射極線寬縮短為0.5 μm,fMAX提高到535 GHz,擊穿電壓降至4 V[30]。2016年,55所報(bào)道了一款140 GHz左右HBT功率放大器,芯片采用0.5 μm InP DHBT工藝,電路拓?fù)浣Y(jié)構(gòu)采用四級(jí)共射放大電路結(jié)構(gòu),采用威爾金森功分器進(jìn)行四路功率合成,放大器在140~160 GHz頻段內(nèi),小信號(hào)增益大于20 dB,140 GHz時(shí)飽和輸出功率達(dá)13.6 dBm[31]。2018年,55所報(bào)道了一款工作在H波段的HBT功率放大器,芯片采用0.5 μm InP DHBT工藝,工作頻帶為275~310 GHz,在300 GHz增益大于7.4 dB,在280 GHz實(shí)現(xiàn)最大增益12.5 dB,這是國(guó)內(nèi)報(bào)道的第一款工作在H波段的 InP HBT功放[32],芯片圖和S參數(shù)測(cè)試結(jié)果如圖6所示。
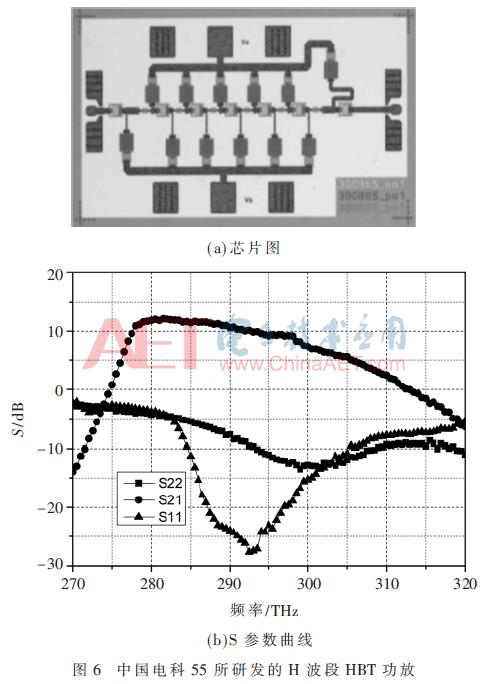
5 結(jié)論
THz固態(tài)放大器的發(fā)展是基于半導(dǎo)體技術(shù)和微波技術(shù)的共同進(jìn)步,目前Ⅲ-Ⅴ族化合物基THz固態(tài)放大器的研究已經(jīng)進(jìn)入THz頻段,以GaN HEMT、InP HEMT和InP HBT為代表的Ⅲ-Ⅴ族化合物基器件的技術(shù)進(jìn)步推動(dòng)著固態(tài)放大器向THz頻域的不同方向發(fā)展。
GaN HEMT基器件特征尺寸目前已經(jīng)可以達(dá)到20 nm,器件最大振蕩頻率可以達(dá)到558 GHz,在G波段已經(jīng)可以實(shí)現(xiàn)18.2 dBm的功率輸出。所以未來(lái)一段時(shí)間內(nèi),GaN HEMT基固態(tài)放大器的發(fā)展主要集中在THz的低頻段,包括W、D、G甚至H頻段。GaN HEMT基固態(tài)放大器除了可以實(shí)現(xiàn)高功率放大器外,還可以實(shí)現(xiàn)相比GaAs、InP等具有高P-1、耐大功率的低噪聲放大器,是未來(lái)實(shí)現(xiàn)THz收發(fā)一體多功能芯片的首選。
InP HEMT基器件特征尺寸目前已經(jīng)可以達(dá)到25 nm,器件最大振蕩頻率可以達(dá)到1.5 THz,在1 THz處已經(jīng)研制成功了放大器芯片,增益為9 dB。所以未來(lái)InP HEMT基固態(tài)放大器是實(shí)現(xiàn)THz頻段高頻、低噪聲放大器芯片的第一選擇。另外,在THz低頻段,InP HEMT基固態(tài)放大器通過(guò)片內(nèi)合成的方式,也可以實(shí)現(xiàn)小功率的放大器芯片。
InP HBT基器件特征尺寸已經(jīng)可以達(dá)到130 nm,器件最大振蕩頻率大于1.1 THz,已經(jīng)實(shí)現(xiàn)670 GHz頻段 HBT芯片,另外InP HBT基放大器實(shí)現(xiàn)了200 GHz附近大于200 mW的功率輸出。所以未來(lái)在200 GHz~1 THz頻段進(jìn)行高功率、高增益、寬帶、高線性放大器研究,InP HBT基放大器一定會(huì)成為優(yōu)先選擇。
國(guó)內(nèi)在THz固態(tài)放大器研究上已經(jīng)取得了一定的基礎(chǔ)和成果,但是與歐美等發(fā)達(dá)國(guó)家相比,還有很大差距,在THz半導(dǎo)體材料設(shè)計(jì)、THz器件結(jié)構(gòu)設(shè)計(jì)、THz器件建模、THz電路設(shè)計(jì)、THz測(cè)試技術(shù)以及THz電路可靠性等一系列關(guān)鍵技術(shù)上,國(guó)內(nèi)還有很大差距,目前國(guó)內(nèi)還沒(méi)有可以批量工程化應(yīng)用的THz芯片。未來(lái),隨著5G/6G技術(shù)、物聯(lián)網(wǎng)、信息感知等技術(shù)的發(fā)展,太赫茲技術(shù)必將成為影響國(guó)民經(jīng)濟(jì)、國(guó)防現(xiàn)代化的關(guān)鍵技術(shù),未來(lái)需要太赫茲領(lǐng)域相關(guān)從業(yè)者不斷努力,共同推進(jìn)國(guó)內(nèi)太赫茲技術(shù)的進(jìn)步。
參考文獻(xiàn)
[1] 李驍.太赫茲InP DHBT收發(fā)芯片關(guān)鍵技術(shù)研究[D].成都:電子科技大學(xué),2018.
[2] SIEGEL P H.Terahertz technology[J].IEEE Transaction on Microwave Theory and Technique,2002,50(3):910-928.
[3] HOSAKO I,SEKINE N.At the dawn of a new era in terahertz technology[J].Proceedings of IEEE,2007,95(8):1611-1623.
[4] 劉盛綱,姚建銓,張杰,等.太赫茲科學(xué)技術(shù)的新發(fā)展[C].第270次香山會(huì)議,北京,2005.
[5] 牧凱軍,張振偉,張存林.太赫茲科學(xué)與技術(shù)[J].中國(guó)電子科學(xué)研究院學(xué)報(bào),2009,6(3):221-230.
[6] 金智,蘇永波,張畢禪,等.InP基三端太赫茲固態(tài)電子器件和電路發(fā)展[J].太赫茲科學(xué)與電子信息學(xué)報(bào),2013,11(1):43-49.
[7] 姜霞.AlGaN/GaN HEMT模型研究及MMIC功率放大器設(shè)計(jì)[D].天津:河北工業(yè)大學(xué),2011.
[8] 李歐鵬.太赫茲InP HBT非線性模型及單片放大器研究[D].成都:電子科技大學(xué),2017.
[9] LIU I,MA K,MOU S,et al.A review of recent power amplifier IC[C].2017 10th Global Symposium on Millimeter-Waves,Hong Kong,2017:87-91.
[10] MARGOMENOS A.GaN technology for E,W and G-band applications[C].2014 IEEE Compound Semiconductor Integrated Circuit Symposium(CSICS),La Jolla,CA,2014:1-4.
[11] KURDOGHLIAN A.First demonstration of broadband W-band and D-band GaN MMICs for next generation communication systems[C].2017 IEEE MTT-S International Microwave Symposium(IMS),Honololu,HI,2017:1126-1128.
[12] FUNG A.Gallium nitride amplifiers beyond W-band[C].2018 IEEE Radio and Wireless Symposium(RWS),Anaheim,CA,2018:150-153.
[13] MICOVIC M.GaN HFET for W-band power applications[C].2006 International Electron Devices Meeting,San Francisco,CA,2006:1-3.
[14] MICOVIC M.W-Band GaN MMIC with 842 mW output power at 88 GHz[C].2010 IEEE MTT-S International Microwave Symposium,Anaheim,CA,2010:237-239.
[15] SCHELLENBERG J M.A 2-W W-band GaN traveling-wave amplifier with 25-GHz bandwidth[J].IEEE Transactions on Microwave Theory and Techniques,2015,63(9):2833-2840.
[16] TURE E.First demonstration of W-band Tri-gate GaN-HEMT power amplifier MMIC with 30 dBm output power[C].2017 IEEE MTT-S International Microwave Symposium(IMS),Honololu,HI,2017:35-37.
[17] ROMANCZYK B.Demonstration of constant 8 W/mm power density at 10, 30, and 94 GHz in state-of-the-art millimeter-wave N-Polar GaN MISHEMTs[J].IEEE Transactions on Electron Devices,2018,65(1):45-50.
[18] 吳少兵,高建峰,王維波,等.W波段GaN單片功率放大器研制[J].固體電子學(xué)研究與進(jìn)展,2016,36(4):266-269.
[19] SHAOBING W.W-band AlGaN/GaN MMIC PA with 3.1 W output power[C].2017 14th China International Forum on Solid State Lighting:International Forum on Wide Bandgap Semiconductors China(SSLChina:IFWS),Beijing,2017:219-223.
[20] TESSMANN A.Metamorphic HEMT MMICs and modules for use in a high-bandwidth 210 GHz radar[J].IEEE Journal of Solid-State Circuits,2008,43(10):2194-2205.
[21] RADISIC V,LEONG K M K H,MEI X,et al.Power amplification at 0.65 THz using InP HEMTs[J].IEEE Transactions on Microwave Theory and Techniques,2012,60(3):724-729.
[22] MEI X.First demonstration of amplification at 1 THz using 25-nm InP high electron mobility transistor process[J].IEEE Electron Device Letters,2015,36(4):327-329.
[23] RADISIC V.A 50 mW 220 GHz power amplifier module[C].2010 IEEE MTT-S International Microwave Symposium,Anaheim,CA,2010:45-48.
[24] URTEAGA M,PIERSON R,ROWELL P,et al.130 nm InP DHBTs with ft >0.52 THz and fmax>1.1 THz[C].69th Device Research Conference,Santa Barbara,CA,2011:281-282.
[25] HACKER J,URTEAGA M,SEO M,et al.InP HBT amplifier MMICs operating to 0.67 THz[C].2013 IEEE MTT-S International Microwave Symposium Digest(MTT),Seattle,WA,2013:1-3.
[26] RADISIC V.InP HBT transferred substrate amplifiers operating to 600 GHz[C].2015 IEEE MTT-S International Microwave Symposium,Phoenix,AZ,2015:1-3.
[27] RADISIC V,SCOTT D W,CAVUS A,et al.220-GHz high-efficiency InP HBT power amplifiers[J].IEEE Transactions on Microwave Theory and Techniques,2014,62(12):3001-3005.
[28] GRIFFITH Z,URTEAGA M,ROWELL P,et al.A 23.2 dBm at 210 GHz to 21.0 dBm at 235 GHz 16-Way PA-Cell combined InP HBT SSPA MMIC[C].2014 IEEE Compound Semiconductor Integrated Circuit Symposium(CSICS),La Jolla,CA,2014.
[29] 王淑華.THz InP HEMT和HBT技術(shù)的最新研究進(jìn)展[J].微納電子技術(shù),2018,55(6):381-387.
[30] NIU B,WANG Y,CHENG W,et al.Common base four-finger InGaAs/InP double heterojunction bipolar transistor with maximum oscillation frequency 535 GHz[J].Chinese Physics Letters,2015,32(7):175-178.
[31] 孫巖,程偉.140 GHz InP DHBT功率放大器[C].2016微波集成電路與移動(dòng)通信學(xué)術(shù)年會(huì),上海,2016.
[32] Sun Yan.A 300 GHz monolithic integrated amplifier in 0.5-um InP double heterojunction bipolar transistor technology[C].2018 International Conference on Microwave and Millimeter Wave Technology,ICMMT 2018-Proceedings,December,2018.
作者信息:
郭方金,王維波,陳忠飛,孫洪錚,周細(xì)磅,陶洪琪
(南京電子器件研究所,江蘇 南京210016)

