硅上GaN LED不必受應(yīng)力的影響,一定量的應(yīng)力阻礙了輸出功率。英國一個研究小組通過原位工具監(jiān)測溫度和晶片曲率,制備出低位錯密度的扁平型150mm外延片,并將這些芯片安裝到器件中,使得內(nèi)量子效率接近40%。
美國能源署認(rèn)為,LED照明的廣泛使用,將對成本更低、效率更高的商業(yè)器件提出了要求。這兩項標(biāo)準(zhǔn)被記錄到LED的路線圖中,比如,到2015年LED燈的發(fā)光效率達(dá)到150lm/W,成本低于5美元/千流明。
現(xiàn)今LED照明的成本比這個目標(biāo)高了1倍以上,僅芯片成本這一項就占去了約一半的成本。但是,通過把生產(chǎn)工藝轉(zhuǎn)向更大尺寸、更低成本的襯底,加工的成本得到控制,芯片的成本因此會降低一個數(shù)量級。
我們的英國研究聯(lián)盟是由RFMD英國公司領(lǐng)頭,其余成員來自劍橋大學(xué)、Aixtron UK、QinetiQ和Forge Europa,利用2007年4月開啟的英國政府基金,我們得到了450美元的資助,以求達(dá)成上述目標(biāo)。我們的研究工作致力于在150mm的硅平臺上開發(fā)出高質(zhì)量的LED。現(xiàn)在,RFMD已經(jīng)制備出內(nèi)量子效率(IQE)近40%的器件。
整項工作有具體的分配。劍橋大學(xué)負(fù)責(zé)前段,開發(fā)出制備高質(zhì)量器件材料的生長工藝;QinetiQ為其提供生長及工藝支持,利用豐富的半導(dǎo)體專業(yè)技術(shù)來確保材料開發(fā)能有效地進(jìn)行;之后交由LED制造商RFMD擴(kuò)大生產(chǎn);當(dāng)器件制造商啟動之后,市場工作就交給LED應(yīng)用專家Forge Europa公司來打理。
硅襯底在典型生長溫度下可保持穩(wěn)定性,成本低;它的直徑可上升至300mm,且硅表面適合外延生長,結(jié)合以上特點,硅襯底被選作生長氮化物的平臺。硅上氮化物外延片也能用到硅工業(yè)中標(biāo)準(zhǔn)的生產(chǎn)設(shè)備,使得芯片的生產(chǎn)更具成本效率,芯片能接受綁定,并轉(zhuǎn)變?yōu)榉庋b型LED。

一個由英國政府資助、領(lǐng)軍企業(yè)和研究機(jī)構(gòu)牽頭的項目,用MOCVD設(shè)備在150mm的硅(111)襯底上開發(fā)出硅上GaN LED,包括RFMD英國團(tuán)隊、劍橋大學(xué)、Aixtron UK、QinetiQ和Forge Europa。
如今LED生產(chǎn)使用的襯底材料一般是藍(lán)寶石和SiC,比起它們硅有著重要的優(yōu)勢,但也有一個致命的弱點,那就是硅與GaN的晶格和熱膨脹系數(shù)極度失配。在典型的生長溫度1000℃時,若GaN直接被沉積到硅襯底上,自此刻起在生長薄膜中產(chǎn)生了拉應(yīng)力,而且隨著晶片降至室溫,兩種材料之間不同的膨脹系數(shù)導(dǎo)致了拉應(yīng)力的增大。除非得到正確的控制,這種應(yīng)力甚至?xí)率笹aN薄膜的破裂。往往產(chǎn)生了晶片翹曲,這會讓面向硅加工設(shè)計的自動化設(shè)備束手無策。作為比較,當(dāng)?shù)锷L在SiC襯底上,彼此的熱膨脹和晶格系數(shù)相當(dāng);然而在藍(lán)寶石上生長時它們會引起GaN薄膜的緊縮,但這不會產(chǎn)生裂縫。
GaN與硅之間的晶格嚴(yán)重失配,致使外延片中的位錯密度相對高一些。雖然氮化物L(fēng)ED對高度位錯表現(xiàn)出難以置信的適應(yīng)性,藍(lán)光LED的位錯密度還是跌破109cm-2,IQE值也會隨之下降。
在初期生長階段,硅與反應(yīng)腔中的載氣發(fā)生反應(yīng),在晶體表面產(chǎn)生瑕疵,其表面形貌已不適合隨后的GaN生長,這是硅的另一弱點。
劍橋大學(xué)開發(fā)的藍(lán)光LED生產(chǎn)工藝可解決所有的這些問題。其中,利用Aixtron的CCS MOCVD設(shè)備制備外延結(jié)構(gòu),設(shè)備適合生長單個150mm晶片(或多個2英寸晶片),并配有原位監(jiān)測儀器用于測量晶片翹曲及溫度。在150mm的硅(111)襯底上,先沉積一層復(fù)雜的勢壘結(jié)構(gòu),以控制應(yīng)力和晶片曲率;接著,生長一個帶InGaN量子阱和GaN勢壘層的多量子阱(MQW)LED結(jié)構(gòu),能發(fā)出460nm的光;最后才是一個摻鎂p型GaN(圖1a)。
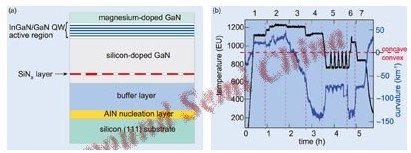
圖1.LED的結(jié)構(gòu)包括一個降低位錯的SiNx層(a);Aixtron的Argus工具與LayTec提供的Epicurve監(jiān)測器一起,可測量出晶片翹曲以及晶片溫度(b)。生長過程可分為四個步驟:預(yù)生長熱處理,AlN晶核層、勢壘層和n型GaN層,多量子阱區(qū)域和p型GaN層,以及退火/冷卻。
襯底在氫氣氛圍內(nèi)退火之后,移除本征半導(dǎo)體層并形成一個梯田狀,并回流至硅表面。生長過程如下:先沉積一個AlN晶核層,確保硅表面不會分解;接著是一個復(fù)雜的勢壘結(jié)構(gòu)。通過對勢壘層的成分和厚度進(jìn)行仔細(xì)的控制以平衡應(yīng)力;當(dāng)生長溫度降至室溫時,熱膨脹失配在結(jié)構(gòu)內(nèi)產(chǎn)生了應(yīng)力。
為了降低位錯密度、提高LED的性能,在勢壘層上又沉積GaN和AlGaN層。插入SiNX層是一項用于生長藍(lán)寶石上氮化物薄膜的技術(shù),在很大程度上能降低線位錯密度。
原位工具持續(xù)地監(jiān)測晶片的溫度和曲率是成功的關(guān)鍵,可再次生長出平整而無裂縫的材料。在劍橋大學(xué),反應(yīng)室內(nèi)襯底的溫度通過Aixtron的Argus工具進(jìn)行圖形表征,并利用LayTec的Epicurve提供實時的晶片曲率測量。
我們所使用的硅有輕微的凸起翹曲,一經(jīng)加熱和在位式退火之后會變成凹型,這是因為,此時襯底底端的溫度比頂面要高(圖1b)。AlN晶核層的添加使得凹型翹曲更為嚴(yán)重,但隨著勢壘層以及摻硅GaN層的生長,表面又呈現(xiàn)凸起狀,壓應(yīng)力隨之增加。量子阱的生長和勢壘層導(dǎo)致曲率發(fā)生了少許變化,我們能察覺到,之后往GaN層中摻雜鎂元素時,反應(yīng)腔內(nèi)的溫度會增加,晶片因而變得更加凸起。薄膜的拉應(yīng)力產(chǎn)生于GaN與硅之間存在的熱膨脹系數(shù)差異,通過沉積勢壘層匹配物,優(yōu)化其翹曲程度,這樣晶片在冷卻后還非常平整。
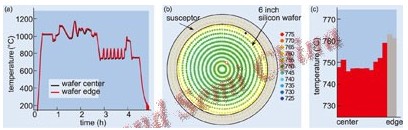
圖2.Aixtron的Argus溫度分布圖顯示了整個150mm晶片的剖面溫度。通過調(diào)整反應(yīng)腔加熱器的放射區(qū),能將任何差異逐一最小化(a, b, c)
生長工藝的開發(fā)把150mm外延片的生產(chǎn)帶入更佳狀態(tài),整個表面的高度變化低于50祄。這些晶片適合用RFMD的高產(chǎn)量生產(chǎn)設(shè)備來加工處理。
為確保晶片在冷卻時保持表面平整,必須在生長溫度時引入翹曲;由于襯底與基座之間有著距離差異,整塊晶片的溫度會有明顯的變動。溫度變化對InGaN LED生長不利,他們改變了量子阱中的銦組分以及發(fā)光波長。幸運的是我們能用Argus分布圖來監(jiān)測這些溫度變化,并通過調(diào)整三個加熱區(qū)的輸出功率將這些變化降至最小。
橫截面透射電子顯微鏡圖(TEM)顯示,器件層結(jié)構(gòu)中的SiNx層會改變?nèi)毕莸姆较蛏踔劣械南Р灰娏耍蚨鴮?dǎo)致了低位錯密度(圖3)。與AlN相比GaN的面內(nèi)晶格參數(shù)更大,它產(chǎn)生的壓應(yīng)力使得AlGaN/GaN界面也出現(xiàn)這種現(xiàn)象。
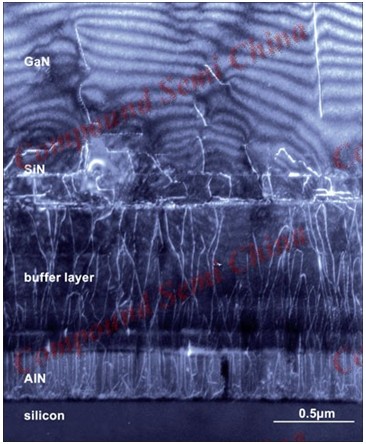
圖3.TEM圖中的淡線和深色區(qū)域展示出,SiN層有助于降低InGaN/GaN LED中的位錯密度。圖中純螺旋式/混合型的位錯清晰可見。
用TEM的平面圖來評估外延片中的位錯密度。匯同其它的原子力顯微鏡圖像(在860°C時將表面暴露在硅烷助熔劑下面,可突出凹坑),最終測得硅上GaN材料的位錯密度值低于109cm-2。
在曼切斯特大學(xué),研究人員使用光致光測量法PL(受溫度的影響)來評估材料的IQE值,在室溫下約為50%。使用這種方法的前提是,假定非輻射復(fù)合接近零基本予以忽略。生長在藍(lán)寶石上的類似結(jié)構(gòu),它的位錯密度是108cm-2,典型的IQE值是70%;這表明在硅平臺上制備高性能LED的時候,硅上氮化物的位錯密度不可能成為一個主要的問題。我們在QinetiQ繼續(xù)制備LED。通過刻蝕一個n型GaN層的臺面。接著,往上面沉積一層Ti/Al/Pt/Au合金以產(chǎn)生n型接觸;p型接觸是一個退火后的半透明NiAu和一個更厚的金接觸焊盤。
我們最好的0.5×0.5mm LED,它所呈現(xiàn)的I-V特性與藍(lán)寶石上GaN器件極其相似,開通電壓約是2.5V(圖4),使用相同的光學(xué)方法測量兩種器件的頂部光輸出,結(jié)果發(fā)現(xiàn)藍(lán)寶石基LED產(chǎn)生的光輸出是硅器件的兩倍。考慮到硅襯底的光吸收較大,對LED正向的總發(fā)光量進(jìn)行測量,據(jù)計算硅上LED的IQE是37%。
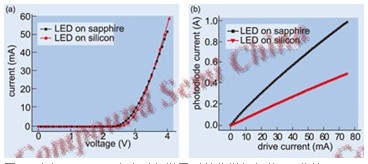
圖4. 硅上GaN LED產(chǎn)生了與常用器件非常相似的I-V曲線(a);但這種類型器件的光輸出不到一半左右(b)

圖5 硅、藍(lán)寶石和SiC之比較
硅上LED仍處于早期階段,但初始結(jié)果令我們非常振奮。移除硅襯底可防止光吸收,但它將不再對制造商構(gòu)成威脅,原因是高亮度LED生產(chǎn)通常會采取倒裝焊接和襯底移除。通過使用先進(jìn)的封裝及合適的熒光粉,我們現(xiàn)有的器件的發(fā)光效率可達(dá)70lm/W,這與基于藍(lán)寶石的LED形成了對照。由于硅的成本低,這意味著,在硅上生長的GaN LED將接近美國能源署關(guān)于2012年每千流明成本所需達(dá)到的目標(biāo)。這些將促使我們的器件成為固態(tài)照明應(yīng)用中名副其實的競爭者。隨著原位生長技術(shù)的提高,帶來了更高質(zhì)量的材料,為此器件的性能只會變得更好。

