摘 要: 介紹了系統(tǒng)級封裝的概念和特性,闡述了SiP設(shè)計的關(guān)鍵技術(shù)和基本生產(chǎn)實現(xiàn)流程。設(shè)計了一款基于ARM和FPGA管芯的SiP通用微處理系統(tǒng),介紹了該SiP系統(tǒng)的整體框圖,并詳細(xì)分析了系統(tǒng)各部分電路的功能結(jié)構(gòu)。該系統(tǒng)具有體積小、功耗低及功能完備等優(yōu)點,充分展現(xiàn)了SiP技術(shù)的優(yōu)越性。
關(guān)鍵詞: 系統(tǒng)級封裝;ARM;FPGA;管芯
封裝是連接半導(dǎo)體芯片和電子系統(tǒng)的一道橋梁,隨著半導(dǎo)體產(chǎn)業(yè)的飛速發(fā)展及其向各行業(yè)的迅速滲透,電子封裝已經(jīng)逐步成為實現(xiàn)半導(dǎo)體芯片功能的一項關(guān)鍵技術(shù),受到了越來越多的關(guān)注。近幾年,消費類電子和特殊應(yīng)用環(huán)境對嵌入式系統(tǒng)設(shè)計的迫切需要帶動了電子封裝產(chǎn)業(yè)的高速發(fā)展。電子封裝技術(shù)正朝著多功能、高度集成、高可靠性、小型化等方向發(fā)展,應(yīng)用領(lǐng)域也從之前的傳統(tǒng)消費類電子設(shè)備領(lǐng)域擴(kuò)展到雷達(dá)、聲吶、醫(yī)學(xué)影像和石油勘探等領(lǐng)域。
目前,業(yè)界高度集成化的電子系統(tǒng)主要有系統(tǒng)級芯片SoC(System on Chip)和系統(tǒng)級封裝SiP(System in Package)兩種。SoC技術(shù)相對比較成熟,已經(jīng)在電子系統(tǒng)中大量使用,但卻越來越受到工藝、可靠性等方面的限制。SiP是基于SoC的一種新型的封裝技術(shù),它將一個或多個芯片及無源器件構(gòu)成的高性能模塊以芯片管芯的形式堆疊在一個殼體內(nèi),從而使封裝由單一芯片升級為系統(tǒng)級芯片[1]。與SoC相比,SiP具有系統(tǒng)開發(fā)成本低、研制周期短、集成度高及可靠性高等優(yōu)點。
SiP技術(shù)功能可定制、體積小、功耗低和重量輕的特點適應(yīng)了嵌入式系統(tǒng)的發(fā)展需求,在嵌入式領(lǐng)域獲得了越來越多的關(guān)注和應(yīng)用。本文設(shè)計了一款采用ARM和FPGA管芯設(shè)計實現(xiàn)的SiP系統(tǒng)級封裝,該系統(tǒng)將具有多種功能的通用微處理系統(tǒng)封裝在一顆很小的SiP芯片內(nèi),體積小、功耗低且功能齊全,實現(xiàn)了系統(tǒng)的高度集成。
1 系統(tǒng)總體設(shè)計
圖1為SiP內(nèi)部結(jié)構(gòu)框圖,該SiP系統(tǒng)級封裝以ARM處理器和FPGA控制器為核心構(gòu)建。采用ARM為主處理器,負(fù)責(zé)整個系統(tǒng)的控制和管理;FPGA作為系統(tǒng)的主橋控制器,完成系統(tǒng)多功能外設(shè)的綜合調(diào)度管理。FPGA內(nèi)部完成離散量、PWM、串口、A/D、D/A等控制邏輯,實現(xiàn)了16路模擬量輸入、2路模擬量輸出、8路PWM輸入、16路PWM輸出、5路離散量輸入、5路離散量輸出、6路RS-232、6路RS-422、1路RS-485等功能。
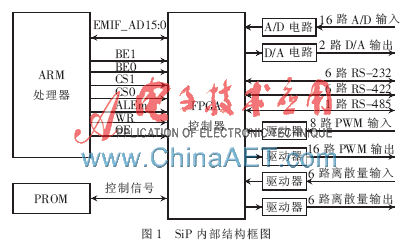
不同于傳統(tǒng)的封裝器件,SiP系統(tǒng)級封裝設(shè)計選用的所有器件均為芯片管芯,在該系統(tǒng)設(shè)計中,ARM處理器選用Silicon Labs公司的SIM3U167 ARM Cortex-M3管芯,F(xiàn)PGA選用Xilinx公司的XQV6000管芯,系統(tǒng)的其他功能電路(如PROM電路、A/D及D/A電路、接口驅(qū)動電路)均采用相應(yīng)的芯片管芯設(shè)計。該SiP系統(tǒng)的最終實現(xiàn)形式為BGA304塑體封裝芯片,所有功能信號、CPU下載、FPGA下載、電源信號均以管腳形式引到芯片管腳上。設(shè)計中芯片還預(yù)留了部分通用I/O管腳,以實現(xiàn)用戶開發(fā)時的自定義功能。用戶通過搭建簡單的基礎(chǔ)外圍電路,便可實現(xiàn)具有上述功能的完整復(fù)雜系統(tǒng)。
2 系統(tǒng)電路結(jié)構(gòu)
2.1 ARM電路
ARM作為系統(tǒng)的CPU,負(fù)責(zé)整個系統(tǒng)的控制和管理,圖2為ARM與FPGA電路的連接結(jié)構(gòu)[2]。其中,EMIF為外部存儲器總線,該ARM芯片支持地址數(shù)據(jù)分用模式和復(fù)用模式兩種模式,復(fù)用模式下最高可支持24位數(shù)據(jù),本系統(tǒng)選用的是復(fù)用模式,EMIF_AD15:0為16位地址數(shù)據(jù)復(fù)用總線。ARM通過WR寫使能信號、OE讀使能信號、ALEm地址鎖存信號、CSx片選信號和BEx字節(jié)使能信號控制FPGA芯片,實現(xiàn)對系統(tǒng)外圍電路的控制。其中,ALEm信號、BEx信號僅在復(fù)用模式下使用。系統(tǒng)采用的SIM3U167芯片是一款高性能處理器,具有256 KB Flash和32 KB SRAM片上存儲器,支持很多外圍通用接口。本系統(tǒng)根據(jù)設(shè)計需要,將1路UART、1路USART、1路SPI、1路I2C、1路USB、2路12位A/D轉(zhuǎn)換、2路10位D/A轉(zhuǎn)換接口信號引到了SiP的外部管腳上。
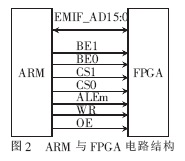
2.2 PROM電路
FPGA一般需要PROM芯片存儲邏輯加載文件,本系統(tǒng)選用國微公司的SM18V04管芯作為FPGA的外圍配置器件。該管芯分并行加載和串行加載兩種方式[3],此處選用串行加載方式,在該模式下,數(shù)據(jù)以每TCK一位的速度加載配置數(shù)據(jù),加載速度可達(dá)33 MHz。PROM配置電路結(jié)構(gòu)如圖3所示。

除TDI、TDO、TMS和TMK 4個JTAG專用邊界掃描信號外,F(xiàn)PGA與PROM之間還需一組控制信號,包括D0(配置數(shù)據(jù)輸入)、CCLK(配置時鐘)、DONE(FPGA配置完成)、PROG(觸發(fā)重配置)和INIT(配置初始化)5個信號,上電時PROM通過這些控制信號將配置數(shù)據(jù)加載到FPGA中,啟動系統(tǒng)正常運行。
2.3 模擬量輸入電路
系統(tǒng)具有16路模擬信號采集功能,電壓幅度范圍為-10 V~+10 V,實現(xiàn)框圖如圖4所示。信號通過1片16選1多路開關(guān)選通16路模擬信號中的1路信號進(jìn)行A/D轉(zhuǎn)換,F(xiàn)PGA產(chǎn)生通道選擇信號A3~A0,決定最終轉(zhuǎn)換哪路模擬信號。多路開關(guān)選用ADI公司的ADG506管芯實現(xiàn),通過多路開關(guān)選通后的信號要經(jīng)過一級運算放大器進(jìn)行電壓跟隨處理,電壓跟隨器輸入阻抗非常大,輸出阻抗非常小,可提高通道帶負(fù)載能力。

2.5 離散量與PWM電路
外部離散量與PWM輸入信號均為5 V TTL電平,而FPGA能處理的信號為3.3 V CMOS電平,因此,離散量與PWM信號在輸入、輸出時需要通過驅(qū)動器進(jìn)行電平轉(zhuǎn)換,電平轉(zhuǎn)換結(jié)構(gòu)如圖6所示。驅(qū)動器選用國微公司的SM164245管芯,該芯片由兩組8位雙向數(shù)據(jù)緩沖器組成,每組數(shù)據(jù)緩沖器由一個DIR方向控制信號和一個OE#使能信號控制,兩信號均由FPGA邏輯產(chǎn)生,PWM和離散量的最終處理也由FPGA邏輯實現(xiàn)。

基板[5]選擇一般參考材料的熱膨脹系數(shù)CTE、介電常數(shù)、介質(zhì)損耗、電阻率和導(dǎo)熱率等因素。商用SiP產(chǎn)品一般都選擇有機(jī)基板,它是以高密度多層布線和微孔基板技術(shù)為基礎(chǔ)制造的,具有較低的互連電阻和介電常數(shù),成本低,但存在芯片與基板之間CTE差高、熱失配大、穩(wěn)定性差等局限性。工業(yè)級產(chǎn)品一般多采用成本較高的陶瓷基板,其散熱優(yōu)良、氣密性好、可靠性高。
裸片與基板連接通常有引線鍵合(Wire Bonding)和倒裝焊(Flip-Chip)兩種方法。Wire Bonding加工靈活、成本低、可靠性高,但連接效率和焊接精度低。Flip-Chip具有焊接點牢固、信號傳輸路徑短、電源/地分布廣、I/O密度高、封裝體尺寸小和可靠性高等優(yōu)點,但加工成本相對較高。
3.2 SiP封裝制造工藝
SiP一般采用BGA塑體封裝或陶瓷封裝形式[3],因此加工生產(chǎn)流程主要也是BGA封裝經(jīng)常采用的Wire Bonding BGA(WB-BGA)和FlipChip BGA(FC-BGA)兩種工藝。但由于SiP系統(tǒng)級封裝是由多顆管芯堆疊而成的,與普通單一功能的BGA芯片還不完全相同,可能會遇到裸片中既有支持WB工藝芯片,也有支持FC工藝芯片的情況,此時就需要采用混合SiP工藝流程。圖8給出了SiP混合工藝流程的流程圖。本系統(tǒng)較一般的SiP封裝設(shè)計,埋入的管芯和無源器件種類多、數(shù)量大,最終采用混合工藝流程生產(chǎn)實現(xiàn)。
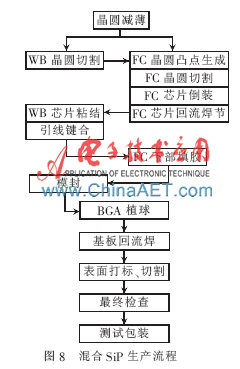
本文對SiP設(shè)計的關(guān)鍵技術(shù)和生產(chǎn)實現(xiàn)進(jìn)行了介紹,并以此為基礎(chǔ),詳細(xì)闡述了一款采用ARM和FPGA實現(xiàn)的SiP系統(tǒng)級封裝系統(tǒng),該芯片功能齊全、性能穩(wěn)定,相對于傳統(tǒng)的單板系統(tǒng),其具有可定制、體積小、功耗低、重量輕等優(yōu)點,值得在以后的微處理系統(tǒng)中推廣使用。SiP技術(shù)是一種飛速發(fā)展的IC封裝技術(shù),正受到越來越多的關(guān)注和推進(jìn),必將成為未來電子封裝的主流發(fā)展方向,為嵌入式系統(tǒng)的發(fā)展提供一種全新的解決途徑。
參考文獻(xiàn)
[1] 韓慶福,成立,嚴(yán)雪萍,等.系統(tǒng)級封裝(SIP)技術(shù)及其應(yīng)用前景[J].半導(dǎo)體技術(shù),2007,32(5):374-377.
[2] 朱曉鵬,肖鐵軍,趙蕙.ARM+FPGA的實時數(shù)據(jù)采集系統(tǒng)設(shè)計[J].計算機(jī)工程與設(shè)計,2009,30(13):3088-3090.
[3] 何賓.Xilinx可編程邏輯器件設(shè)計技術(shù)詳解[M].北京:清華大學(xué)出版社,2010.
[4] 李揚(yáng),劉揚(yáng).SiP系統(tǒng)級封裝設(shè)計與仿真[M].北京:電子工業(yè)出版社,2012.
[5] 陳貴寶,閻山.系統(tǒng)級封裝技術(shù)現(xiàn)狀與發(fā)展趨勢[J].電子工藝技術(shù),2007,28(5):273-275.

