文獻(xiàn)標(biāo)識碼: A
DOI:10.16157/j.issn.0258-7998.174429
中文引用格式: 李文杰,李冬梅. 幾種基于PLC的硅片清洗設(shè)備流量控制方法[J].電子技術(shù)應(yīng)用,2018,44(4):69-72,76
英文引用格式: Li Wenjie,Li Dongmei. Flowrate control methods based on PLC in wafer clean tool[J]. Application of Electronic Technique,2018,44(4):69-72,76
0 引言
集成電路制造過程中的硅片清洗是指在氧化、光刻、外延、擴(kuò)散和引線蒸發(fā)等工序前,采用物理或化學(xué)方法去除硅片表面的污染物和自身氧化物,以得到符合清潔度要求的硅片表面的過程[1]。硅片需要及時進(jìn)行清洗去除其表面的污染顆粒,以避免污染顆粒以初始的物理吸附形式轉(zhuǎn)化為化學(xué)吸附形式[2],以及降低污染顆粒在光刻階段對光刻膠黏附力的影響,避免造成浮膠等問題[3];同時由于低k 介質(zhì)材料的機(jī)械強(qiáng)度遠(yuǎn)低于傳統(tǒng)材料,還要避免在晶片清洗過程中化學(xué)藥液浸潤到多孔結(jié)構(gòu)中對器件結(jié)構(gòu)造成腐蝕,形成缺陷[4]。
在半導(dǎo)體生產(chǎn)工藝中,幾乎每道工序中都需要進(jìn)行清洗,圓片清洗質(zhì)量的好壞對器件性能有重要的影響[5-6]。清洗工藝過程中藥液的流量和濃度對硅片表面金屬的腐蝕速率和均勻性有很大的影響。流量不穩(wěn)定會導(dǎo)致化學(xué)藥液在晶片表面形成的液膜不均勻,繼而新舊化學(xué)藥液在晶片表面的傳遞速度和化學(xué)藥液在整張晶片表面的反應(yīng)速度不均勻,造成整張晶片清洗效果的一致性較差,最終影響到芯片的良率。圖1是根據(jù)測算數(shù)據(jù)制作的腐蝕效果圖,可以看出在流量不穩(wěn)定時,整個硅片的腐蝕不均衡,如圖1(a)所示,相差達(dá)到0.925 ![]() ;在進(jìn)行流量穩(wěn)定性的優(yōu)化之后,硅片的腐蝕均勻性有明顯改善,如圖1(b)所示。因此,保證清洗設(shè)備藥液流量的穩(wěn)定非常重要。
;在進(jìn)行流量穩(wěn)定性的優(yōu)化之后,硅片的腐蝕均勻性有明顯改善,如圖1(b)所示。因此,保證清洗設(shè)備藥液流量的穩(wěn)定非常重要。

1 單腔室清洗設(shè)備流量控制設(shè)計
單腔室硅片清洗設(shè)備主要應(yīng)用于半導(dǎo)體工藝測試和小批量產(chǎn)品生產(chǎn),對控制精度要求很高,以得到良好的試驗(yàn)、生產(chǎn)效果。
清洗設(shè)備的藥液供給的動力由磁懸浮泵提供,泵引入反饋信號可實(shí)現(xiàn)對藥液壓力或流量的閉環(huán)控制。磁懸浮泵是一種沒有軸承、不需要潤滑且無機(jī)械摩擦的電磁感應(yīng)驅(qū)動流體泵[7],其葉輪和泵體之間沒有結(jié)構(gòu)連接,可以有效避免葉輪旋轉(zhuǎn)過程中產(chǎn)生污染顆粒的風(fēng)險,同時提高了工作效率,節(jié)省能源。
由于只有一個腔室,磁懸浮泵直接引入腔室的流量信號作為反饋信號。此外,單個腔室總工藝流量較小,藥液在CDS內(nèi)循環(huán)加熱時,熱量傳輸較慢,因此一般要在循環(huán)管路上增加一段旁路以加大CDS總流量,旁路流量可以通過針閥調(diào)節(jié)。同時,在藥液加熱前期,加熱器輸出功率較大,大量的高溫液體需要進(jìn)行快速的流通,因此還要在循環(huán)管路增加一路更大流量的旁路,旁路只需控制通斷。管路結(jié)構(gòu)如圖2所示。
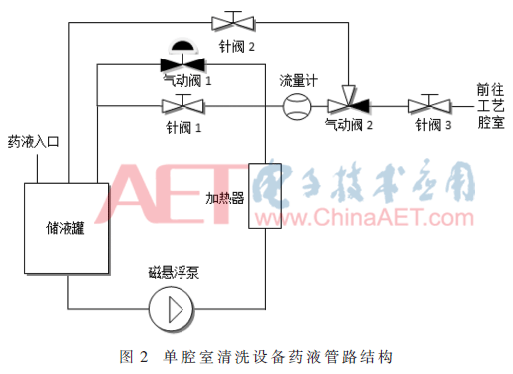
工藝腔室沒有進(jìn)行清洗時,藥液經(jīng)過流量計和氣動閥2后,從針閥2回到儲存罐;工藝腔室需要藥液時,只需驅(qū)動氣動閥2,藥液便可從針閥3進(jìn)入腔室。一般情況下,氣動閥動作切換藥液流經(jīng)管路,管路背壓產(chǎn)生瞬時變化,會造成藥液實(shí)際流量突變,然后磁懸浮泵會通過自動調(diào)節(jié)轉(zhuǎn)速以使流量重新達(dá)到平衡,如圖3所示。這種流量的瞬時波動會對清洗過程產(chǎn)生不利的影響。

為了減小氣動閥切換時產(chǎn)生的流量波動,可先控制磁懸浮泵以固定轉(zhuǎn)速運(yùn)行,然后分別對供給和返回兩管路的針閥開度進(jìn)行調(diào)節(jié),使氣動閥2切換時,其流量穩(wěn)定在工藝流量。
圖4是磁懸浮泵流量模式運(yùn)行過程中的流量、速度變化曲線,依照這種流量調(diào)節(jié)方法,藥液在供液和循環(huán)之間切換時,兩路支路的背壓基本一致,磁懸浮泵的運(yùn)行速度不變,并且氣動閥切換時,不會產(chǎn)生流量的瞬時變化,可以提高硅片清洗時的工藝效果。

2 多腔室清洗設(shè)備流量控制設(shè)計
多腔室硅片清洗設(shè)備是半導(dǎo)體制造業(yè)中的主流設(shè)備,具有清洗效果好、使用效率高的特點(diǎn)[8]。其中,對于硅片的不同特征尺寸,其相對應(yīng)的清洗設(shè)備采用了不同的流量控制設(shè)計:90~45 nm清洗設(shè)備使用磁懸浮泵加壓力傳感器的控制方式,通過針閥手動調(diào)節(jié)各腔室流量;而28 nm以下清洗設(shè)備則增加了流量調(diào)節(jié)閥自動控制腔室流量。
藥液工藝流量一般是通過磁懸浮泵和反饋信號進(jìn)行閉環(huán)控制的,對于單腔室的清洗設(shè)備,反饋信號可以直接采用流量信號;而對于多腔室清洗設(shè)備,由于流量信號較多,一般只采用主傳輸管路中的壓力信號作為反饋信號,各腔室通過調(diào)節(jié)支路管路中的針閥開度,調(diào)整各腔室藥液流量值和一致性。多腔室流量控制系統(tǒng)如圖5所示。

為了保證清洗設(shè)備每個腔室都有足夠流量的藥液,并降低單個磁懸浮泵轉(zhuǎn)速,CDS采用2個磁懸浮泵串聯(lián)設(shè)計,泵的閉環(huán)控制方案如圖6所示。PLC下發(fā)設(shè)定壓力(P0)和壓力傳感器檢測到的實(shí)際壓力(PV)到主動泵,主泵通過比較設(shè)定壓力和實(shí)際壓力的差值建立運(yùn)行速度與壓力的對應(yīng)關(guān)系,具體方程如下[9]:

式(1)表示磁懸浮泵速度算法采用比例積分進(jìn)行調(diào)節(jié),系數(shù)KP、KI可根據(jù)泵響應(yīng)速率進(jìn)行修改。

為保持兩個磁懸浮泵的同步性,PLC實(shí)時讀取主動泵實(shí)際速度(V1),并將其運(yùn)行速度(V1)作為設(shè)定速度(V0)下發(fā)到從泵,兩個泵串聯(lián)同步同速運(yùn)行,以二級升壓的方式形成液體的出口壓力。同時PLC可由壓力傳感器實(shí)時檢測變化的實(shí)際壓力(PACT),并且作為新的PV值下發(fā)到主動泵。通過控制磁懸浮泵自動調(diào)整運(yùn)行速度,使出口壓力穩(wěn)定在設(shè)定值(P0),即可實(shí)現(xiàn)藥液壓力的閉環(huán)控制。
這種磁懸浮泵串聯(lián)設(shè)計的優(yōu)點(diǎn)在于,既降低了磁懸浮泵的轉(zhuǎn)速,增加了泵的使用壽命,還能提供足夠壓力的藥液,保持壓力的穩(wěn)定。
CDS主供液管路內(nèi)藥液壓力足夠大時,各工藝腔室的藥液流量則可以通過流量控制元件調(diào)整。如圖4所示,當(dāng)有工藝腔室需要供液時,PLC控制打開支路管路上氣動閥,然后通過手動調(diào)節(jié)各支路上針閥開度,使流量計檢測到的流量穩(wěn)定在工藝設(shè)定值。管路流量、壓力關(guān)系如式(2)所示,當(dāng)管路設(shè)計和液體確定后,流量系數(shù)(Cv)、流體密度(ρ)都是固定值,流量(Q)僅與壓力(P)和管路截面積(S)有關(guān),因此只要保證壓力穩(wěn)定可控、針閥開度不變,藥液流量將保持穩(wěn)定。

這種藥液流量的控制方法比較容易實(shí)現(xiàn),缺點(diǎn)是需要定期校準(zhǔn),且流量是開環(huán)控制,因此28 nm以下制程的清洗設(shè)備采用壓力和流量雙閉環(huán)的控制方法。壓力控制仍采用磁懸浮泵的控制方法,流量閉環(huán)控制則通過流量控制閥實(shí)現(xiàn)。PLC輸出4~20 mA流量信號作為流量控制閥的設(shè)定值,閥體則根據(jù)內(nèi)部流量計讀取的流量值自動調(diào)整開度,使流量最終穩(wěn)定在設(shè)定值。圖7是設(shè)定流量在1.2 L/min時的流量變化曲線,可以看出流量控制閥可以較迅速地控制流量,且控制精度非常高。

3 藥液配比流量控制
隨著芯片特征尺寸的減小,硅片清洗工藝會采用經(jīng)過配比后的混合藥液,混合藥液對成分精度要求很高[10],藥液配比過程需要精確控制。藥液配比一般在藥液填充儲存罐時進(jìn)行,即將各種藥液以所需的比例同時注入儲存罐,因此在注入過程中,只要控制了各藥液的流量,即控制了混合藥液的比例。
如圖8所示,儲存罐的每一路藥液支路上都設(shè)計有控制流量裝置。對于藥液比值接近的混合液,各支路藥液可采用流量控制器或磁懸浮泵與流量計作為流量控制裝置。對于藥液比值較大的混合液,較大流量支路設(shè)計流量控制器、小流量支路設(shè)計脈沖計量泵來控制流量,計量泵每個動作往儲存罐補(bǔ)充精確體積的藥液,可以提高混合藥液比例精度。

藥液配比一般包括多藥液混合和藥液稀釋,對于一些用于硅片清洗非常用藥液,可能需要通過其他常用藥液進(jìn)行配比后才能得到。其中多藥液混合一般可以采用上一節(jié)的方法,即磁懸浮泵和流量計的閉環(huán)控制方法實(shí)現(xiàn),每種藥液都設(shè)計一個小的循環(huán)系統(tǒng),磁懸浮泵以流量模式往儲液罐供給一定流量的藥液。藥液稀釋則是用一定比例的高純水和藥液進(jìn)行混合,根據(jù)不同稀釋比例需采用不同的配比方法。稀釋比例大(如1:300)的藥液配比,藥液管路也可以采用磁懸浮泵進(jìn)行供給,而一般廠務(wù)的高純水系統(tǒng)可提供較大的供給壓力,因而水管路可以采用流量控制器來控制供給流量。
流量控制器由控制器、流量計和閥體3個部分組成,流量控制過程PLC向流量控制器下發(fā)4~20 mA的電流信號后,控制器可根據(jù)從流量計讀取到的管路內(nèi)流量,通過控制器內(nèi)部PID算法自動調(diào)整閥體開度,使流量計讀數(shù)等于設(shè)定值。一般情況下,流量控制器流量誤差可保持在±10 mL/min之內(nèi),完全滿足控制要求。流量控制器的控制示意圖如圖9所示。

藥液稀釋比例大(如1:1 000)的情況下,一般廠端高純水供應(yīng)流量低于10 L/min,因而藥液供給必須在一個比較小的流量范圍內(nèi)進(jìn)行控制,這種情況下,可以選用一種小流量高精度的流量控制部件——脈沖計量泵,來實(shí)現(xiàn)藥液的稀釋。
脈沖計量泵是一種接受脈沖泵出液體的特殊的流量控制裝置,它不能直接控制流量,只能通過PLC下發(fā)不同頻率的脈沖間接控制流量。假設(shè)脈沖計量泵每次泵出的液體體積為V0(0~1.5 mL可調(diào)),每接收一個脈沖泵運(yùn)行n次行程(1/6~6次可調(diào)),脈沖下發(fā)頻率為f,便可得到流量Q,計算公式為:

當(dāng)藥液稀釋比例確定后,可計算出高純水和藥液的設(shè)定流量,再通過反推得出脈沖下發(fā)頻率,PLC根據(jù)該頻率下發(fā)脈沖到計量泵,并將高純水流量對應(yīng)的電流信號發(fā)送到流量控制器,便可實(shí)現(xiàn)藥液配比功能。
4 結(jié)論
表1總結(jié)了本文提出的幾種流量控制方法,設(shè)備設(shè)計階段可根據(jù)不同的硅片清洗設(shè)備及工藝特點(diǎn),選取最適合的控制方式。

筆者所在公司研發(fā)的65 nm高精細(xì)硅片清洗設(shè)備為8腔室設(shè)計,已在中芯國際產(chǎn)品生產(chǎn)線長期運(yùn)行,關(guān)鍵參數(shù)控制穩(wěn)定,產(chǎn)品良率達(dá)到98.626 8%,超出同類機(jī)臺平均水平。圖10為北京中芯國際硅片在該設(shè)備清洗前后表面顆粒圖,在保證清洗性能的前提下,硅片表面顆粒污染物數(shù)量顯著減少,有利于提高芯片的良率。

參考文獻(xiàn)
[1] 林曉杰,劉麗君,王維升.半導(dǎo)體硅片清洗設(shè)備研究進(jìn)展[J].微處理機(jī),2012,33(4):25-27.
[2] EIN-ELI Y,STAROSVETSKY D.Review on copper chemical-mechanical polishing(CMP) and post-CMP cleaning in ultra large system integrated(ULSI)—anelectro chemical perspective[J].Electrochimica Acta,2007,52(5):1825-1838.
[3] DELEONIBUS S.Physical and technological limitations ofnano CMOS devices to the end of the roadmap and beyond[J].European Physical Journal Applied Physics,2006,36(3):197-214.
[4] YAMADA Y,KONISHI N,NOGUCHI J,et al.Influence of CMP slurries and post-CMP cleaning solutions on Cu interconnects and TDDB reliability[J].Journal of the Electrochemical Society,2008,155(7):H485-H490.
[5] 張士偉.半導(dǎo)體晶元的污染雜質(zhì)及清洗技術(shù)[J].電子工業(yè)專用設(shè)備,2014,43(7):18-21.
[6] JOYCE R,SINGH K,SONEY V,et al.Effective cleaning process and its influence on surface roughness in anodic bonding for semiconductor device packaging[J].Materails Science in Semiconductor Processing,2015,31:84-93.
[7] 祝福生,郭春華,夏楠君.工業(yè)泵在濕法腐蝕清洗設(shè)備中的應(yīng)用[J].電子工業(yè)專用設(shè)備,2016,45(1):43-46.
[8] QUIRK M,SERDA J.半導(dǎo)體制造技術(shù)[M].韓鄭生,等,譯.北京:電子工業(yè)出版社,2004.
[9] 張磊,吳儀.雙磁懸浮泵串聯(lián)技術(shù)在超精細(xì)清洗機(jī)中的應(yīng)用[J].半導(dǎo)體技術(shù),2014,39(7):549-553.
[10] 陳琪昊,呂菲,劉峰,等.清洗液溫度及濃度對硅研磨片清洗效果的影響[J].電子工業(yè)專用設(shè)備,2011,40(7):23-27.
作者信息:
李文杰1,2,李冬梅1
(1.清華大學(xué) 電子工程系,北京100084;2.北京北方華創(chuàng)微電子設(shè)備有限公司,北京100176)

