文獻(xiàn)標(biāo)識碼: A
DOI:10.16157/j.issn.0258-7998.181565
中文引用格式: 張露漩,喬樹山,郝旭丹. 一種新型的雙閾值4T SRAM單元的設(shè)計[J].電子技術(shù)應(yīng)用,2018,44(11):21-23,28.
英文引用格式: Zhang Luxuan,Qiao Shushan,Hao Xudan.A new Dual-Vt 4T SRAM bitcell design[J]. Application of Electronic Technique,2018,44(11):21-23,28.
0 引言
根據(jù)摩爾定律,在一個芯片上集成的晶體管的數(shù)目將隨時間按指數(shù)規(guī)律增長。嵌入式存儲器SRAM也不例外,正在按這樣的速度發(fā)展[1-2]。SRAM主要應(yīng)用于片上系統(tǒng)(System on Chip,SoC),隨著SoC的不斷發(fā)展,對嵌入式SRAM提出了大容量、低成本的需求,從而刺激了高密度SRAM存儲器的研發(fā)。同時,快速發(fā)展的CMOS工藝為存儲器集成度的增加提供了實現(xiàn)條件。SRAM存儲器的這種高密度發(fā)展趨勢影響著其設(shè)計復(fù)雜度,在SRAM設(shè)計時需要綜合考慮高穩(wěn)定度、低功耗、高速等性能特點[3]。
本文中,設(shè)計不同結(jié)構(gòu)的SRAM存儲單元,提供相同的供電電壓VDD,分析和比較它們在不同工作狀態(tài)下的穩(wěn)定特性。
存儲單元中相互獨立的晶體管特性是影響SRAM工作性能的重要因素[4]。通常認(rèn)為,對SRAM起主要影響作用的特性包括晶體管閾值電壓Vth和溝道長度L等[5-6]。在分析6T、4T 結(jié)構(gòu)的SRAM工作穩(wěn)定性時,使用多次蒙特卡洛仿真來考慮晶體管特性的影響,比較存儲單元在不同工作狀態(tài)下的噪聲容限均值mean、標(biāo)準(zhǔn)方差sigma和mean/sigma值的大小。所以,在本文中分析SRAM穩(wěn)定性問題時,根據(jù)存儲單元的不同工作狀態(tài)區(qū)別分析,包括數(shù)據(jù)保持狀態(tài)的噪聲容限(Retention Noise Margin,ReNM)、讀工作狀態(tài)的噪聲容限(Read Static Noise Margin,RSNM)和寫操作狀態(tài)的容限(Write Margin,WM)[7]。
1 4T SRAM存儲單元結(jié)構(gòu)
新型的4T SRAM 存儲單元[8-9]由兩個PMOS和兩個NMOS分別作為上拉器件和傳輸器件構(gòu)成。與傳統(tǒng)6T SRAM相比,4T SRAM減少了兩個下拉器件,即驅(qū)動器件。
這種無驅(qū)動的4T SRAM在晶體管的類型選取時,上拉器件選用高閾值電壓(High-Threshold Value,HVT) 的PMOS晶體管,傳輸器件選用低閾值電壓(Low-Threshold Value,LVT) 的NMOS晶體管[10]。
圖1所示為傳統(tǒng)6T和新型4T SRAM存儲單元版圖。經(jīng)過歸一化處理,PMETAL表示單元寬度。可以得出,相比6T SRAM,4T SRAM面積減小了20%。

2 新型4T SRAM的理論分析及建模
2.1 數(shù)據(jù)保持Retention
圖2所示為數(shù)據(jù)保持工作狀態(tài)下4T SRAM的工作原理示意圖。

雙閾值4T結(jié)構(gòu)SRAM在WL低電平條件下保持內(nèi)部節(jié)點存儲的數(shù)據(jù),然而因為不同內(nèi)部節(jié)點表現(xiàn)出不同的穩(wěn)定特性,所以稱為亞穩(wěn)態(tài)存儲單元[11]。這種4T SRAM一側(cè)內(nèi)部節(jié)點通過上拉晶體管穩(wěn)定地連接到VDD稱為靜態(tài)節(jié)點Static Node(QB),而另一側(cè)的內(nèi)部節(jié)點由于容易發(fā)生數(shù)據(jù)翻轉(zhuǎn)和波動稱為動態(tài)節(jié)點Dynamic Node(Q)。動態(tài)節(jié)點Q的理想工作狀態(tài)是持續(xù)放電,維持?jǐn)?shù)據(jù)不發(fā)生變化。因此,在數(shù)據(jù)保持狀態(tài),位線Bitline(BL、BLX)接地。
同時,根據(jù)不同閾值電壓的MOS晶體管具有不同的亞閾值區(qū)電流,即漏電流IOFF:

其中,W/L為晶體管的寬長比,Vt為閾值電壓,S為亞閾值區(qū)擺幅[12]。
通過使用HVT的PMOS作為上拉器件,使用LVT的NMOS作為傳輸器件,來保證漏電流IOFF_M3遠(yuǎn)大于IOFF_M1,實現(xiàn)動態(tài)節(jié)點的‘0’數(shù)據(jù)保持。
針對這種新型無驅(qū)動4T SRAM結(jié)構(gòu),也可以通過改變晶體管寬長比來調(diào)整漏電流,但這種方式不僅會帶來額外的存儲單元面積損失,得到的漏電流差也并不如通過調(diào)整晶體管閾值電壓的方式效果明顯。所以新型4T SRAM設(shè)計使用不同閾值電壓的晶體管來保持?jǐn)?shù)據(jù)。
2.2 數(shù)據(jù)讀取Read
圖3所示為4T SRAM在數(shù)據(jù)讀取工作狀態(tài)。

4T SRAM讀工作前,BL/BLX預(yù)放電至GND。WL高電平有效后,4T SRAM的存‘1’內(nèi)部節(jié)點通過BLX放電,BLX電壓上升,與BL產(chǎn)生電壓差,這個電壓差被送到靈敏放大單元,即可讀出存儲單元存儲的數(shù)據(jù)。
在數(shù)據(jù)讀取工作時,BL/BLX預(yù)放電,當(dāng)WL開啟后,存‘1’側(cè)上拉管M2與傳輸管M4同時打開,通路上的電流即為讀電流Read Current。在當(dāng)前的數(shù)據(jù)讀取工作狀態(tài),M2工作在線性區(qū),M4工作在飽和區(qū)。如式(2)、式(3)[13]所示,M2上的導(dǎo)通電流Ion_p給QB節(jié)點寫‘1’,M4上的導(dǎo)通電流Ion_n給QB節(jié)點寫‘0’,可能使QB節(jié)點數(shù)據(jù)發(fā)生反轉(zhuǎn),導(dǎo)致讀紊亂錯誤(read disturbance)。

為增強4T SRAM的讀穩(wěn)定性,引入讀輔助電路read assist(RA)[14-15]。本文中選用的讀輔助電路方案:(1)降低字線電壓(Word Line Under Drive,WLUD);(2)提升供電電壓(VDD Boost,VDDB),提供給上拉器件的源極一個高于VDD的電壓,即增大了上拉器件的導(dǎo)通電流和工作速度。同時,上拉器件的襯底應(yīng)與源極保持相同電壓,保證沒有襯底偏置效應(yīng)的影響。
2.3 數(shù)據(jù)寫入Write
圖4所示為4T SRAM在數(shù)據(jù)寫入工作狀態(tài)。減少下拉器件有助于4T SRAM的寫操作。這是由于4T結(jié)構(gòu)存儲單元的亞穩(wěn)態(tài)特性導(dǎo)致的,存‘1’端的內(nèi)部節(jié)點為靜態(tài)節(jié)點,存‘0’端的內(nèi)部節(jié)點為動態(tài)節(jié)點。這使得存‘0’端的動態(tài)節(jié)點較易受到工作狀態(tài)影響而發(fā)生翻轉(zhuǎn),進(jìn)而改變靜態(tài)節(jié)點的數(shù)據(jù),從而完成4T存儲單元的寫操作。
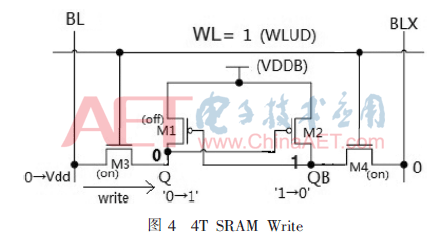
在存儲單元寫入數(shù)據(jù)時,將連接存‘0’端內(nèi)部節(jié)點Q的位線置高VDD,使用快速的LVT晶體管作為傳輸器件,相對較慢的HVT晶體管作為上拉器件,滿足連接Q的傳輸晶體管M3工作電流Ion_n大于連接QB點的上拉晶體管M2工作電流Ion_p,即存儲單元易將數(shù)據(jù)‘0’寫為‘1’。
以上兩點使得4T結(jié)構(gòu)存儲單元具有較強的寫能力和較快的寫工作時間。
于是對于6T和4T SRAM的寫容量Write Margin(WM)定義如式(4)、式(5)所示。

3 仿真結(jié)果分析
通常存儲單元設(shè)計需要在單元面積、速度、功耗、良率之間進(jìn)行綜合考慮、折中取舍。本文針對55 nm CMOS工藝下的傳統(tǒng)6T和雙閾值4T SRAM,考慮SRAM穩(wěn)定特性與供電電壓的問題,進(jìn)行多次蒙特卡洛仿真。經(jīng)過數(shù)據(jù)歸一化處理,結(jié)果如表1所示。

4T SRAM數(shù)據(jù)保持穩(wěn)定性ReNM相對較差,與6T SRAM相比降低了37.67%。4T SRAM在增加讀輔助電路后,數(shù)據(jù)讀取工作的穩(wěn)定性RSNM顯著提高,根據(jù)VDDB和WLUD的不同,穩(wěn)定性提高不同。考慮CMOS工藝最高供電電壓VDDB和SRAM讀工作速度限制的最低WLUD,4T SRAM的讀穩(wěn)定性可提高110%。新型4T SRAM具有很強的寫能力WM,寫容限提高183%。很強的寫能力,也進(jìn)一步說明了它的亞穩(wěn)態(tài)特性,與傳統(tǒng)6T SRAM相比,減少兩個作為驅(qū)動的下拉晶體管,更容易受到周圍環(huán)境的影響,降低了數(shù)據(jù)保持穩(wěn)定性。而雙閾值晶體管的器件選擇,進(jìn)一步增強了新型4T SRAM的數(shù)據(jù)寫能力。
4 結(jié)論
本文提出了一種新型雙閾值4T SRAM存儲單元,在55 nm CMOS工藝下,與傳統(tǒng)6T SRAM相比,實現(xiàn)了版圖單元面積減小20%,同時具有較好的工作穩(wěn)定性和讀寫速度。本次設(shè)計的關(guān)鍵在于使用漏電少的HVT作為上拉晶體管,速度快的LVT作為傳輸晶體管。這種雙閾值的設(shè)計是實現(xiàn)數(shù)據(jù)保持工作狀態(tài)穩(wěn)定性的關(guān)鍵,同時,有助于存儲單元進(jìn)行數(shù)據(jù)寫操作。對于讀穩(wěn)定性問題,通過讀輔助電路實現(xiàn)有效改善。對新型4T SRAM的不斷研究,有助于未來高密度、低功耗的SRAM設(shè)計發(fā)展。
參考文獻(xiàn)
[1] DU X G,MUKHERJEE N,CHENG W T,et al.Full-speed field-programmable memory BIST architecture[C].IEEE International Conference on Test,2005,Austin,TX,2005.
[2] KUMAR A.SRAM cell design with minimum number of transistor[C].2014 Recent Advances in Engineering and Computational Sciences(RAECS),Chandigarh,2014:1-3.
[3] SONG T,RIM W,JUNG J,et al.A 14 nm FinFET 128 Mb 6T SRAM with VMIN-enhancement techniques for low-power applications,2014 IEEE International Solid-State Circuits Conference Digest of Technical Papers(ISSCC),San Francisco,CA,2014:232-233.
[4] BURNETT D,ERINGTON K,SUBRAMANIAN C,et al.Implications of fundamental threshold voltage variations for high-density SRAM and logic circuits[C].Proceedings of 1994 VLSI Technology Symposium,Honolulu,HI,USA,1994:15-16.
[5] LIN H S,HUANG V.Investigation of thermal budget impact on core CMOS SRAM device in an embedded Flash technology[C].2009 16th IEEE International Symposium on the Physical and Failure Analysis of Integrated Circuits,Suzhou,Jiangsu,2009:54-58.
[6] TANG X G,DE V K,MEINDL J D.Intrinsic MOSFET parameter fluctuations due to random dopant placement[J].IEEE Transactions on Very Large Scale Integration(VLSI) Systems,1997,5(4):369-376.
[7] BHAVNAGARWALA A J,TANG X G,MEINDL J D.The impact of intrinsic device fluctuations on CMOS SRAM cell stability[J].IEEE Journal of Solid-State Circuits,2001,36(4):658-665.
[8] SINGH W,KUMAR G A.Design of 6T,5T and 4T SRAM cell on various performance metrics[C].2015 2nd International Conference on Computing for Sustainable Global Development(INDIACom),New Delhi,2015:899-904.
[9] BOUMCHEDDA R,NOEL J P,BIRAUD B,et al.High-density 4T SRAM bitcell in 14 nm 3-D cool cube technology exploiting assist techniques[J].IEEE Transactions on Very Large Scale Integration(VLSI) Systems,2017,25(8):2296-2306.
[10] BROCARD M,BOUMCHEDDA R,NOEL J P,et al.High density SRAM bitcell architecture in 3D sequential Cool-Cube 14 nm technology[C].2016 IEEE SOI-3D-Subthreshold Microelectronics Technology Unified Conference(S3S),Burlingame,CA,2016:1-3.
[11] SHAFAEI A,PEDRAM M.Energy-efficient cache memories using a dual-Vt 4T SRAM cell with read-assist techniques[C].2016 Design, Automation & Test in Europe Conference & Exhibition(DATE),Dresden,2016:457-462.
[12] GHANI T,ARMSTRONG M,AUTH C,et al.A 90 nm high volume manufacturing logic technology featuring novel 45 nm gate length strained silicon CMOS transistors[C].IEEE International Electron Devices Meeting 2003,Washington,DC,USA,2003,11.6.1-11.6.3.
[13] Chen Ming,HU C.Modern semiconductor devices for integrated circuits(IV)[M].北京:電子工業(yè)出版社,2012.
[14] ZIMMER B,TOH S O,VO H,et al.SRAM assist techniques for operation in a wide voltage range in 28 nm CMOS[J].IEEE Transactions on Circuits and Systems II:Express Briefs,2012,59(12):853-857.
[15] NAUTIYAL V,et al.Charge recycled low power SRAM with integrated write and read assist, for wearable electronics, designed in 7 nm FinFET[C].2017 IEEE/ACM International Symposium on Low Power Electronics and Design(ISLPED),Taipei,2017:1-6.
作者信息:
張露漩1,喬樹山1,2,郝旭丹3
(1.中國科學(xué)院大學(xué) 微電子學(xué)院,北京100029;2.中國科學(xué)院微電子研究所,北京100029;
3.中芯國際集成電路制造有限公司,北京100176)

