近日,中國(guó)臺(tái)灣工業(yè)技術(shù)研究院研究總監(jiān)Yang Rui預(yù)測(cè),臺(tái)積電將在芯片制造業(yè)再占主導(dǎo)地位五年,此后3D封裝將成為主要工藝挑戰(zhàn)。
過(guò)去十年各種計(jì)算工作負(fù)載飛速發(fā)展,而摩爾定律卻屢屢被傳將走到盡頭。面對(duì)更家多樣化的計(jì)算應(yīng)用需求,為了將更多功能“塞”到同一顆芯片里,先進(jìn)封裝技術(shù)成為持續(xù)優(yōu)化芯片性能和成本的關(guān)鍵創(chuàng)新路徑。
臺(tái)積電、英特爾、三星均在加速3D封裝技術(shù)的部署。今年8月,這三大芯片制造巨頭均亮出,使得這一戰(zhàn)場(chǎng)愈發(fā)硝煙四起。

▲英特爾封裝技術(shù)路線(xiàn)圖
通過(guò)三大芯片制造巨頭的先進(jìn)封裝布局,我們可以看到在接下來(lái)的一年,3D封裝技術(shù)將是超越摩爾定律的重要?dú)⑹诛怠?/p>
一、先進(jìn)封裝:將更多功能塞進(jìn)一顆芯片
此前芯片多采用2D平面封裝技術(shù),但隨著異構(gòu)計(jì)算應(yīng)用需求的增加,能將不同尺寸、不同制程工藝、不同材料的芯片集成整合的3D封裝技術(shù),已成為兼顧更高性能和更高靈活性的必要選擇。
從最新3D封裝技術(shù)落地進(jìn)展來(lái)看,英特爾Lakefield采用3D封裝技術(shù)Foveros,臺(tái)積電的3D封裝技術(shù)SoIC按原計(jì)劃將在2021年量產(chǎn),三星的3D封裝技術(shù)已應(yīng)用于7nm EUV芯片。
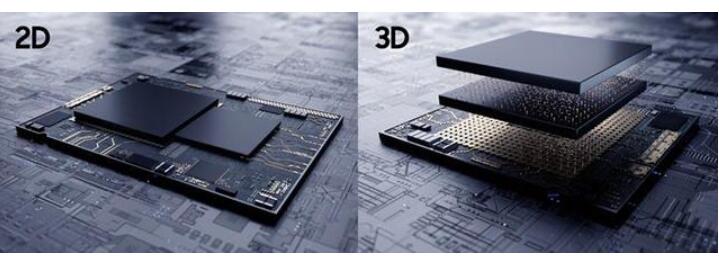
為什么要邁向先進(jìn)封裝技術(shù)?主要原因有二點(diǎn),一是迄今處理器的大多數(shù)性能限制來(lái)自?xún)?nèi)存帶寬,二是生產(chǎn)率提高。
一方面,存儲(chǔ)帶寬的開(kāi)發(fā)速度遠(yuǎn)遠(yuǎn)低于處理器邏輯電路的速度,因此存在“內(nèi)存墻”的問(wèn)題。
在傳統(tǒng)PCB封裝中,走線(xiàn)密度和信號(hào)傳輸速率難以提升,因而內(nèi)存帶寬緩慢增長(zhǎng)。而先進(jìn)封裝的走線(xiàn)密度短,信號(hào)傳輸速率有很大的提升空間,同時(shí)能大大提高互連密度,因而先進(jìn)封裝技術(shù)成為解決內(nèi)存墻問(wèn)題的主要方法之一。
另一方面,高性能處理器的體系架構(gòu)越來(lái)越復(fù)雜,晶體管的數(shù)量也在增加,但先進(jìn)的半導(dǎo)體工藝仍然很昂貴,并且生產(chǎn)率也不令人滿(mǎn)意。
在半導(dǎo)體制造中,芯片面積越小,往往成品率越高。為了降低使用先進(jìn)半導(dǎo)體技術(shù)的成本并提高良率,一種有效的方法是將大芯片切分成多個(gè)小芯片,然后使用先進(jìn)的封裝技術(shù)將它們連接在一起。
在這一背景下,以臺(tái)積電、英特爾、三星為代表的三大芯片巨頭正積極探索3D封裝技術(shù)及其他先進(jìn)封裝技術(shù)。
二、臺(tái)積電的3D封裝組合拳
今年8月底,臺(tái)積電推出3DFabric整合技術(shù)平臺(tái),旨在加快系統(tǒng)級(jí)方案的創(chuàng)新速度,并縮短上市時(shí)間。
臺(tái)積電3DFabric可將各種邏輯、存儲(chǔ)器件或?qū)S眯酒cSoC集成在一起,為高性能計(jì)算機(jī)、智能手機(jī)、IoT邊緣設(shè)備等應(yīng)用提供更小尺寸的芯片,并且可通過(guò)將高密度互連芯片集成到封裝模塊中,從而提高帶寬、延遲和電源效率。
3DFabric由臺(tái)積電前端和后端封裝技術(shù)組成。
前端3D IC技術(shù)為臺(tái)積電SoIC技術(shù),于2018年首次對(duì)外公布,支持CoW(Chip on Wafer)和WoW(Wafer on Wafer)兩種鍵合方式。
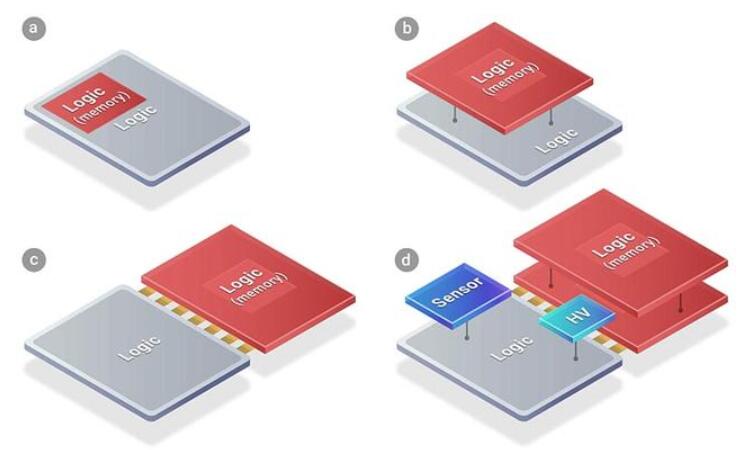
▲a為芯片分割前的SoC;b、c、d為臺(tái)積電SoIC服務(wù)平臺(tái)支持的多種分區(qū)小芯片和重新集成方案
通過(guò)采用硅穿孔(TSV)技術(shù),臺(tái)積電SoIC技術(shù)可達(dá)到無(wú)凸起的鍵合結(jié)構(gòu), 從而可將不同尺寸、制程、材料的小芯片重新集成到一個(gè)類(lèi)似SoC的集成芯片中,使最終的集成芯片面積更小,并且系統(tǒng)性能優(yōu)于原來(lái)的SoC。
臺(tái)積電后端技術(shù)包括CoWoS(Chip on Wafer on Substrate)和InFO(Integrated Fan-out)系列封裝技術(shù),已經(jīng)廣泛落地。例如今年全球TOP 500超算榜排名第一的日本超算“富岳”所搭載的Fujitsu A64FX 處理器采用了臺(tái)積電CoWoS封裝技術(shù),蘋(píng)果手機(jī)芯片采用了臺(tái)積電InFO封裝技術(shù)。
此外,臺(tái)積電擁有多個(gè)專(zhuān)門(mén)的后端晶圓廠(chǎng),負(fù)責(zé)組裝和測(cè)試包括3D堆疊芯片在內(nèi)的硅芯片,將其加工成封裝后的設(shè)備。
這帶來(lái)的一大好處是,客戶(hù)可以在模擬IO、射頻等不經(jīng)常更改、擴(kuò)展性不大的模塊上采用更成熟、更低成本的半導(dǎo)體技術(shù),在核心邏輯設(shè)計(jì)上采用最先進(jìn)的半導(dǎo)體技術(shù),既節(jié)約了成本,又縮短了新產(chǎn)品的上市時(shí)間。
臺(tái)積電3DFabric將先進(jìn)的邏輯、高速存儲(chǔ)器件集成到封裝模塊中。在給定的帶寬下,高帶寬內(nèi)存(HBM)較寬的接口使其能以較低的時(shí)鐘速度運(yùn)行,從而減少功耗。
如果以數(shù)據(jù)中心規(guī)模來(lái)看,這些邏輯和HBM器件節(jié)省的成本十分可觀(guān)。
三、英特爾用“分解設(shè)計(jì)”策略打出差異化優(yōu)勢(shì)
和臺(tái)積電相似,英特爾也早已在封裝領(lǐng)域布局了多種維度的先進(jìn)封裝技術(shù)。
在8月13日的2020年英特爾架構(gòu)日上,英特爾發(fā)布一個(gè)全新的混合結(jié)合(Integrated Fan-out)技術(shù),使用這一技術(shù)的測(cè)試芯片已在2020年第二季度流片。
相比當(dāng)前大多數(shù)封裝技術(shù)所使用的熱壓結(jié)合(Thermocompression bonding)技術(shù),混合結(jié)合技術(shù)可將凸點(diǎn)間距降到10微米以下,提供更高互連密度、更高帶寬和更低功率。
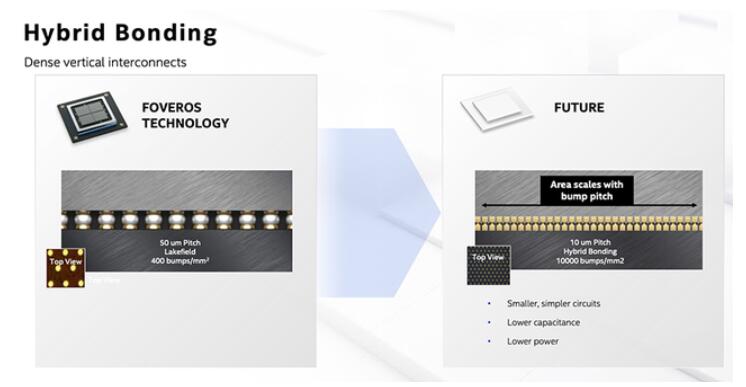
▲英特爾混合結(jié)合技術(shù)
此前英特爾已推出標(biāo)準(zhǔn)封裝、2.5D嵌入式多互連橋(EMIB)技術(shù)、3D封裝Foveros技術(shù)、將EMIB與Foveros相結(jié)合的Co-EMIB技術(shù)、全方位互連(ODI)技術(shù)和多模I/O(MDIO)技術(shù)等,這些封裝互連技術(shù)相互疊加后,能帶來(lái)更大的可擴(kuò)展性和靈活性。
據(jù)英特爾研究院院長(zhǎng)宋繼強(qiáng)介紹:“封裝技術(shù)的發(fā)展就像我們蓋房子,一開(kāi)始蓋的是茅廬單間,然后蓋成四合院,最后到高樓大廈。以Foveros 3D來(lái)說(shuō),它所實(shí)現(xiàn)的就是在建高樓的時(shí)候,能夠讓線(xiàn)路以低功率同時(shí)高速率地進(jìn)行傳輸。”
他認(rèn)為,英特爾在封裝技術(shù)的優(yōu)勢(shì)在于,可以更早地知道未來(lái)這個(gè)房子會(huì)怎么搭,也就是說(shuō)可以更好地對(duì)未來(lái)芯片進(jìn)行設(shè)計(jì)。
面向未來(lái)的異構(gòu)計(jì)算趨勢(shì),英特爾推出“分解設(shè)計(jì)(Digression design)”策略,結(jié)合新的設(shè)計(jì)方法和先進(jìn)的封裝技術(shù),將關(guān)鍵的架構(gòu)組件拆分為仍在統(tǒng)一封裝中單獨(dú)晶片。
也就是說(shuō),將原先整個(gè)SoC芯片“化整為零”,先做成如CPU、GPU、I/O等幾個(gè)大部分,再將SoC的細(xì)粒度進(jìn)一步提升,將以前按照功能性來(lái)組合的思路,轉(zhuǎn)變?yōu)榘淳琁P來(lái)進(jìn)行組合。
這種思路的好處是,不僅能提升芯片設(shè)計(jì)效率、減少產(chǎn)品化的時(shí)間,而且能有效減少此前復(fù)雜設(shè)計(jì)所帶來(lái)的Bug數(shù)量。
“原來(lái)一定要放到一個(gè)晶片上做的方案,現(xiàn)在可以轉(zhuǎn)換成多晶片來(lái)做。另外,不僅可以利用英特爾的多節(jié)點(diǎn)制程工藝,也可以利用合作伙伴的工藝。”宋繼強(qiáng)解釋。
這些分解開(kāi)的小部件整合起來(lái)之后,速度快、帶寬足,同時(shí)還能實(shí)現(xiàn)低功耗,有很大的靈活性,將成為英特爾的一大差異性?xún)?yōu)勢(shì)。
四、三星首秀3D封裝技術(shù),可用于7nm工藝
除了臺(tái)積電和英特爾外,三星也在加速其3D封裝技術(shù)的部署。
8月13日,三星也公布了其3D封裝技術(shù)為“eXtended-Cube”,簡(jiǎn)稱(chēng)“X-Cube”,通過(guò)TSV進(jìn)行互連,已能用于7nm乃至5nm工藝。
據(jù)三星介紹,目前其X-Cube測(cè)試芯片可以做到將SRAM層堆疊在邏輯層上,可將SRAM與邏輯部分分離,從而能騰出更多空間來(lái)堆棧更多內(nèi)存。
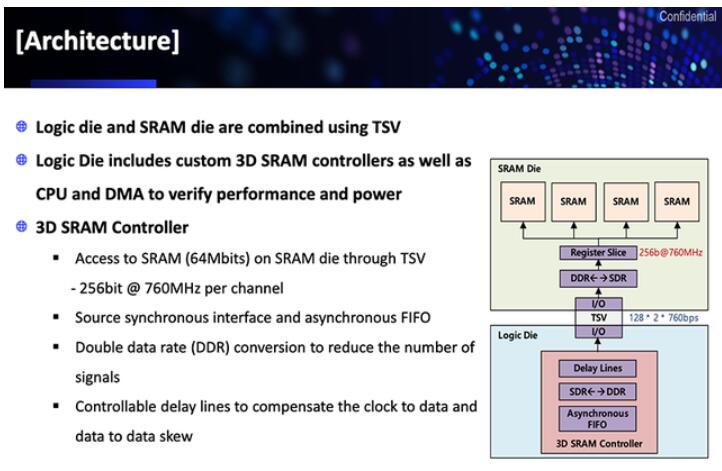
▲三星X-Cube測(cè)試芯片架構(gòu)
此外,TSV技術(shù)能大幅縮短裸片間的信號(hào)距離,提高數(shù)據(jù)傳輸速度和降低功耗。
三星稱(chēng),該3D封裝技術(shù)在速度和功效方面實(shí)現(xiàn)了重大飛躍,將幫助滿(mǎn)足5G、AI、AR、VR、HPC、移動(dòng)和可穿戴設(shè)備等前沿應(yīng)用領(lǐng)域的嚴(yán)格性能要求。
結(jié)語(yǔ):三大芯片巨頭強(qiáng)攻先進(jìn)封裝
可以看到,在2020年,圍繞3D封裝技術(shù)的戰(zhàn)火繼續(xù)升級(jí),臺(tái)積電、英特爾、三星這三大先進(jìn)芯片制造商紛紛加碼,探索更廣闊的芯片創(chuàng)新空間。
盡管這些技術(shù)方法的核心細(xì)節(jié)有所不同,但殊途同歸,都是為了持續(xù)提升芯片密度、實(shí)現(xiàn)更為復(fù)雜和靈活的系統(tǒng)級(jí)芯片,以滿(mǎn)足客戶(hù)日益豐富的應(yīng)用需求。
而隨著制程工藝逼近極限,以及應(yīng)用需求的持續(xù)多元化,未來(lái)芯片制造商除了要解決散熱等技術(shù)挑戰(zhàn)外,還有望推進(jìn)來(lái)自不同廠(chǎng)商的先進(jìn)封裝技術(shù)的融合。

