硅基器件已經(jīng)成為我們行業(yè)60多年的基礎(chǔ),這非常令人驚訝,,因?yàn)樽畛醯逆N基器件將難以大規(guī)模集成,。(值得一提,GaAs器件還開發(fā)了一個(gè)獨(dú)特的微電子市場(chǎng)領(lǐng)域,。)
最近,,令人驚訝的是,通過引入諸如FinFETs之類的拓?fù)浣Y(jié)構(gòu)以及即將到來的納米片,,硅場(chǎng)效應(yīng)器件獲得了新的生命,。硅基互補(bǔ)FET的研究正在進(jìn)行中 (CFET)設(shè)計(jì)達(dá)到量產(chǎn)狀態(tài),其中nMOS和pMOS器件是垂直制造的,,從而消除了當(dāng)前單元設(shè)計(jì)中的橫向n-p間距,。
另外,材料工程學(xué)的進(jìn)步已經(jīng)將(拉伸和壓縮)應(yīng)力納入硅通道晶體結(jié)構(gòu)中,,以增強(qiáng)自由載流子遷移率,。
但是,硅設(shè)備收益遞減的點(diǎn)正在逼近:
由于高電場(chǎng)下的速度飽和,,無硅載流子遷移率接近最大值
尺寸的持續(xù)縮小降低了硅半導(dǎo)體的導(dǎo)帶和價(jià)帶邊緣的“自由載流子態(tài)密度”(DoS)–填充更大范圍的載流子態(tài)需要更多的能量
與Fin圖案相關(guān)的統(tǒng)計(jì)過程變化很大
散熱片的熱傳導(dǎo)導(dǎo)致局部“自熱”溫度升高,,從而影響了幾種可靠性機(jī)制(HCI,電遷移)
為解決以上問題,目前業(yè)界正在進(jìn)行大量研究,,以評(píng)估與硅完全不同的場(chǎng)效應(yīng)晶體管材料的潛力,,但這也與當(dāng)前的大批量制造操作相一致,。一種選擇是探索 器件通道的單層二維半導(dǎo)體材料,,例如二硫化鉬(MoS2)。
另一個(gè)有希望的選擇是從碳納米管(CNT)構(gòu)造設(shè)備溝道,。下圖提供了碳鍵獨(dú)特性質(zhì)的簡(jiǎn)單圖示,。(我對(duì)化學(xué)反應(yīng)有些不熟悉,但我記得“ sp2”鍵是指原子核周圍亞軌道“ p殼”中相鄰碳原子的電子配對(duì),。沒有“懸掛鍵”,,并且碳材料是惰性的。)
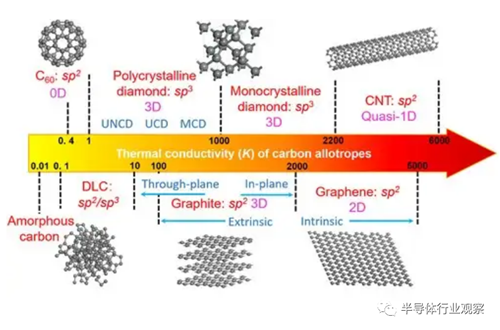
請(qǐng)注意,,石墨,,石墨烯和CNT的化學(xué)結(jié)構(gòu)相似-使用石墨進(jìn)行的實(shí)驗(yàn)材料分析更加容易,并且最終可以擴(kuò)展到CNT處理,。
在最近的IEDM會(huì)議上,,臺(tái)積電提供了有關(guān)CNT器件制造進(jìn)展的有趣更新。本文總結(jié)了該演講的重點(diǎn),。
CNT設(shè)備具有一些引人注目的功能:
極高的載流子遷移率(>3,000cm2在/V-sec,,“彈道運(yùn)輸”(ballistic transport),散射最?。?/p>
非常薄的CNT主體尺寸(例如,,直徑~1nm)
低寄生電容
優(yōu)良的導(dǎo)熱性
低溫(<400C)處理
最后一個(gè)功能特別有趣,因?yàn)樗€為基于硅的高溫制造與后續(xù)的CNT處理集成提供了潛力,。
門介電(Gate Dielectric)
臺(tái)積電開發(fā)了獨(dú)特的工藝流程來為CNT器件提供“高K”電介質(zhì)等效柵極氧化物,,類似于當(dāng)前硅FET的HKMG處理。

上面的TEM圖說明了CNT的橫截面,。為了與獨(dú)特的碳表面兼容,,需要沉積初始界面電介質(zhì)(Al2O3)–即需要在碳上對(duì)該薄層進(jìn)行適當(dāng)?shù)某珊撕驼稀?/p>
隨后,添加高K HfO2膜的原子級(jí)沉積(ALD),。(如前所述,,這些關(guān)于材料性能的介電實(shí)驗(yàn)是在石墨基底上完成的。)
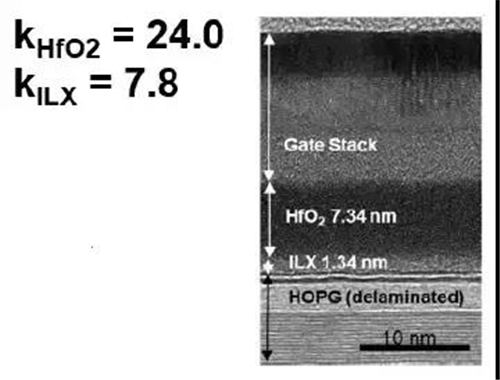
這些柵極電介質(zhì)層的最小厚度受到非常低的柵極泄漏電流(例如,,柵極長度為10nm的<1 pA/CNT)的限制,。下面說明用于測(cè)量柵極到CNT泄漏電流的測(cè)試結(jié)構(gòu)。(對(duì)于這些電測(cè)量,,CNT結(jié)構(gòu)使用石英襯底,。)
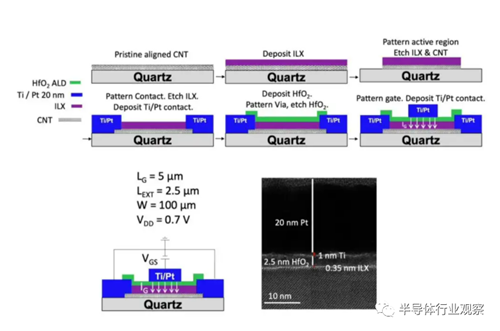
實(shí)驗(yàn)得出的“最佳”尺寸為t_Al2O3=0.35nm和t_HfO2=2.5nm。由于這些極薄的層,Cgate_ox非常高,,從而改善了靜電控制,。(請(qǐng)注意,這些層厚于CNT的直徑,,其影響將在稍后討論,。)
門方向(Gate Orientation)
臺(tái)積電評(píng)估的CNT器件采用了獨(dú)特的“頂柵加背柵”拓?fù)洹?/p>
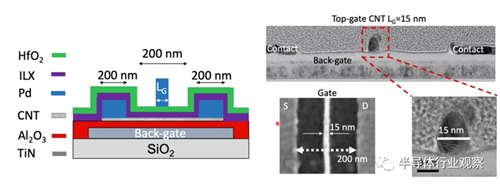
頂柵提供常規(guī)的半導(dǎo)體場(chǎng)效應(yīng)器件輸入,而(較大的)背柵提供對(duì)S/D擴(kuò)展區(qū)域中載流子的靜電控制,,以有效降低寄生電阻Rs和Rd,。而且,背柵會(huì)影響CNT與鈀金屬之間的源極和漏極接觸電勢(shì),,從而降低肖特基二極管勢(shì)壘以及在該半導(dǎo)體-金屬界面處的相關(guān)電流行為,。
設(shè)備電流
CNT pFET的IV曲線(線性和對(duì)數(shù)Ids(用于亞閾值斜率測(cè)量))如下所示。對(duì)于此實(shí)驗(yàn),,Lg=100nm,,S/D間距為200nm,CNT直徑=1nm,,t_Al2O3= 1.25nm,,t_HfO2=2.5nm。
對(duì)于此測(cè)試(制造在石英基板上),,單個(gè)CNT支持超過10uA的Ids,。接近上述目標(biāo)尺寸的更薄電介質(zhì)將實(shí)現(xiàn)進(jìn)一步的改進(jìn)。

最終將在生產(chǎn)制造中使用平行CNT-相關(guān)的制造指標(biāo)將是“每微米CNT的數(shù)量”,。例如,,4nm的CNT間距將被引用為“ 250CNTs/um”。
挑戰(zhàn)
規(guī)劃CNT生產(chǎn)時(shí)肯定要解決一些挑戰(zhàn)(僅舉幾例):
規(guī)則/均勻的CNT沉積,,具有非常干凈的表面,,用于介電成核
需要最小化柵極電介質(zhì)堆棧中的載流子“陷阱密度”
最佳S / D接觸電位材料工程
設(shè)備建模設(shè)計(jì)
上面的最后一個(gè)挑戰(zhàn)尤其值得注意,因?yàn)楫?dāng)前用于場(chǎng)效應(yīng)晶體管的緊湊型器件模型肯定不夠用,。CNT柵氧化層拓?fù)渑c平面或FinFET硅通道完全不同,。由于柵極到溝道的電場(chǎng)本質(zhì)上是徑向的,因此與平面器件一樣,,“有效柵極氧化物”并不存在簡(jiǎn)單的關(guān)系,。
此外,S/D擴(kuò)展需要唯一的Rs和Rd模型,。而且,,CNT柵氧化層的厚度比CNT的直徑厚,從而導(dǎo)致從柵到S/D延伸以及到(小間距分隔)平行CNT的大量邊緣場(chǎng),。為基于CNT的設(shè)計(jì)開發(fā)合適的緊湊模型是一項(xiàng)持續(xù)的工作,。
順便說一句,,CNT“環(huán)繞柵極”氧化物(類似于納米片周圍的所有柵極)將比沉積的頂部柵極氧化物有所改進(jìn),但難以制造,。
臺(tái)積電顯然正在投入大量研發(fā)資源,,為“不可避免的”后硅器件技術(shù)的引入做準(zhǔn)備。CNT的制造和電學(xué)表征結(jié)果證明了該器件替代產(chǎn)品的巨大潛力,。

