在日前舉辦的 "IMW 2025" 上,三星電子關(guān)于下一代 DRAM 和下一代 NAND 閃存的演變。
在 DRAM 部分,三星首先回顧了 DRAM 單元多年來的演變。
在 1990 年代,平面 n 溝道 MOS FET 是單元選擇晶體管(單元晶體管)的標準。然而,進入 21 世紀,短溝道效應(yīng)和關(guān)斷漏電流已變得無法忽視。一種在不縮短溝道長度的情況下使橫向(水平)方向微型化的晶體管結(jié)構(gòu)被設(shè)計出來并被用于 DRAM 單元晶體管。隨著光刻技術(shù)的不斷縮小,DRAM 單元的面積可以不斷縮小。
與此同時,DRAM 單元陣列布局在 2010 年代得到了改進。 DRAM 單元的尺寸是根據(jù)設(shè)計規(guī)則(或最小加工尺寸)"F:特征尺寸 " 進行比較的。原則上,可能的最小單元是 2F(垂直尺寸)x 2F(水平尺寸)= 4F2,但這極難實現(xiàn)。
2010 年代,通過改進 DRAM 單元陣列的布局,單元面積從傳統(tǒng)的 "8F2" 縮小到 "6F2"。即使加工尺寸相同,單元面積也減少了 25%。這種 "6F2" 布局至今仍是大容量 DRAM 使用的標準。

圖注:DRAM 單元的演變
(1990 年代至 2030 年代)
在 "6F2" 布局中,通過將字線和溝道嵌入到襯底中,單元晶體管的面積得以減小。源極和漏極水平(橫向)布局。單元晶體管的垂直結(jié)構(gòu)從襯底側(cè)開始依次為字線(WL)、溝道、位線觸點(BLC)、電荷存儲節(jié)點觸點(SNC)、位線和單元電容器。字線間距為 2F,位線間距為 3F。
10nm 代(1X 代及以后)的 DRAM 單元基本維持上述結(jié)構(gòu),但通過改進電容結(jié)構(gòu)、字線材料等延續(xù)了七代,依次稱為 "1X → 1Y → 1Z → 1A → 1B → 1C → 1D" 代。不過,下一代 "0A" 代(10nm 以下第一代)將無法維持 "6F2" 布局,有很大機會轉(zhuǎn)向 "4F2" 布局。
10nm 以下 DRAM ,如何實現(xiàn)
實現(xiàn) "4F2" 布局的單元晶體管的基本結(jié)構(gòu)是溝道垂直排列的結(jié)構(gòu)。它被稱為 "VCT(垂直溝道晶體管)"。位線、溝道(側(cè)面有字線)和電容器從基板側(cè)垂直排列。

圖注:DRAM 單元陣列布局架構(gòu)和垂直通道晶體管的示例。左上為 "6F2" 布局,右上為 "4F2" 布局。左下角是三星發(fā)明的 VCT(垂直通道晶體管)結(jié)構(gòu)的示例(稱為 "S2CAT:自對準 2 間距單元陣列晶體管 "),右下角是用透射電子顯微鏡(TEM)觀察到的原型單元陣列的橫截面圖像。
實現(xiàn)更高內(nèi)存密度的嘗試是三維 DRAM(3D DRAM)。通過垂直堆疊水平較長的 DRAM 單元(一端有位線,中間有通道,另一端有電容器)來增加內(nèi)存容量。
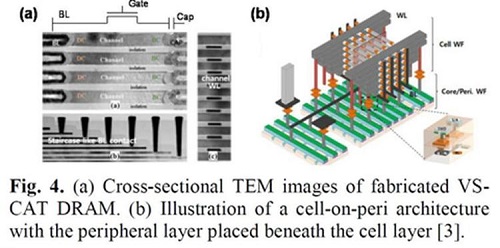
圖注:三維動態(tài)隨機存取存儲器(3D DRAM)的原型。這是由三星構(gòu)思并制作的原型。它們被稱為 "VS-CAT(垂直堆疊單元陣列晶體管)"。左圖顯示了用透射電子顯微鏡 ( TEM ) 觀察到的原型 DRAM 單元陣列的橫截面。左上角顯示 3D 堆疊晶體管和電容器,左下角顯示位線提取結(jié)構(gòu)(階梯式),右側(cè)顯示字線和通道的橫截面(一個通道夾在兩條字線之間)。右側(cè)的結(jié)構(gòu)圖展示了通過堆疊存儲單元陣列和外圍電路來減少硅面積的想法。將存儲單元陣列晶圓(Cell WF)與周邊電路晶圓(Core/Peri. WF)鍵合在一起。
3D NAND 閃存超越極限
從這里開始,將收官對有關(guān) NAND 閃存(以下簡稱 "NAND 閃存 ")的介紹部分進行簡單說明。自上世紀 90 年代中期開始實用化的 NAND 閃存(平面 NAND 閃存)已經(jīng)經(jīng)歷了密度和小型化的極限。
最初,內(nèi)存容量和密度主要通過小型化來增加,但到 2010 年代初,小型化已經(jīng)達到了極限。這是因為,即使存在被認為具有最高絕緣性能的氣隙,也無法再抑制相鄰單元(單元晶體管)之間的干擾,并且單元可以存儲的電荷量已減少到無法再防止干擾的程度。

圖注:NAND 閃存的演變
(1990 年代至 2030 年代)
當時的突破(突破限制的手段)就是 3D 化。作為 NAND 閃存基本電路的單元串(一系列單元晶體管)已從水平方向轉(zhuǎn)換為垂直方向。結(jié)果,單元可存儲的電荷量大大增加,相鄰單元之間的干擾大大減少。
此外,該公司還利用三維 NAND 閃存(3D NAND 閃存),成功實現(xiàn)了傳統(tǒng)半導(dǎo)體存儲器難以實現(xiàn)的 " 多值存儲 " 成為標準規(guī)格,即在一個單元中存儲三位數(shù)據(jù)。
垂直單元串通過增加堆疊單元晶體管的數(shù)量,快速增加了密度和容量。 2010 年代初期的產(chǎn)品有 32 層。到 2020 年代中期,它已發(fā)展到 300 多層,高度約為其原始高度的十倍。此外,將存儲單元陣列堆疊在外圍電路上方(CuA:CMOS under Array)的布局已投入實際使用,從而減少了硅片面積。
與此同時,3D NAND 閃存面臨著與其前身平面 NAND 閃存類似的挑戰(zhàn)。隨著堆疊的增加,形成單元串溝道的孔變得更深,使得蝕刻更加困難。為了緩解這個問題,單元晶體管的柵極(字線)和字線之間的絕緣膜已經(jīng)逐漸變薄。這會增加同一單元串中相鄰單元之間的干擾,并減少可積累的電荷量。
此外,構(gòu)成單元串通道的孔(存儲孔)之間的間距也逐漸縮小,有助于提高存儲密度。這增加了相鄰單元串之間的干擾。
為了解決這個問題,人們嘗試用電荷陷阱單元中的鐵電膜代替作為柵極絕緣膜的氮氧化物 ( ONO ) 膜。電荷陷阱法是通過在 ONO 膜的捕獲能級中積累電荷(主要是傳導(dǎo)電子)來決定邏輯值(1bit 的 " 高 " 或 " 低 ")。鐵電薄膜的邏輯值由極化方向決定,而不是由電荷決定。
通過在單元晶體管中使用鐵電膜,可以實現(xiàn)降低編程電壓和抑制閾值電壓波動等效果。這兩者都有助于減少小區(qū)之間的干擾。在單元級別上也已確認可以支持 " 多值存儲 ",即將單元晶體管的閾值電壓從兩個值增加到八個值(3 位)或 16 個值(4 位)。

圖注:將鐵電薄膜應(yīng)用于 NAND 閃存單元晶體管的嘗試示例。最左邊的圖像(a)是包含鐵電膜(Ferro)的絕緣膜的橫截面圖像(通過 TEM)。中心(b)是將鐵電薄膜納入類似于 NAND 閃存的圓柱形結(jié)構(gòu)的單元晶體管的橫截面圖像(TEM)。最右邊(c)顯示了閾值電壓以 16 種不同的方式變化時的測量結(jié)果(相當于 4 位 / 單元)
DRAM 和 NAND 閃存都面臨著許多阻礙其未來發(fā)展的挑戰(zhàn)。三星在主題演講中提到的只是其中的一部分。我希望能夠找到解決這些問題和其他問題的解決方案,并且希望進步能夠繼續(xù)下去。
更多技術(shù)分享
在演講中,來自全球的企業(yè)和專家對 DRAM 和 NAND 的未來做了豐富的分享。
例如 imec 首次公布純金屬柵極技術(shù),該技術(shù)可將層間距縮小至 30nm,同時確保 3D NAND 閃存的可靠性。鎧俠也分享了其多級編碼技術(shù),該技術(shù)可實現(xiàn)閃存的高速隨機存取。應(yīng)用材料公司開發(fā)出一種快速外延生長 3D NAND 的 Si 溝道的技術(shù)。
除了 3D NAND,GLOBALFOUNDRIES 還將展示兼容 28nm HKMG CMOS 邏輯的分柵嵌入式閃存技術(shù)。他們演示了一個 34Mbit 嵌入式閃存宏的原型。
在 "DRAM" 領(lǐng)域,開發(fā) 3D 存儲器技術(shù)的風險投資公司 NEO Semiconductor 將講解與 3D NAND 結(jié)構(gòu)類似的 3D DRAM 技術(shù) "3D X-DRAM"。內(nèi)存供應(yīng)商 Macronix International 將展示一種改進的 3D DRAM 技術(shù),該技術(shù)由兩條水平字線、一條垂直位線和柵極控制晶閘管組成。半導(dǎo)體能源實驗室 ( SEL ) 通過使用氧化物半導(dǎo)體單片堆疊平面 FET 和垂直通道 FET,制造出了原型 1M 位 3D DRAM。
在 " 鐵電存儲器 " 領(lǐng)域,美光科技講解了其高性能、長壽命鐵電存儲器的材料工程技術(shù)。佐治亞理工學院將描述一種非揮發(fā)性電容器的制造工藝,該工藝能夠?qū)崿F(xiàn)鐵電電容器的小信號無損讀出。GLOBALFOUNDRIES 也討論了互補 FeFET 存儲器中發(fā)生的電荷捕獲問題,該存儲器旨在嵌入 CMOS 邏輯。
在 " 電阻式存儲器 / 交叉點 " 領(lǐng)域,清華大學將展示兼容 40nm 高壓 CMOS 工藝的 3.75Mbit 嵌入式電阻式存儲器宏。此外,旺宏國際開發(fā)了 AsSeGeS 和 GeN 異質(zhì)結(jié)構(gòu),優(yōu)化了交叉點存儲器中使用的 OTS 選擇器的性能。


