文獻(xiàn)標(biāo)識(shí)碼: A
文章編號(hào): 0258-7998(2011)01-0049-03
逐次逼近型ADC是采樣速率低于5 MS/s的中高分辨率應(yīng)用的常見結(jié)構(gòu),SAR ADC的分辨率一般為8~16位,具有低功耗、小尺寸等特點(diǎn),因此具有較寬的應(yīng)用范圍,如:便攜式儀器電池供電儀表、工業(yè)控制和數(shù)據(jù)/信號(hào)采集器等[1]。
在現(xiàn)有工藝水平下,由于受電容失配、系統(tǒng)失調(diào)以及噪聲等因素的限制,采用電荷再分配結(jié)構(gòu)的SAR ADC能夠達(dá)到的最高精度被限制在12位左右[2]。因此,高精度ADC設(shè)計(jì)必須依靠校準(zhǔn)技術(shù)。一般校準(zhǔn)技術(shù)有兩類:模擬校準(zhǔn)技術(shù)是在模擬領(lǐng)域把相關(guān)的量調(diào)整到正常數(shù)值或者利用激光對(duì)芯片元件進(jìn)行修正,但這種技術(shù)成本高,且容易受到封裝時(shí)機(jī)械應(yīng)力的影響;還有一種數(shù)字校準(zhǔn)技術(shù),通過把電路中失配誤差等影響在數(shù)字領(lǐng)域描述,然后在數(shù)字領(lǐng)域?qū)敵龃a進(jìn)行調(diào)整,而不關(guān)心模擬領(lǐng)域的物理量數(shù)值[3]。數(shù)字校準(zhǔn)是現(xiàn)行校準(zhǔn)技術(shù)的主流。
提出一種基于二進(jìn)制加權(quán)電容陣列DAC的數(shù)字校準(zhǔn)算法,用一個(gè)低精度的DAC表示各個(gè)待校準(zhǔn)電容的失配誤差值,然后在AD轉(zhuǎn)換過程中,將相應(yīng)的誤差電壓加載到電容陣列中,實(shí)現(xiàn)對(duì)電容網(wǎng)絡(luò)的校準(zhǔn)。
1 SAR ADC內(nèi)核原理
SAR ADC的基本結(jié)構(gòu)由比較器、DAC、SAR邏輯控制電路組成,如圖1所示。

基本工作過程:首先模擬輸入Vin被采樣保持,送入比較器的一端, N位SAR寄存器的初始值為中間值(即100……00),DAC將該值轉(zhuǎn)換為對(duì)應(yīng)模擬量VDAC=VREF/2(VREF是ADC的基準(zhǔn)電壓)。比較器開始比較Vin與VDAC的大小。若Vin>VDAC,則比較器輸出1,SAR寄存器的最高位保持,次高位預(yù)置為1;反之,比較器輸出0,SAR寄存器的最高位為0,次高位預(yù)置為1,ADC進(jìn)行下一次比較。這樣反復(fù)逐次比較直到SAR寄存器的最低位,寄存器中保存的N位數(shù)字量就是ADC的轉(zhuǎn)換結(jié)果。
2 數(shù)字校準(zhǔn)算法
數(shù)字校準(zhǔn)算法的基本思想是在ADC正常使用前,先計(jì)算電容失配等的一些非線性誤差,把誤差相應(yīng)地在數(shù)字領(lǐng)域用校準(zhǔn)碼形式描述,并在正常工作過程中把這些校準(zhǔn)碼加載到電路中進(jìn)行誤差校準(zhǔn),從而達(dá)到校準(zhǔn)失配的目的。校準(zhǔn)碼的產(chǎn)生和使用有不同的算法[4,5],本文設(shè)計(jì)了一種從低位到高位電容依次校準(zhǔn)的思想。
2.1 校準(zhǔn)碼產(chǎn)生的算法原理說明
本設(shè)計(jì)中采用對(duì)稱的分段電容結(jié)構(gòu),如圖2。對(duì)稱差分結(jié)構(gòu)使得比較器輸入負(fù)載相等,消除比較器的共模噪聲,提高信噪比;分段電容陣列采用高位與低位通過過渡電容耦合的結(jié)構(gòu),保證了MSB的高精度以及LSB的單調(diào)性。N(N=M+K)位的SAR ADC由左右側(cè)差分結(jié)構(gòu)的高M(jìn)位DAC以及左側(cè)低K位的DAC構(gòu)成,右側(cè)低K位則用于校準(zhǔn)電容陣列的失配誤差。
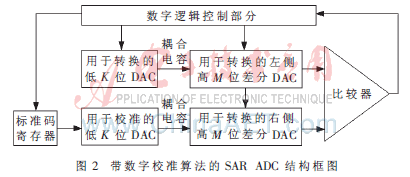
產(chǎn)生校準(zhǔn)碼的工作過程中,設(shè)置兩種電容陣列工作狀態(tài):Φ1工作狀態(tài)下接入一組電容,并將左右側(cè)電容陣列的輸出與比較器的輸入端斷開(比較器兩端輸入均為0),同時(shí)電容陣列輸出端接共模電平VCM;Φ2工作狀態(tài)下接入另一組電容,輸出接比較器兩端的輸入端進(jìn)行比較。通過兩種工作時(shí)序的切換,根據(jù)電荷守恒以及電荷重分配原理,待校準(zhǔn)電容之間的失配誤差可以通過右側(cè)低K位的校準(zhǔn)電容陣列表示出來。
下面以高位電容為例,分析校準(zhǔn)碼產(chǎn)生原理細(xì)節(jié)。圖3為在兩個(gè)不同的工作狀態(tài)下左側(cè)電容陣列的等效模型。

圖3中,CLN表示左側(cè)電容陣列中除了C1、C2電容外的所有電容之和,C1表示已經(jīng)校準(zhǔn)的所有電容之和,C2表示目前待校準(zhǔn)的電容,且C1、C2為相鄰的兩組電容,設(shè)CT表示左側(cè)電容陣列總電容值,即有CLN+C1+C2=CT。VL端接入比較器的一個(gè)輸入端,根據(jù)Φ1、Φ2兩種工作狀態(tài)下的電荷守恒原理,則有:


式(4)中,C1是已校準(zhǔn)電容,且C2與C1之間有相互聯(lián)系的權(quán)重關(guān)系,而C2與C1之間的失配誤差可以通過CV描述出來。CV的值對(duì)應(yīng)右側(cè)低K位電容陣列的開關(guān)二進(jìn)制值,即將電容失配誤差的影響通過數(shù)字域描述出來,并在正常轉(zhuǎn)換過程中,將這些誤差通過相應(yīng)的處理后加載在電路中,實(shí)現(xiàn)校準(zhǔn)誤差的效果。
2.2 SAR ADC校準(zhǔn)算法的實(shí)現(xiàn)
假設(shè)單位電容的失配誤差為?駐,通過對(duì)應(yīng)位電容數(shù)量的加和,可以近似模擬高位電容誤差的統(tǒng)計(jì)分布情況。當(dāng)每位電容的統(tǒng)計(jì)誤差與其對(duì)應(yīng)的權(quán)重(2n)乘積超過單位權(quán)值時(shí),需要考慮對(duì)此位進(jìn)行校準(zhǔn)。
現(xiàn)假設(shè)需要校準(zhǔn)的最低位電容CL1為左側(cè)低K位電容陣列中的某電容。將CL1低一位的電容C0視為基準(zhǔn)電容值,高位電容則需要依次校準(zhǔn)為2i×C0,以達(dá)到相互匹配的關(guān)系。首先需要用右側(cè)低位校準(zhǔn)電容陣列表示出基準(zhǔn)電容C0的大小。在Φ1工作狀態(tài),左右側(cè)電容陣列均不接入電容,輸出接共模電平。Φ2工作狀態(tài),左側(cè)電容陣列接入C0,同時(shí)右側(cè)低位校準(zhǔn)電容陣列接入可變的Cv0電容,觀察比較器的輸出,當(dāng)比較器輸出發(fā)生跳變時(shí),有:

Calib集合保存的是對(duì)應(yīng)位電容的校準(zhǔn)碼值,在正常的SAR ADC模數(shù)轉(zhuǎn)化過程中,加載到右側(cè)低位的校準(zhǔn)電容陣列中,與對(duì)應(yīng)待校準(zhǔn)電容的共同作用下,起到校準(zhǔn)電容失配誤差的效果。
3 系統(tǒng)行為級(jí)仿真及結(jié)果分析
設(shè)置單位電容的失配誤差為0.5%,建立帶有統(tǒng)計(jì)分布失配誤差的14 bit電容陣列模型。由于本次的系統(tǒng)行為級(jí)仿真是為了驗(yàn)證校準(zhǔn)算法的正確性及有效性,因此,設(shè)計(jì)比較器為理想的比較器,可以實(shí)現(xiàn)無限精度的比較。
系統(tǒng)級(jí)仿真內(nèi)容包括采用碼密度直方圖方式仿真微分非線性(DNL)和積分非線性(INL)等常規(guī)靜態(tài)參數(shù),并采用FFT法進(jìn)行頻譜分析,仿真信噪比、信噪失真比和有效位數(shù)等動(dòng)態(tài)參數(shù)[6]。
進(jìn)行靜態(tài)參數(shù)仿真時(shí),滿足0.3LSB精度、95%置信度,仿真點(diǎn)數(shù)設(shè)置為220個(gè)。
對(duì)于ADC的頻譜分析,設(shè)置采樣頻率fs為200 kHz,采樣點(diǎn)數(shù)為N為8 192個(gè)點(diǎn),采樣的周期數(shù)M為129個(gè)。
SAR ADC在未進(jìn)行數(shù)字校準(zhǔn)時(shí),由于電容之間的失配誤差導(dǎo)致ADC非線性,引起頻譜的失真,在頻譜圖上表現(xiàn)出明顯的諧波,造成信噪比以及有效位數(shù)都比較低。從仿真結(jié)果(見圖5、圖6)可以看出信號(hào)噪聲失真比SNDR為72.9 dB,有效位數(shù)僅為11.82 bit。靜態(tài)參數(shù)INL、DNL分別為2.86 LSB、5.01 LSB,說明存在嚴(yán)重的失碼。

在相同采樣頻率及輸入信號(hào)的情況下,對(duì)SAR ADC進(jìn)行數(shù)字校準(zhǔn)。從仿真結(jié)果可以看出(見圖7、圖8),校準(zhǔn)后,ADC的非線性有了明顯改善,SNDR有明顯的提高,為85.1 dB,有效位數(shù)為13.85 bit,接近理想的轉(zhuǎn)換位數(shù)。靜態(tài)參數(shù)INL、DNL分別為0.25 LSB、0.26 LSB。


本文詳細(xì)介紹了一種基于二進(jìn)制加權(quán)電容陣列SAR ADC的數(shù)字校準(zhǔn)算法。該算法通過利用兩種不同工作狀態(tài)下電容陣列電荷守恒以及電荷重分配原理,實(shí)現(xiàn)由低位到高位依次校準(zhǔn)電容的目的,大大改善了整體SAR ADC由電容失配引起的非線性。通過對(duì)實(shí)際14 bit SAR ADC系統(tǒng)級(jí)的仿真可以看到,在加入校準(zhǔn)算法后,ADC的信噪比以及有效位數(shù)得到明顯的提高,非線性失真很大程度上得到了抑制,即驗(yàn)證了本校準(zhǔn)算法的正確性和有效性,為高精度SAR ADC的設(shè)計(jì)提供了有效而且易于實(shí)現(xiàn)的數(shù)字校準(zhǔn)算法。
參考文獻(xiàn)
[1] 魏智.解析逐次逼近ADC[J].國外電子元器件,2003(2):72-74.
[2] 周文婷,李章全.SAR A/D轉(zhuǎn)換器中電容失配問題的分析[J].微電子學(xué),2007,37(2):199-203 .
[3] 戴瀾,周玉梅,胡曉宇,等.一種流水線ADC數(shù)字校準(zhǔn)算法實(shí)現(xiàn)[J].半導(dǎo)體學(xué)報(bào),2008,29(5):993-997.
[4] LEE H S.Self-calibration technique for A/D converters[J]. IEEE Transactions on Circuits and Systems,1983,30(3):188-190.
[5] 喬高帥,戴慶元,孫磊,等.基于16位SAR模數(shù)轉(zhuǎn)換器的誤差校準(zhǔn)方法[J].微納電子技術(shù),2009,46(10):636-639.
[6] 王衛(wèi)江,陶然.高速ADC的性能測試[J].電子技術(shù)應(yīng)用,2004,30(2):33-34.

