文獻標識碼: A
DOI:10.16157/j.issn.0258-7998.2017.07.012
中文引用格式: 李揚. SiP系統(tǒng)級封裝設(shè)計仿真技術(shù)[J].電子技術(shù)應(yīng)用,2017,,43(7):47-50,,54.
英文引用格式: Li Yang. SiP-system in package design and simulation technology[J].Application of Electronic Technique,2017,,43(7):47-50,,54.
0 引言
SiP系統(tǒng)級封裝是一種最新的電子封裝和系統(tǒng)集成技術(shù),,目前正成為電子技術(shù)發(fā)展的熱點,,受到了來自多方面的關(guān)注。這些關(guān)注者既來源于傳統(tǒng)的封裝Package設(shè)計者,,也來源于傳統(tǒng)的MCM設(shè)計者,,更多來源于傳統(tǒng)的PCB設(shè)計者,甚至SoC的設(shè)計者也開始密切關(guān)注SiP,。
和Package比較而言,,SiP是系統(tǒng)級的多芯片封裝,能夠完成獨立的系統(tǒng)功能,。和MCM比較而言,,SiP是3D立體化的多芯片封裝,其3D主要體現(xiàn)在芯片堆疊和基板腔體上,。同時,SiP的規(guī)模和所能完成的功能也比MCM有較大提升,。和PCB比較而言,,SiP技術(shù)的優(yōu)勢主要體現(xiàn)在小型化、低功耗,、高性能方面,。實現(xiàn)和PCB同樣的功能,SiP只需要PCB面積的10~20%左右,,功耗的40%左右,,性能也會有較大的提升,。和SoC比較而言,SiP技術(shù)的優(yōu)勢體現(xiàn)在周期短,、成本低,、易成功等方面。實現(xiàn)同樣的功能,,SiP只需要SoC研發(fā)時間的10~20%,,成本的10~15%左右,并且更容易取得成功,。
1 應(yīng)用在SiP設(shè)計仿真中的技術(shù)
SiP設(shè)計是集高級封裝設(shè)計,、MCM設(shè)計、PCB設(shè)計之大成,,同時又和IC設(shè)計密切相關(guān),。在SiP設(shè)計中,主要包含的技術(shù)有:鍵合線(Wire Bonding),、芯片堆疊(Die Stacks),、腔體(Cavity)、倒裝焊(Flip Chip)及重分布層(RDL),、高密度基板(HDI),、埋入式無源元件(Embedded Passive)、參數(shù)化射頻電路(RF)等技術(shù),。
同時,,為了先導(dǎo)的IC芯片設(shè)計以及后續(xù)PCB設(shè)計協(xié)同,SiP設(shè)計中會應(yīng)用到多版圖項目設(shè)計技術(shù),。
圖1給出了IC裸芯片,、SiP封裝、PCB板級系統(tǒng)三者之間的關(guān)系,。IC裸芯片被封裝在SiP中,,SiP又被安裝在PCB之上。信號在三者之間相互傳遞,,電源從外部設(shè)備提供到PCB→SiP→IC裸芯片,。從整個系統(tǒng)應(yīng)用的環(huán)節(jié)上來說,三者之間是密不可分的,。
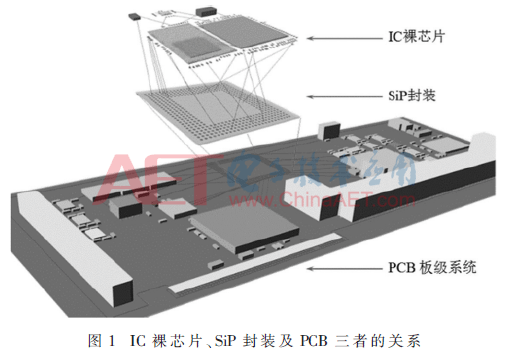
為了提高設(shè)計效率以及應(yīng)對突發(fā)緊急的項目,,SiP設(shè)計中會應(yīng)用多人協(xié)同設(shè)計,這包括原理圖多人協(xié)同設(shè)計和版圖多人協(xié)同設(shè)計,。
另外,,因為SiP具有3D立體化的特點,需要設(shè)計工具支持3D實時顯示和3D DRC檢查等功能,。
除了設(shè)計技術(shù),,仿真技術(shù)也是保證SiP產(chǎn)品成功的重要環(huán)節(jié),,其中包含信號完整性仿真、電源完整性仿真,、熱分析,、電熱聯(lián)合仿真以及3D電磁場仿真等。
2 SiP設(shè)計仿真流程
為了確保SiP項目能夠取得成功,,遵循嚴格而規(guī)范的設(shè)計流程是必不可少的,。通過多個實際SiP項目的成功經(jīng)驗,現(xiàn)將SiP的設(shè)計仿真流程總結(jié)如下,,參看圖2,,SiP設(shè)計仿真流程主要包含12個步驟:

(1)設(shè)計方案定義,主要包括:SiP相關(guān)資料收集,、裸芯片物理尺寸,、管腳定義、能否采購等,。封裝類型是采用BGA還是其他封裝形式,、封裝尺寸的確定、管腳間距,、數(shù)目的確定,。采用自定義管腳排列方式還是采用標準封裝。封裝工藝和材料選擇,,根據(jù)其應(yīng)用領(lǐng)域選擇塑料封裝,、陶瓷封裝或金屬封裝。
(2)建庫及庫管理,,主要包括原理圖符號庫,、IC裸芯片庫、BGA封裝庫,、Part庫以及仿真模型庫等建立,。
(3)原理圖設(shè)計,主要包括原理圖輸入,,射頻原理設(shè)計以及原理圖協(xié)同設(shè)計等,。
(4)設(shè)計前仿真,可和原理圖設(shè)計同步進行,,通過假定分析,,確定設(shè)計層疊結(jié)構(gòu)、關(guān)鍵信號的網(wǎng)絡(luò)拓撲結(jié)構(gòu),、阻抗匹配,,以及電源平面的分割,、電容種類及型號選擇等,。對數(shù)?;旌想娐犯鶕?jù)需要進行電路功能仿真。
(5)工藝確定,,主要是為了確定SiP采用哪種工藝,,如Wire Bonding、FlipChip,、TAB,、TSV等?;迳鲜欠褚谇惑w,,采用單面腔體還是雙面腔體,以及腔體結(jié)構(gòu)等,。同時要考慮是否做芯片堆疊Chip stack,,基板的層數(shù)以及層疊結(jié)構(gòu)等通常在這一步要確定下來。
(6)基板層疊設(shè)置,,約束規(guī)則設(shè)置,,根據(jù)工藝確定及設(shè)計復(fù)雜程度進行SiP基板層疊結(jié)構(gòu)設(shè)置,包括層數(shù)以及層疊結(jié)構(gòu)的選擇,,是采用m+N+m(其中m代表激光孔,,N代表機械孔)或者ALIVH等層疊結(jié)構(gòu)。約束規(guī)則設(shè)置主要包括網(wǎng)絡(luò)分類,、網(wǎng)絡(luò)類規(guī)則,、間距規(guī)則、電氣規(guī)則,、區(qū)域規(guī)則等,。
(7)器件布局,確定裸芯片在SiP封裝中的位置,。如果芯片需要放置到腔體里,,則需要確定腔體的深度以及是單階還是多階腔體,腔體形狀的繪制和屬性設(shè)置等,;如果需要設(shè)計芯片堆疊,,則堆疊芯片后再進行布局。
(8)引線鍵合,、布線和敷銅,,主要確定引線鍵合方式是單層鍵合還是多層鍵合、鍵合線模型選擇,、電源環(huán)設(shè)置,;交互式手工布線或自動布線、電源層分割,、射頻電路設(shè)計,,埋阻,、埋容的自動綜合等。
(9)版圖設(shè)計檢查,,檢查版圖設(shè)計中的DRC錯誤并進行修正,,確保設(shè)計的正確性。
(10)設(shè)計后仿真
將版圖設(shè)計數(shù)據(jù)導(dǎo)出到仿真工具,,進行信號完整性,、電源完整性、電磁場及熱等方面的仿真,。解決由于信號質(zhì)量,、供電不足、噪聲等產(chǎn)生的問題,,以及由于芯片功耗過大而發(fā)生的過熱問題,,確保產(chǎn)品工作的穩(wěn)定和可靠性。后仿真如果順利通過,,則進入到下一步,,如果不能通過則需要回到前仿真,進行優(yōu)化后重新設(shè)計和仿真,。
(11)后處理及生產(chǎn)文件
輸出包括Gerber,、Drill、BOM,、DXF,、IDF、GDSII,、ODB++等格式的文件,。
(12)電子結(jié)構(gòu)一體化設(shè)計
電子設(shè)計軟件ECAD工具主要完成的是SiP內(nèi)部的設(shè)計,包括基板設(shè)計和芯片組裝,、鍵合等,,而SiP的外殼等數(shù)據(jù)通常需要通過結(jié)構(gòu)設(shè)計軟件MCAD來確定,如陶瓷封裝的金屬框架,、蓋板,、塑封的模封,BGA的焊球,,金屬封裝的外殼等,,需要電子結(jié)構(gòu)一體化設(shè)計完成。
所有流程走完,,SiP設(shè)計仿真結(jié)束,,進入生產(chǎn)環(huán)節(jié)。
3 SiP設(shè)計仿真技術(shù)在實際項目的應(yīng)用
結(jié)合某SiP項目的實際應(yīng)用,闡述SiP設(shè)計仿真的流程及具體問題的解決方法,。
SiP設(shè)計和仿真采用了Mentor Graphics最新的Xpedition軟件高級封裝功能模塊及相關(guān)的仿真工具,。
3.1 從方案定義到工藝確定
首先是設(shè)計方案定義,該SiP是一款應(yīng)用在航空航天項目中的計算機系統(tǒng)SiP,,其原理和在航天項目中成功應(yīng)用的PCB主板基本相同, 原理圖設(shè)計主要參考原有的主板進行設(shè)計。由于需要扇出的引腳數(shù)量較多,,所以選擇BGA封裝形式,。由于該產(chǎn)品工作環(huán)境苛刻,所以選擇陶瓷封裝,。該SiP包含的主要的裸芯片為CPU,、FPGA、DDRIII,、SRAM和3片F(xiàn)lash,。在有限的空間內(nèi),無法在單面完成布局,因此選擇雙面器件布局的方案,其中尺寸較大的FPGA放在基板背面,,并采用腔體嵌入,,周圍為BGA焊球區(qū)域,其他芯片放置在基板正面,,整體方案如圖3所示。
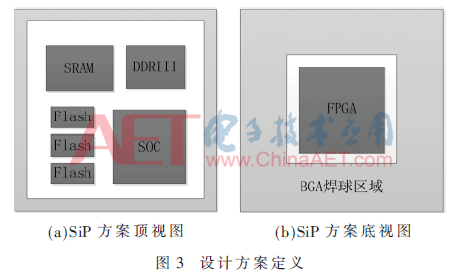
下一步是創(chuàng)建所需要的元器件庫,包括裸芯片庫,、無源器件庫和BGA封裝庫。這部分工作由中心庫管理工具來完成,,分別創(chuàng)建焊盤Padstacks,,創(chuàng)建原理符號Symbol,創(chuàng)建版圖單元Cell,,然后把Symbol和Cell對應(yīng)起來,,形成器件Part,就可以直接在原理圖中使用了,。需要注意的是Padstack,、symbol、Cell的信息都可以從上游IC設(shè)計的輸出文件中獲取,,并通過建庫向?qū)韯?chuàng)建,,這樣既保證了效率,又避免出錯,。
庫創(chuàng)建完成后,,進入原理圖設(shè)計階段。其主要工作是確定硬件系統(tǒng)結(jié)構(gòu)以及使用的總線等,從庫中調(diào)用元器件,,放置到原理圖并進行正確的網(wǎng)絡(luò)互連,。在原理圖設(shè)計過程中或設(shè)計完成后,可在原理圖中抽取關(guān)鍵網(wǎng)絡(luò)進行設(shè)計前仿真,。通過LineSim-link功能,,可直接將選擇的關(guān)鍵網(wǎng)絡(luò)傳遞到仿真工具HyperLynx前仿真環(huán)境LineSim中,然后加載器件模型,,進行前仿真,。
該SiP主要由數(shù)字電路組成,無需做數(shù)?;旌想娐贩抡?。另外,由于電源種類不多,,每種電源都能有充足的空間分布,,所以也無需做電源完整性前仿真。前仿真主要工作是完成信號完整性仿真,。
根據(jù)LineSim前仿真結(jié)果,,對原理圖進行了優(yōu)化設(shè)計,確定了網(wǎng)絡(luò)拓撲結(jié)構(gòu),,關(guān)鍵網(wǎng)絡(luò)的匹配方式,,部分網(wǎng)絡(luò)增加了匹配電阻,確定了關(guān)鍵信號的布線策略,。
下一步進入工藝階段,。工藝確定是前面方案定義階段的細化,該SiP包含的所有IC裸芯片均支持鍵合工藝,,布局上采用雙面布局,,F(xiàn)PGA和CPU因為引腳數(shù)量比較多,鍵合線多層排列,,均要設(shè)計多階腔體階,,將芯片放置在腔體內(nèi)部,這樣,,多層鍵合時外層鍵合線跨度和弧度均能有效減小,,提高鍵合線的穩(wěn)定性。參看圖4,。

該SiP工藝確定包括:Bond wire,,基板多階腔體,芯片堆疊等工藝,。
3.2 SiP版圖設(shè)計
工藝確定后,,進入層疊設(shè)置和規(guī)則設(shè)置階段,該設(shè)計中采用多層HTCC陶瓷基板,首先按照前面工藝確定的要求,,繪制雙面多階腔體,,然后進行器件布局。需要注意的是,,BGA封裝也作為一個器件,,布局到基板的背面,作為信號對外通路以及外部供電的接口,。布局完成后進行規(guī)則設(shè)置,,在CES(Constraint Edit System)中設(shè)置線寬、線間距,、等長、差分等規(guī)則,。另外還需要合理分配電源,、地平面層,選擇合適的過孔等,。規(guī)則設(shè)置完后,,進行裸芯片的鍵合,將芯片與基板電氣連接,。
因為Bond wire,、芯片堆疊及腔體都是3D元素,所以要結(jié)合2D和3D設(shè)計環(huán)境進行操作,,圖5所示為完成布局和鍵合后的SiP設(shè)計在3D環(huán)境中的截圖,。為了更清楚地檢查Bond wire細節(jié)以及頂層CPU和底層FPGA的位置,可以選擇3D局部檢查,。圖6為鍵合完成后的3D側(cè)面局部截圖,,可以清楚地看出CPU、FPGA的鍵合圖和它們的相對位置,,從此圖也可以看出腔體結(jié)構(gòu)大大減小了外層Bond wire的跨距和弧度,,增加了Bond wire的穩(wěn)定性,提高了SiP的抗震動和沖擊能力,。


隨后,,進入版圖布線和覆銅環(huán)節(jié)。完成后做版圖DRC檢查環(huán)節(jié),,這兩步基本和PCB設(shè)計大同小異,,在此不做贅述。DRC檢查通過后,,版圖設(shè)計完成,。
3.3 SiP設(shè)計后仿真
版圖設(shè)計完成后,需要對關(guān)鍵網(wǎng)絡(luò)進行仿真。因為SiP的3D立體特性,,二維的仿真工具已無法解決問題,,需要采用三維仿真工具抽取三維模型。這里采用HyperLynx Full-Wave Solver抽取版圖設(shè)計的3D模型,,因為3D電磁場仿真對系統(tǒng)資源和內(nèi)存要求都很高,,一般抽取關(guān)鍵網(wǎng)絡(luò)及其參考網(wǎng)絡(luò)周邊的局部3D模型,在滿足仿真精度的要求下,,節(jié)省資源消耗,,如圖7所示為抽取的DDRIII部分關(guān)鍵網(wǎng)絡(luò)的3D模型。
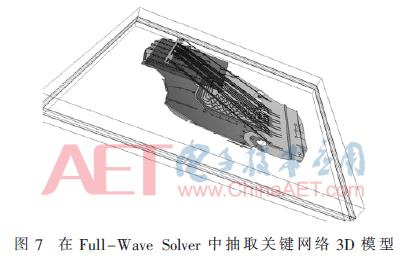
在此模型基礎(chǔ)上,,進行3D電磁場仿真,,可得到關(guān)鍵網(wǎng)絡(luò)的S-parameter模型,此模型為關(guān)鍵網(wǎng)絡(luò)的互聯(lián)特性模型,,如圖8所示為關(guān)鍵網(wǎng)絡(luò)的S參數(shù),。
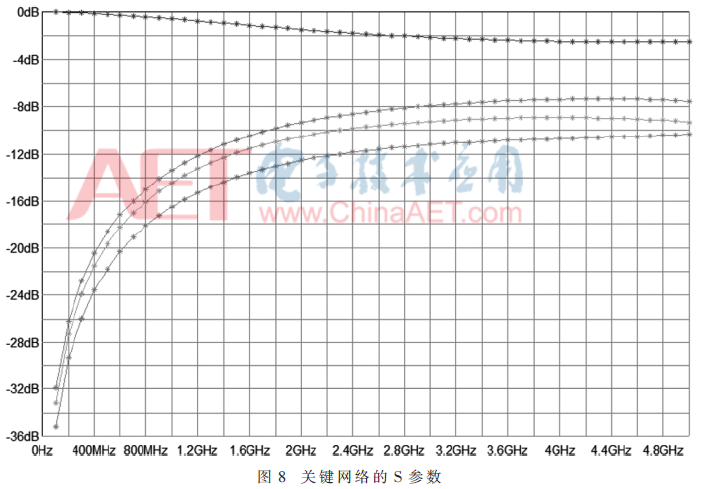
然后將此互聯(lián)路徑的S參數(shù)模型連同IC芯片的IBIS或者Spice模型一起導(dǎo)入HyperLynx SI中進行仿真,即可獲得DDRIII信號實際工作時的信號波形,,如圖9所示為DDRIII信號眼圖,,可以看出,眼圖張開良好,,滿足設(shè)計要求,。

另外,為了保證有足夠的電源供應(yīng),,避免由于電壓供應(yīng)不足而造成的系統(tǒng)不穩(wěn)定,,以及電流密度過大造成局部溫度過高而產(chǎn)生事故,這都需要進行電源完整性PI分析,。通過PI分析,,該SiP設(shè)計滿足要求,未出現(xiàn)壓降過大或者電流密度過大的問題,。圖10給出3.3 V電源的電流密度仿真結(jié)果,,可以看出最大電流密度為33.9 mA/mil2,滿足設(shè)計要求,。

此外,,熱分析也是SiP仿真后分析的重要的環(huán)節(jié),通過熱分析,,可以避免由于器件過熱而造成的系統(tǒng)工作不穩(wěn)定,,可靠性下降等問題。由于文章篇幅關(guān)系,,這里就不做詳述,。
3.4 生產(chǎn)文件輸出及電子結(jié)構(gòu)一體化設(shè)計
后仿真通過后,,就可以輸出生產(chǎn)文件,一般需要輸出基板的Gerber及Drill文件,,描述每一層的圖形和鉆孔,。另外,此SiP設(shè)計基板的結(jié)構(gòu)比較復(fù)雜,,所以還需要一個輸出一份DXF文件,,詳細描述腔體的位置、尺寸,、每一臺階的寬度和深度,。另外,再編寫一份技術(shù)說明文檔,,提醒生產(chǎn)廠家生產(chǎn)中應(yīng)注意的問題,。
在SiP基板設(shè)計完成后,可將結(jié)構(gòu)軟件設(shè)計的蓋板,,框架以及后續(xù)工藝需要植在基板底部的BGA焊球等數(shù)據(jù)從結(jié)構(gòu)設(shè)計軟件導(dǎo)入3D設(shè)計檢查環(huán)境,,檢查ECAD和MCAD設(shè)計的一致性,在3D環(huán)境中模擬產(chǎn)品結(jié)構(gòu)和外觀,,避免數(shù)據(jù)交互中由于誤解而造成的設(shè)計往復(fù),。
4 結(jié)論
本文介紹了SiP系統(tǒng)級封裝設(shè)計仿真技術(shù)的流程和方法,,并結(jié)合實際的SiP工程項目,,詳細論述了SiP設(shè)計和仿真的具體環(huán)節(jié)及實施方法。
本文中描述的SiP設(shè)計仿真流程和方法,,已成為SiP設(shè)計仿真工程師的重要參考,,成功應(yīng)用在國內(nèi)多款SiP項目中,并取得了良好的社會效益和經(jīng)濟效益,。
參考文獻
[1] 李揚,,劉楊.SiP系統(tǒng)級封裝設(shè)計與仿真—Mentor Expedition Enterprise Flow高級應(yīng)用指南[M].北京:電子工業(yè)出版社,2012.
[2] Advanced Packaging Guide,,Release X-ENTP VX.2,,Mentor Graphics,2016.
[3] Philip E.Garrou, Lwona Turlik著.多芯片組件技術(shù)手冊[M].王傳聲,,葉天培等,,譯.北京:電子工業(yè)出版社,2006.
[4] HyperLynx SI/PI User Guide,,Mentor Graphics,,2016.
作者信息:
李 揚
(奧肯思科技有限公司,北京100045)

