文獻標識碼: A
文章編號: 0258-7998(2010)12-0048-03
單片微波集成電路(MMIC)憑借小型緊湊、穩(wěn)定性好、抗干擾能力強、批量生產成本低和產品性能一致性好的優(yōu)點成為軍事電子對抗及民用通信系統(tǒng)最具吸引力的選擇。MMIC單位產品的價格和芯片面積有很大關系,因此需要在保證功率放大器正常穩(wěn)定工作的同時盡量減小芯片面積,減小芯片面積往往和芯片的散熱能力矛盾。場效應管的溝道溫度是決定其可靠性的關鍵性因素,溝道溫度不能高于150 ℃。微波功率放大器的熱分析主要有3個方面:(1)電子設備機箱、機框等系統(tǒng)的熱分析為系統(tǒng)級別的熱分析;(2)電子模塊、散熱器、PCB板級別的熱分析為封裝級別熱分析;(3)元件、芯片級別的熱分析為組件級別熱分析。通過Ansys軟件對高功率Ka波段功率放大器芯片熱分析,也涉及芯片的封裝,因此是屬于芯片級和封裝級熱分析。高功率放大器芯片通過多個晶體管并聯(lián)實現(xiàn)高功率輸出。選取了制造工藝和并聯(lián)的晶體管數(shù)目以后,晶體管的總柵寬也就確定,進而晶體管的單指柵寬和柵指數(shù)也就可以被確定下來。
1 程序分析原理
一般說來,溫度的計算是由拉普拉斯的三維方程式?jīng)Q定的:

其中,T(x,y,z)是指被分析物體空間里任意一點,問題的求解可以看作是在一定的邊界條件和初始條件求解微分方程或微分方程組的問題[1,2]。但由于控制微分方程組的復雜性以及邊界條件的難以確定,一般不能得到系統(tǒng)的精確解。對于這類問題,一般需要采用各種數(shù)值計算方法獲得滿足需要的近似數(shù)值解,這就是數(shù)值模擬技術。目前解決實際工程問題的主要數(shù)值方法包括兩大類:有限差分法和有限元法,而后者比前者的應用范圍更廣,更易于操作。Ansys軟件是集結構、傳熱學、流體、聲學、爆破分析為一體的大型通用有限元軟件。可以對力場、溫度場、流場、磁場、熱-流耦合場、電磁-熱耦合場等進行仿真。由于Ansys軟件功能強大且數(shù)值仿真精確,已經(jīng)成為結構設計、熱設計等設計的首選[3]。在Ansys所進行的結構力學分析中,主要使用的是能量方程式,通過Rayleigh-Ritz方法,導出有限元分析的剛性矩陣。在Rayleigh-Ritz方法中,使用能量方程式[4]:
然而,并不是所有問題都適合用能量方程式來處理。對于純量場問題,如熱分析等問題,由于微分方程比能量方程式容易獲得,因此采用比較適合Galerkin方法直接生成系統(tǒng)的剛性矩陣。方程式如下[4]:
程序可處理熱傳遞的三種基本類型:傳導、對流和輻射,并可進行穩(wěn)態(tài)和瞬態(tài)、線性和非線性分析。熱分析還具有可以模擬材料固化和熔解過程的相變分析能力以及模擬熱與結構應力之間的熱結構耦合分析能力。Ansys進行熱分析的基本原理是先將所處理的對象劃分成有限個單元(包含若干節(jié)點),然后根據(jù)能量守恒原理求解一定邊界條件和初始條件下每一節(jié)點處的熱平衡方程,由此計算出各節(jié)點溫度,繼而進一步求解出其他相關量。Ansys軟件主要包括三個部分:前處理模塊、分析處理模塊和后處理模塊。在實際應用的過程中可以通過很多方法來創(chuàng)建有限元模型,以進行各種相關的分析計算。如何建立模型對分析計算模塊及后處理模塊有著至關重要的影響。
2 分析過程及仿真結果
2.1 晶體管模型
Ka波段功率輸出為2 W的MMIC功率放大器芯片,芯片面積為3 mm×3 mm,所用工藝為D01PH,該芯片采用商業(yè)化的0.13 μm的GaAs PHEMT工藝進行設計,其晶體管結構采用交叉梳狀結構,結構如圖1所示,在該結構中y方向的柵指長度為柵長(Lg),x方向的柵指長度為柵寬(Wg),基片厚度為t,漏極區(qū)與源極區(qū)交替出現(xiàn)在柵指的兩側,最外兩側的源極區(qū)通常用于接地,所有的源極區(qū)通過空氣橋相連接,同樣所有的柵指以及漏極區(qū)也是分別互相連接。對晶體管模型做如下假設:
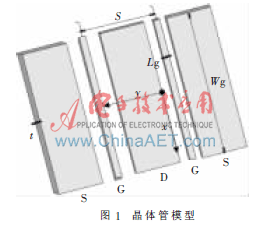
(1)耗散功率也就是晶體管產生的熱量完全由柵指產生,熱量Q分布在Wg×Lg的面積上;
(2)除了下表面,所有表面是絕熱的,下表面保持70 ℃的恒溫。
漏極區(qū)在y方向的長度為13 μm,源極區(qū)在y方向長度為10 μm。D01PH工藝的柵長是0.13 μm,柵寬由用戶根據(jù)需要進行選擇,柵寬越長則晶體管所能輸出的功率就越大。基于這樣一個簡單的示意圖可以對其熱特性作一個初步的判斷:
(1)柵指間距S越寬,其散熱性能越好。柵指間距對于晶體管的電特性影響較小,因此增加柵指間距可以在其耗散功率不變的前提下減小其熱阻,進而減小柵指下方的溝道溫度。
(2)中間區(qū)域的柵指溫度將會較兩端柵指的溫度高,柵指中心的溫度較柵指兩頭的溫度要高,這是顯而易見的,因此晶體管的最高溫度處將會是在中間區(qū)域柵指的中心。
(3)減小基片厚度t同樣可以使晶體管在輸出功率不降低、耗散功率不增加的情況下降低晶體管的熱阻,從而減小晶體管溝道的溫度。有了以上三點判斷就可以對晶體管的熱特性有所了解。但是,GaAs PHEMT工藝的柵指間距以及基片厚度都是固定的,用戶不能任意修改柵指間距和基片厚度,晶體管的熱性能除了與晶體管的柵指間距和基片厚度相關外,改變單指柵寬同樣也可以改變晶體管散熱性能。減小柵寬可以減小單個晶體管的輸出功率,同時也會降低其耗散功率,但柵寬的減小同樣也會增加晶體管的熱阻,降低其散熱能力。于是,只有通過定量分析才可以了解晶體管的柵寬與晶體管溝道溫度的關系。
2.2 分析及仿真
Ansys軟件對等間距柵指排列晶體管的溝道溫度進行熱分析,首先進行前處理,操作如下:
(1)選用適當?shù)脑亍⒍x元素特性及材料性質;
(2)建立被分析物體的實體模型;
(3)產生有限元素模型。
設計的目標輸出是2 W,輸出計劃由8路合成,則每路輸出至少0.25 W。該功率放大器芯片采用并聯(lián)功率合成的方式,4路驅動8路、8路級聯(lián)8路的方式合成,是一種典型的二進制功率合成方式。主要對第二級的4路驅動進行熱分析。
本例中器件的特性就是其導熱特性不同:上層金屬的K值設為0.003 W/umK,下層GaAs襯底的導熱系數(shù)隨溫度的變化而變化:k(T)=568.73T-1.23 W/cmK,需要輸入不同溫度下的K值,其中K為熱力學溫度,經(jīng)計算,在60 ℃、80 ℃、100 ℃、120 ℃、140 ℃、160 ℃溫度下,導熱系數(shù)如表1所示。

由于Ansys是有限元分析軟件,所以需要將無限元實體網(wǎng)格化,以生成有限元實體。而且在網(wǎng)格化(Mesh)時應指定上下層的不同屬性材料。另外,由于內存容量的限制以及關心的是襯底溫度,尤其是金屬層附近的溫度,所以采用“整體粗糙+局部細化”的方法,得到網(wǎng)格模型。
通過對晶體管溝道溫度的仿真,由圖2可以看到,溝道最高溫度為170 ℃,高于晶體管工作的最高溫度150 ℃,經(jīng)過查閱相關資料,找到了可以讓場效應管正常工作方法。

2.3 封裝結構模型
目前已出現(xiàn)了多種新型的芯片封裝連接技術,它們從高可靠性、高導電率和良好的熱傳導性能等諸多方面體現(xiàn)出強大的優(yōu)勢。在功率電子封裝中,新出現(xiàn)的納米銀焊膏低溫燒結連接技術就是一個典型的代表,相比于以往的連接形式(如引線鍵合等和連接材料(釬焊等)),在結構上更簡單,在導電導熱等方面顯示出更好的性能。運用ANSYS有限元分析軟件,針對芯片-粘接材料-基板這一基本結構進行分析。
在實際的封裝中,基板的形狀和型式多種多樣,在熱分析中只需考慮粘接層附近一定區(qū)域內的情況,因此可將基板簡化為一個長方形薄板以簡化熱分析過程。此外,在實際情況中,芯片-粘接層-基板這一基本結構的基板下面會裝有散熱裝置(如熱沉、散熱器等)來轉移其工作過程中產生的熱量。對封裝結構簡化為如圖3所示的基本模型進行熱分析,其中在基板層和芯片層之間有一層很薄的粘結層,在基板下表面施加較大的空氣對流系數(shù)來模擬相應的散熱裝置所能夠達到的散熱效果。進行基本熱分析時主要考慮芯片-粘接層-基板這一熱傳導路徑。

2.4 對封裝模型的分析和仿真
芯片尺寸為:3 mm×2.7 mm×0.1 mm,納米銀層尺寸為:7.2 mm×2.7 mm×0.14 mm,銅(Cu)基板層尺寸:10.8 mm×6.8 mm×0.46 mm。周圍環(huán)境溫度假設為20 ℃(初始溫度為20 ℃)。有限元分析中,在空氣自然對流條件下,對流系數(shù)為20 W/m2·K。


溫度仿真如圖4,從對芯片封裝后溫度仿真可以看到,芯片最高溫度是37 ℃,可以滿足芯片正常工作,解決了由于溫度過高影響晶體管工作性能、減小工作壽命的問題。

參考文獻
[1] REMSBURG R.Thermal design of electronic equipment.New York:CRC,2001.
[2] JAEGER J C,CARSLAW H S.Conduction of heat in solids,2nded.Oxford,U.K.:Oxford Univ.Press,1959.
[3] Ansys CFD Flotran Analysis Guide.ANSYS Inc.1995.
[4] 唐興倫.ANSYS工程應用教程-熱與電磁學篇[M]北京: 鐵道出版社,2003.

