芯片制造技術(shù)的高精密化已經(jīng)成為摩爾定律持續(xù)發(fā)展的關(guān)鍵。在半導(dǎo)體產(chǎn)業(yè)鏈中,技術(shù)創(chuàng)新和迭代的推動(dòng)力正在從設(shè)計(jì)、制造向封裝測(cè)試延伸。作為芯片制造的后道工序,封裝向中道擴(kuò)展,其價(jià)值早已不是簡(jiǎn)單的“對(duì)晶圓進(jìn)行切割、焊線塑封,使集成電路與外部器件實(shí)現(xiàn)電氣連接、信號(hào)連接的同時(shí),對(duì)集成電路提供物理、化學(xué)保護(hù)”的基本定義。
全球市場(chǎng)規(guī)模穩(wěn)定增長(zhǎng)
這一價(jià)值驅(qū)動(dòng)的趨勢(shì)在全球相關(guān)市場(chǎng)規(guī)模中得到體現(xiàn)。過(guò)去幾年,全球封測(cè)市場(chǎng)一直保持著平穩(wěn)的增長(zhǎng)。單就OSAT(封測(cè)代工)而言,2011年,全球相關(guān)市場(chǎng)規(guī)模為455億美元,到2020年,增長(zhǎng)到594億美元,2012~2020 年封測(cè)市場(chǎng)規(guī)模的CAGR為3.0%;如果加上IDM,2019年全球封測(cè)市場(chǎng)規(guī)模已達(dá)680億美元,預(yù)計(jì)到2025年市場(chǎng)規(guī)模可達(dá)850億美元,2020~2025年的CAGR有望達(dá)到4%。

全球OSTA前25營(yíng)收統(tǒng)計(jì)
來(lái)源:Yole Developpement
2020年,全球OSAT營(yíng)收337億美元,按企業(yè)所屬地理區(qū)域劃分,中國(guó)臺(tái)灣地區(qū)占比最高,達(dá)52%,其后依次是中國(guó)大陸21%,美國(guó)15%,韓國(guó)6%,馬來(lái)西亞3%,新加坡2%,日本1%。

全球OSAT營(yíng)收區(qū)域排名
來(lái)源:與非研究院
就業(yè)務(wù)占比看,封裝環(huán)節(jié)占據(jù)封測(cè)價(jià)值量的絕大部分,占整個(gè)封測(cè)市場(chǎng)份額的80~85%,測(cè)試環(huán)節(jié)占整個(gè)封測(cè)市場(chǎng)份額約15~20%。
其中,傳統(tǒng)封裝的市場(chǎng)營(yíng)收增長(zhǎng)穩(wěn)健,預(yù)計(jì)到2026年達(dá)到500億美元,CAGR(2020年~2026年)為4.3%,屆時(shí)全球總體封裝市場(chǎng)營(yíng)收將達(dá)到954億美元,CAGR為6%。
雖然,傳統(tǒng)封裝依然是業(yè)務(wù)主力,但下游應(yīng)用端如手機(jī)、HPC、5G、AI等對(duì)高算力、高集成化芯片的需求提升使得先進(jìn)封裝技術(shù)成為未來(lái)的發(fā)展趨勢(shì)。例如英偉達(dá)的 GPU采用臺(tái)積電的CoWoS 2.5D先進(jìn)封裝技術(shù);AMD在中高端CPU/GPU領(lǐng)域市占率不斷提升的同時(shí),已推出5nm制程Zen-4架構(gòu)新產(chǎn)品,對(duì)FCBGA、FCPGA、FCLGA等倒裝封裝以及2.5/3D等先進(jìn)封裝的需求旺盛。
先進(jìn)封裝成為趨勢(shì)
這一趨勢(shì)的動(dòng)因在于芯片的日趨復(fù)雜,以及在突破摩爾定律上的各種努力。當(dāng)前,異構(gòu)集成已經(jīng)成為半導(dǎo)體創(chuàng)新的關(guān)鍵,先進(jìn)封裝可以提高半導(dǎo)體產(chǎn)品的價(jià)值,增加功能,維持和提高性能,同時(shí)降低成本。而針對(duì)消費(fèi)市場(chǎng),提高性能和個(gè)性化應(yīng)用的SiP封裝也正在加快應(yīng)用。
2020年,全球先進(jìn)封裝市場(chǎng)的營(yíng)收達(dá)300億美元,到2026年將達(dá)到475億美元,CAGR為7.4%。與此同時(shí),先進(jìn)封裝在整個(gè)半導(dǎo)體封裝市場(chǎng)中的占有率也在不斷增加,到2026年,市占率將接近50%。在此期間,3D堆疊, ED和扇出型封裝(Fan Out,F(xiàn)O)將成為增長(zhǎng)主力, CAGR分別為22%, 25%和15%。Yole預(yù)計(jì),全球FO封裝市場(chǎng)規(guī)模到2026年將從2020年的14.75億美元增長(zhǎng)到34.25億美元,CAGR達(dá)15.1%。

先進(jìn)封裝市場(chǎng)規(guī)模高速增長(zhǎng)
來(lái)源:Yole Developpement
隨著先進(jìn)封裝技術(shù)向更高密度發(fā)展,高密度先進(jìn)互聯(lián)成為重要課題,TSV技術(shù),UBM/RDL等互連技術(shù)被更多地使用。且隨著TSV孔尺寸向亞微米發(fā)展、封裝節(jié)距尺寸以及L/S越來(lái)越小,對(duì)先進(jìn)封裝設(shè)備在更小線寬處理、顆粒控制、工藝精度控制、自動(dòng)化等方面提出了更高的要求,這使得原本是后道工序的封裝向中道靠近,進(jìn)而封測(cè)行業(yè)的分工發(fā)生了變化。
目前,從先進(jìn)封裝業(yè)務(wù)營(yíng)收的市占率看,以TSMC為代表的晶圓代工廠優(yōu)勢(shì)明顯。

先進(jìn)封裝市場(chǎng)晶圓代工廠競(jìng)爭(zhēng)優(yōu)勢(shì)明顯
來(lái)源:Yole Developpement
毫無(wú)疑問(wèn),高精密芯片封測(cè)技術(shù)已經(jīng)扛起了后摩爾時(shí)代產(chǎn)業(yè)發(fā)展大旗,芯片制造技術(shù)正在從先進(jìn)封裝邁入高精密封測(cè)技術(shù)革新時(shí)代,高端系統(tǒng)級(jí)應(yīng)用正在推動(dòng)高精密封測(cè)同設(shè)計(jì)、材料、設(shè)備、晶圓制造等上下游產(chǎn)業(yè)鏈的深度技術(shù)協(xié)作。
在這一過(guò)程中,一些創(chuàng)新技術(shù)也開始導(dǎo)入,例如利用原生創(chuàng)新的深度學(xué)習(xí)技術(shù)擴(kuò)展工業(yè)視覺(jué)檢測(cè)的邊界,以克服先進(jìn)封裝技術(shù)的快速迭代和工藝變化對(duì)良率控制和檢測(cè)技術(shù)帶來(lái)的挑戰(zhàn)。
投資不斷加碼
先進(jìn)封裝創(chuàng)造了豐厚的利潤(rùn),OSAT和晶圓代工廠都在加大相關(guān)研發(fā)、產(chǎn)能和投資的投入。2020年,OSAT的資本支出同比增長(zhǎng)了27%,約為60億美元。異構(gòu)集成的主要競(jìng)爭(zhēng)者,如ASE、TSMC、英特爾、Amkor和長(zhǎng)電科技,都在過(guò)去兩年進(jìn)行了前所未有的投資。
2021年,ASE拿出20億美元,專門投資于通過(guò)EMS活動(dòng)蓬勃發(fā)展的系統(tǒng)級(jí)封裝業(yè)務(wù),以及其晶圓級(jí)封裝業(yè)務(wù)。ASE提高了SiP方案在設(shè)計(jì)與制造服務(wù)中的比例,加大利用埋置式基板(Embedded substrate)及FO技術(shù)使封裝產(chǎn)品輕薄短小并具備低熱阻、高可靠度功能的研發(fā)。華為海思的Hi1382就選擇了ASE的 FO CoS15封裝技術(shù)。
TSMC的先進(jìn)封裝業(yè)務(wù)在2020年創(chuàng)造了約36億美元的收入。該公司2021年對(duì)SoIC, SoW和InFO以及CoWoS產(chǎn)品線特別設(shè)計(jì)的先進(jìn)封裝業(yè)務(wù)的資本支出為28億美元。2022年預(yù)計(jì)將投入42~44億美元,擴(kuò)充先進(jìn)封裝的產(chǎn)能。
英特爾對(duì)各種先進(jìn)封裝組合的投資,如Foveros, EMIB, Co-EMIB,是其實(shí)施IDM2.0戰(zhàn)略的關(guān)鍵。該公司在亞利桑那州和俄勒岡州的工廠擴(kuò)大了Foveros/EMIB“混合”封裝制造,實(shí)現(xiàn)管芯到管芯的互連,并在與TSMC SoIC產(chǎn)品線的競(jìng)爭(zhēng)中加速混合鍵合的進(jìn)程。
三星也正在積極投資先進(jìn)封裝技術(shù),以促進(jìn)其代工業(yè)務(wù),與TSMC競(jìng)爭(zhēng)。

異構(gòu)集成主要玩家正在加大投資
來(lái)源:Yole Developpement
除了直接的投入,資本并購(gòu)也是一個(gè)主旋律。例如2015年長(zhǎng)電科技收購(gòu)全球第四大封測(cè)廠星科金朋;2016年Amkor收購(gòu)J-Devices、通富微電收購(gòu)AMD蘇州;2017年ASE收購(gòu)矽品電子;2019年華天科技收購(gòu)馬來(lái)西亞封測(cè)廠商Unisem;2020年智路資本收購(gòu)新加坡UTAC,2021年收購(gòu)了力成新加坡凸塊業(yè)務(wù),同年又收購(gòu)了ASE在中國(guó)國(guó)內(nèi)的4家封測(cè)廠。通過(guò)收購(gòu),全球封測(cè)產(chǎn)業(yè)的集中度進(jìn)一步提高,而中國(guó)國(guó)內(nèi)的封測(cè)產(chǎn)業(yè)發(fā)展也進(jìn)入到一個(gè)新的增長(zhǎng)周期。
國(guó)內(nèi)產(chǎn)業(yè)迎來(lái)拐點(diǎn)
目前,國(guó)內(nèi)的封裝業(yè)主要以傳統(tǒng)封裝產(chǎn)品為主,不過(guò),近幾年通過(guò)并購(gòu),國(guó)內(nèi)廠商已經(jīng)快速積累起先進(jìn)封裝技術(shù),實(shí)力已經(jīng)基本和前沿趨勢(shì)同步,BGA、TVS、WLCSP、SiP等先進(jìn)封裝技術(shù)已經(jīng)實(shí)現(xiàn)量產(chǎn)。當(dāng)然,從營(yíng)收貢獻(xiàn)看,目前先進(jìn)封裝營(yíng)收占比在國(guó)內(nèi)封裝廠相較于中國(guó)臺(tái)灣和美國(guó)廠商還存在差距。按市占率看,全球排名前十的封裝測(cè)試企業(yè)中,中國(guó)臺(tái)灣5家公司的市占率為44.1%;中國(guó)大陸3家公司市占率僅為20.1%。
當(dāng)然,國(guó)內(nèi)封測(cè)市場(chǎng)規(guī)模的增長(zhǎng)持續(xù)高于全球水平。據(jù)中國(guó)半導(dǎo)體行業(yè)協(xié)會(huì)數(shù)據(jù),國(guó)內(nèi)封測(cè)市場(chǎng)規(guī)模由2011 年的975.7億元增長(zhǎng)至2020年的2509.5億元,2012~2020年,中國(guó)大陸封測(cè)市場(chǎng)規(guī)模CAGR約為11.1%,增速明顯高于同期全球水平。
這也反映出全球半導(dǎo)體產(chǎn)業(yè)分工的變化,當(dāng)前,國(guó)內(nèi)已經(jīng)成為全球半導(dǎo)體產(chǎn)能第三次轉(zhuǎn)移的主要地區(qū),晶圓廠建設(shè)迎來(lái)高峰期,因而帶動(dòng)了下游封裝測(cè)試市場(chǎng)的發(fā)展。2021年前三季度集成電路封裝測(cè)試行業(yè)的營(yíng)收和凈利潤(rùn)分別617.61億元和57.01億元,同比增長(zhǎng)分別為31.20%和113.01%,利潤(rùn)率持續(xù)提升的同時(shí)也提高了國(guó)內(nèi)封測(cè)產(chǎn)業(yè)的話語(yǔ)權(quán)。
綜觀國(guó)內(nèi)的半導(dǎo)體產(chǎn)業(yè)鏈,封測(cè)是其中與國(guó)際領(lǐng)先水平差距最小的板塊,2004~2015年在國(guó)內(nèi)半導(dǎo)體產(chǎn)業(yè)鏈環(huán)節(jié)中價(jià)值量占比最高,2020年占國(guó)內(nèi)半導(dǎo)體行業(yè)市場(chǎng)規(guī)模的28.4%。目前,國(guó)內(nèi)半導(dǎo)體產(chǎn)業(yè)鏈中設(shè)計(jì)、制造、封測(cè)的市場(chǎng)規(guī)模占比正逐步趨向于國(guó)際上3:4:3的平均水平,產(chǎn)業(yè)結(jié)構(gòu)趨于平衡。隨著國(guó)內(nèi)半導(dǎo)體產(chǎn)業(yè)鏈結(jié)構(gòu)性改善的推進(jìn),IC設(shè)計(jì)、制造與封測(cè)的協(xié)同效應(yīng)開始顯現(xiàn),封測(cè)行業(yè)發(fā)展有望提速。
據(jù)與非研究院統(tǒng)計(jì),目前國(guó)內(nèi)本土提供半導(dǎo)體封測(cè)服務(wù)的相關(guān)企業(yè)約99家(截止2021年),主要分布在江蘇(31家)、廣東(23家)和上海(11家)地區(qū)。文末附本土半導(dǎo)體封測(cè)企業(yè)名錄。

國(guó)內(nèi)本土半導(dǎo)體封測(cè)服務(wù)相關(guān)企業(yè)分布
來(lái)源:與非研究院
如前文分析,通過(guò)并購(gòu),國(guó)內(nèi)本土封測(cè)企業(yè)已完成對(duì)主要先進(jìn)封裝工藝的全覆蓋,包括晶圓級(jí)封裝、系統(tǒng)級(jí)封裝(SiP)、倒裝封裝(FC)、2.5D/3D 封裝等,實(shí)現(xiàn)技術(shù)協(xié)同。目前,國(guó)內(nèi)非本土封測(cè)企業(yè)主要是ASE、Amkor、力成、京元、南茂和頎邦,本土龍頭企業(yè)包括長(zhǎng)電科技、通富微電、華天和晶方。
其中,長(zhǎng)電科技在晶圓級(jí)、2.5/3D等封裝技術(shù)方面處于行業(yè)領(lǐng)先地位;通富微電在倒裝封裝、高端處理器封測(cè)領(lǐng)域居領(lǐng)先地位。而一些新進(jìn)的封測(cè)企業(yè)也主攻高端IC的封裝和測(cè)試,例如卷入挖角風(fēng)波的甬矽電子。
本土企業(yè)在提高技術(shù)協(xié)同能力的同時(shí),也已在海外進(jìn)行產(chǎn)能布局,例如長(zhǎng)電星科金朋、通富檳州、華天 Unisem等子公司的主要產(chǎn)能都在海外。
發(fā)展機(jī)遇和挑戰(zhàn)
一方面,國(guó)內(nèi)本土的封測(cè)廠商通過(guò)資本并購(gòu)實(shí)現(xiàn)了技術(shù)協(xié)同、市場(chǎng)整合和產(chǎn)能規(guī)模的擴(kuò)張,另一方面,產(chǎn)業(yè)宏觀生態(tài)環(huán)境的變化也給本土封測(cè)廠商創(chuàng)造了發(fā)展機(jī)遇。
這個(gè)宏觀生態(tài)環(huán)境有兩個(gè)重點(diǎn):一是AI、5G、 HPC、汽車電子、智能可穿戴設(shè)備等新興應(yīng)用端帶來(lái)了強(qiáng)勁的半導(dǎo)體產(chǎn)品市場(chǎng)的需求,其增量為國(guó)內(nèi)封測(cè)產(chǎn)業(yè)提供了增長(zhǎng)空間;二是國(guó)內(nèi)半導(dǎo)體產(chǎn)業(yè)正處于以“自主可控”為重心的發(fā)展周期,這部分增量需求必將進(jìn)一步催化本土封測(cè)產(chǎn)業(yè)的發(fā)展。
雖然發(fā)展可期,但本土封測(cè)產(chǎn)業(yè)也面臨諸多挑戰(zhàn)。
首先是技術(shù)協(xié)同,如前文分析,先進(jìn)封裝已經(jīng)成為未來(lái)主導(dǎo)競(jìng)爭(zhēng)力的關(guān)鍵,并且已經(jīng)改變了封測(cè)行業(yè)的分工。總體而言, 傳統(tǒng)屬于OSAT和IDM領(lǐng)域的封裝業(yè)務(wù)已經(jīng)被晶圓代工廠、基板廠所滲透,先進(jìn)封裝正在向原本是前道的代工廠轉(zhuǎn)移并為之所導(dǎo)。例如TSMC的InFO、CoWoS,基板廠AT&S、ACEESS的ECP技術(shù)等。
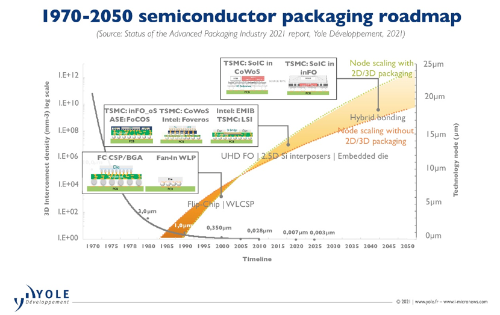
封裝技術(shù)演進(jìn)路線
來(lái)源:Yole Developpement
目前,高性能芯片工藝用到的TSV、3D、熔融鍵合和混合鍵合等技術(shù),主要都掌握在晶圓代工廠,原因在于其掌握設(shè)備能力并主導(dǎo)制程工藝。原本,封測(cè)廠和代工廠之間是合作關(guān)系,可以互通完整的晶圓級(jí)設(shè)計(jì),OSAT長(zhǎng)期以來(lái)一直集成來(lái)自多個(gè)不同供應(yīng)商的裸片,因?yàn)樗鼈儾槐灰暈榇じ?jìng)爭(zhēng)對(duì)手。但當(dāng)代工廠也開始進(jìn)行封裝業(yè)務(wù),并且是主導(dǎo)性的先進(jìn)封裝,那無(wú)疑會(huì)改變?cè)镜暮献麝P(guān)系,而封測(cè)廠在技術(shù)協(xié)同上必將面臨這種情況帶來(lái)的挑戰(zhàn)。
不過(guò),存儲(chǔ)的情況比較特別,如果把存儲(chǔ)放進(jìn)來(lái)看,國(guó)內(nèi)在先進(jìn)封裝上的發(fā)展另有支撐。從市場(chǎng)規(guī)模看,2020年全球存儲(chǔ)器封裝市場(chǎng)的總價(jià)值為131億美元,到2026年增長(zhǎng)到198億美元,CAGR約7%。

全球存儲(chǔ)封裝市場(chǎng)營(yíng)收
來(lái)源:Yole Developpement
不同于價(jià)格波動(dòng)劇烈的獨(dú)立存儲(chǔ)器市場(chǎng),存儲(chǔ)器封裝市場(chǎng)更加穩(wěn)定,因?yàn)榇蟛糠謽I(yè)務(wù)都是IDM在其內(nèi)部進(jìn)行的。Yole統(tǒng)計(jì),2020年全球大約68%的存儲(chǔ)器封裝收益由IDM廠商產(chǎn)生,其余32%由OSAT產(chǎn)生。

2020-2026內(nèi)存封裝市場(chǎng)收入:IDM vs OSAT
來(lái)源:Yole Developpement
但中國(guó)的情況不同。中國(guó)正在加快國(guó)產(chǎn)存儲(chǔ)器的發(fā)展,長(zhǎng)江存儲(chǔ)(NAND)和長(zhǎng)鑫存儲(chǔ)(DRAM)正在加大各自的的晶圓產(chǎn)量。但這兩家廠商沒(méi)有成熟的內(nèi)部封裝能力,必須將所有封裝外包給OSAT。基于倒裝芯片封裝的DRAM和基于3D堆疊技術(shù)的NAND的增長(zhǎng)為封裝企業(yè)帶來(lái)了機(jī)遇,可以說(shuō),存儲(chǔ)器封裝是本土OSAT廠商先進(jìn)封裝業(yè)務(wù)的關(guān)鍵商機(jī)。
根據(jù)Yole的測(cè)算,中國(guó)存儲(chǔ)器制造商為OSAT帶來(lái)的收益可能從2020年的不到1億美元增長(zhǎng)到2026年的約11億美元。這相當(dāng)于2020年至2026年間的CAGR為55%。針對(duì)這一獨(dú)特商機(jī),國(guó)內(nèi)三大主要廠商長(zhǎng)電科技、通富微電和華天都已經(jīng)有所布局。
除了技術(shù)協(xié)同的挑戰(zhàn),設(shè)備和材料也面臨不小的挑戰(zhàn)。目前國(guó)內(nèi)先進(jìn)封裝工藝所對(duì)應(yīng)的高端封裝測(cè)試設(shè)備和材料均為進(jìn)口。隨著地緣政治對(duì)國(guó)內(nèi)半導(dǎo)體產(chǎn)業(yè)環(huán)境負(fù)面影響的加劇,國(guó)內(nèi)產(chǎn)業(yè)鏈各環(huán)節(jié)之間互相支持,驗(yàn)證并使用國(guó)產(chǎn)設(shè)備和材料,以克服外圍不利因素,都不會(huì)是短期內(nèi)能夠跨越的障礙。
最后也是最關(guān)鍵的,還是人才。目前武漢、合肥、廈門、南京、成都、重慶、西安等地均在大力推進(jìn)集成電路產(chǎn)業(yè)發(fā)展,人才供給面臨緊缺,尤其是高端人才。本土封測(cè)行業(yè)人才的引進(jìn)、培養(yǎng)和留用還任重道遠(yuǎn)。需要政府,學(xué)校和企業(yè),從人才的選、育、用、留方面,從制度到政策給予全方面的支持。
結(jié)語(yǔ)
半導(dǎo)體產(chǎn)業(yè)已經(jīng)進(jìn)入后摩爾定律時(shí)代,芯片特征尺寸已接近物理極限,封測(cè)中道的崛起已成為延續(xù)摩爾定律的必然選澤。圍繞這一選擇,顛覆性的技術(shù)創(chuàng)新將成為驅(qū)動(dòng)產(chǎn)業(yè)向前發(fā)展的關(guān)鍵。
未來(lái)十年,集成電路將主要通過(guò)異質(zhì)異構(gòu)系統(tǒng)集成來(lái)提升密度和性能,實(shí)現(xiàn)功耗的降低,以及集成更多的功能。在這一過(guò)程中,先進(jìn)封測(cè)技術(shù)成為整個(gè)行業(yè)的熱點(diǎn),對(duì)國(guó)內(nèi)封測(cè)的上下游產(chǎn)業(yè)鏈而言,既有機(jī)遇也更有挑戰(zhàn)。
作為芯片設(shè)計(jì)、制造、封測(cè)三大板塊中與國(guó)際先進(jìn)水平差距最小的行業(yè),國(guó)內(nèi)封測(cè)產(chǎn)業(yè)在經(jīng)過(guò)并購(gòu)潮之后,其發(fā)展的內(nèi)生動(dòng)力已經(jīng)從規(guī)模擴(kuò)張向自主技術(shù)創(chuàng)新、技術(shù)協(xié)同,以及國(guó)際生態(tài)建設(shè)等轉(zhuǎn)移。而基于國(guó)家產(chǎn)業(yè)政策的支持,地緣政治變化影響下的產(chǎn)業(yè)機(jī)遇催化,以及半導(dǎo)體產(chǎn)業(yè)發(fā)展周期規(guī)律等因素,與非研究院認(rèn)為,國(guó)內(nèi)整個(gè)半導(dǎo)體產(chǎn)業(yè)鏈中,封測(cè)產(chǎn)業(yè)將率先實(shí)現(xiàn)從“跟隨”到“同步”。
附錄:本土半導(dǎo)體封測(cè)服務(wù)企業(yè)名錄





