眾所周知,目前5nm及以下的尖端半導(dǎo)體制程必須要用到價(jià)格極其高昂的EUV光刻機(jī),ASML是全球唯一的供應(yīng)商。而更為尖端2nm制程的則需要用到ASML新一代0.55 NA EUV光刻機(jī),售價(jià)或高達(dá)4億美元。英特爾正計(jì)劃利用新一代0.55 NA EUV光刻機(jī)來(lái)開發(fā)其Intel 20A(2nm)及18A(1.8nm)制程。但是,要想實(shí)現(xiàn)1nm以下的更先進(jìn)的制程,即便是ASML新一代0.55 NA EUV光刻機(jī)也束手無(wú)策。
近日,美國(guó)一家旨在開發(fā)和商業(yè)化原子精密制造 (APM) 技術(shù)的公司Zyvex宣布推出了全球分辨率最高的亞納米分辨率光刻系統(tǒng)“ZyvexLitho1”,其并沒有采用EUV光刻技術(shù),而是基于STM掃描隧道顯微鏡,使用的是電子束光刻(EBL)方式,可以制造出具有0.768nm線寬(相當(dāng)于2個(gè)硅原子的寬度)的芯片,精度遠(yuǎn)超EUV光刻機(jī),是當(dāng)前制造精度最高的光刻系統(tǒng)。
這個(gè)光刻機(jī)制造出來(lái)的芯片主要是用于量子計(jì)算機(jī),可以制造出高精度的固態(tài)量子器件,以及納米器件及材料,對(duì)量子計(jì)算機(jī)來(lái)說(shuō)精度非常重要。
Zyvex是致力于生產(chǎn)原子級(jí)精密制造工具的納米技術(shù)公司。這個(gè)產(chǎn)品是在DARPA(國(guó)防高級(jí)研究計(jì)劃局)、陸軍研究辦公室、能源部先進(jìn)制造辦公室和德克薩斯大學(xué)達(dá)拉斯分校的Reza Moheimani教授的支持下完成的,被國(guó)際自動(dòng)控制聯(lián)合會(huì)授予工業(yè)成就獎(jiǎng)。
氫去鈍化光刻(HDL):實(shí)現(xiàn)更高的分辨率和精度
氫去鈍化光刻(HDL)是電子束光刻(EBL)的一種形式,它通過(guò)非常簡(jiǎn)單的儀器實(shí)現(xiàn)原子分辨率,并使用能量非常低的電子。它使用量子物理學(xué)有效地聚焦低能電子和振動(dòng)加熱方法,以產(chǎn)生高度非線性(多電子)的曝光機(jī)制。HDL使用附著在硅表面的單層H原子作為非常薄的抗蝕劑層,并使用電子刺激解吸在抗蝕劑中創(chuàng)建圖案。
傳統(tǒng)EBL使用大型昂貴的電子光學(xué)系統(tǒng)和非常高的能量(200Kev)來(lái)實(shí)現(xiàn)小光斑尺寸;但是高能電子(獲得小光斑尺寸所必需的)分散在傳統(tǒng)EBL使用的聚合物抗蝕劑中,并分散沉積的能量,從而形成更大的結(jié)構(gòu)。HDL實(shí)現(xiàn)了比傳統(tǒng)EBL更高的分辨率和精度。
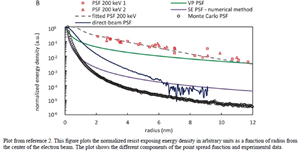
數(shù)據(jù)顯示,光刻膠中的沉積能量不會(huì)下降到光束中心的10%,直到徑向距離約為4nm。
使用HDL,實(shí)驗(yàn)團(tuán)隊(duì)能夠暴露比EBL的10%閾值半徑小>10倍的單個(gè)原子。這個(gè)小得多的曝光區(qū)域令人驚訝,因?yàn)镠DL不使用光學(xué)器件,只是將鎢金屬尖端放置在H鈍化硅樣品上方約1nm處。人們會(huì)期望,如果沒有光學(xué)器件來(lái)聚焦來(lái)自尖端的電子,那么曝光區(qū)域會(huì)更大。
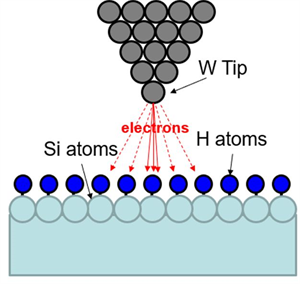
距H鈍化硅表面約1nm的W掃描隧穿顯微鏡(STM)尖端
電子似乎不太可能只遵循暴露單個(gè)H原子所需的實(shí)心箭頭路徑。為了解決這個(gè)謎團(tuán),必須了解電子實(shí)際上不是從尖端發(fā)射(在成像和原子精密光刻模式下),而是從樣品到尖端(在成像模式下)或從尖端到樣品(在光刻模式下)模式。使用具有無(wú)限平坦和導(dǎo)電襯底的簡(jiǎn)單模型、STM尖端頂點(diǎn)處單個(gè)W原子的發(fā)射以及簡(jiǎn)化的隧穿電流模型,我們將看到電流隨著隧穿距離呈指數(shù)下降。
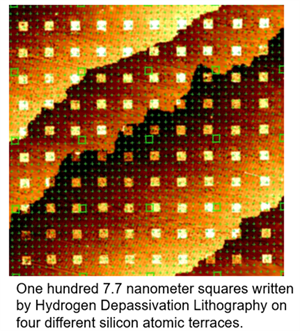
ZyvexLitho1的五大特色功能
ZyvexLitho1 系統(tǒng)基于 Zyvex Labs 自 2007 年以來(lái)一直在完善的掃描隧道顯微鏡 (STM) 技術(shù),配備了低噪聲、低延遲的20位數(shù)字控制系統(tǒng),允許用戶為固態(tài)量子器件和其他納米器件和材料創(chuàng)建原子精度的圖案。ZyvexLitho1套件還包括配置用于構(gòu)建量子器件的 ScientaOmicron 超高真空 STM(掃描隧穿顯微鏡)。這也使得ZyvexLitho1系統(tǒng)具備其他任何商業(yè)掃描隧道顯微鏡不具備的功能和自動(dòng)化功能,包括:能夠?qū)崿F(xiàn)無(wú)失真成像、自適應(yīng)電流反饋回路、自動(dòng)晶格對(duì)準(zhǔn)、數(shù)字矢量光刻、自動(dòng)化腳本和內(nèi)置計(jì)量。
現(xiàn)在下單,6個(gè)月后即可交貨
需要強(qiáng)調(diào)的是,ZvyvexLitho1系統(tǒng)并不是一款實(shí)驗(yàn)室原型產(chǎn)品,而是一款已經(jīng)可以商用的產(chǎn)品。根據(jù)Zyvex Labs官網(wǎng)介紹,目前其正在接受 ZvyvexLitho1 系統(tǒng)的訂單,交貨時(shí)間約為六個(gè)月。
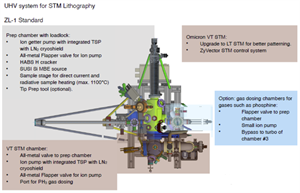
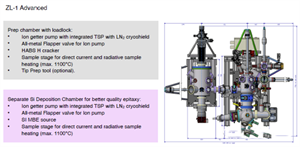
據(jù)悉,ZvyvexLitho1將會(huì)有標(biāo)準(zhǔn)版和高級(jí)版兩個(gè)不同版本,具體售價(jià)未知。
EBL能取代傳統(tǒng)光刻嗎?
所謂光刻,是芯片制造中的一種圖案化工藝。該過(guò)程涉及將圖案從光掩模轉(zhuǎn)移到基板。這主要是使用配備有光學(xué)光源的步進(jìn)器和掃描儀來(lái)完成的,這也是我們現(xiàn)在主流的芯片制造方式,大家熟悉的EUV和DUV就是使用這種方式的。
其他形式的光刻包括直寫電子束(direct-write e-beam)和納米壓印( nanoimprint)。在研發(fā)中還有幾種下一代光刻(NGL)技術(shù)——如多光束電子束和定向自組裝(DSA)。
據(jù)美國(guó)NIST方面介紹,電子束光刻允許精細(xì)控制納米結(jié)構(gòu)特征,這些特征構(gòu)成多種器件技術(shù)的基礎(chǔ)。讓10 nm 的橫向分辨率、1 nm 的放置精度和 1 mm 的圖案化區(qū)域都是可能的。然而,實(shí)現(xiàn)這些性能指標(biāo)取決于許多特定于樣品的相互依賴的因素——圖案定義和斷裂、基板和掩模材料、曝光前和曝光后工藝、對(duì)準(zhǔn)特征定義——以及關(guān)鍵的細(xì)節(jié)光刻系統(tǒng)的操作。
NIST表示,作為一項(xiàng)核心能力,其開發(fā)的工藝處于或接近傳統(tǒng)電子束光刻技術(shù)的極限,以推進(jìn)各個(gè)領(lǐng)域的納米級(jí)設(shè)備和測(cè)量科學(xué),例如:用于精確計(jì)時(shí)的芯片級(jí)頻率梳;用于波長(zhǎng)和量子頻率轉(zhuǎn)換的非線性集成光學(xué);用于傳感、轉(zhuǎn)換和非線性動(dòng)力學(xué)研究的片上腔光機(jī)械和微/納米機(jī)電系統(tǒng);具有用于量子信息的非線性和量子發(fā)射器光源的量子光子集成電路;從紫外到紅外的超表面,用于捕獲和探測(cè)原子和離子、偏振測(cè)量、成像和時(shí)空超快激光脈沖整形;用于像差校正的光學(xué)顯微鏡標(biāo)準(zhǔn)。
但正如很多報(bào)道中所說(shuō),其吞吐和準(zhǔn)確度,限制了EBL的發(fā)展。根據(jù)eBeam Initiative的一份調(diào)查顯示,使用類似電子書光刻這樣的直寫設(shè)備制作一份掩膜寫入時(shí)間大概在2.5到13個(gè)小時(shí)不等,其平均數(shù)在6.8個(gè)小時(shí)。根據(jù)該組織的報(bào)告,對(duì)于復(fù)雜掩膜而言,最長(zhǎng)寫入時(shí)間在14到60個(gè)小時(shí)。一般來(lái)說(shuō),制造商們對(duì)于寫入時(shí)間超過(guò)24個(gè)小時(shí)的掩膜設(shè)計(jì)方案會(huì)比較頭疼。因?yàn)檫^(guò)長(zhǎng)的寫入時(shí)間就意味著更高的成本,更長(zhǎng)的處理時(shí)間和良率問題。
總結(jié)來(lái)說(shuō),雖然EBL電子束光刻機(jī)的精度可以輕松超過(guò)EUV光刻機(jī),但是,這種技術(shù)的缺點(diǎn)也很明顯,那就是產(chǎn)量很低,無(wú)法大規(guī)模制造芯片,只適合制作那些小批量的高精度芯片或者器件,指望它們?nèi)〈鶨UV光刻機(jī)也不現(xiàn)實(shí)。
更多信息可以來(lái)這里獲取==>>電子技術(shù)應(yīng)用-AET<<


