芯片制造離不開光刻機(jī),且制程越先進(jìn),其重要性越凸出,占芯片制造總成本比例也越高,總體來(lái)看,光刻機(jī)的成本占總設(shè)備成本的30%。
當(dāng)制程發(fā)展到7nm后,必須要用到EUV(極紫外線)光刻機(jī),這種光刻機(jī)只有ASML能夠生產(chǎn),且產(chǎn)能有限,廠商們要買到,并不容易,且ASML要優(yōu)先供應(yīng)臺(tái)積電、三星、英特爾這三家股東。
難以逾越的EUV
EUV是一種曝光設(shè)備,它可以根據(jù)發(fā)出的光的種類減少工序數(shù)量并節(jié)省時(shí)間和金錢。現(xiàn)有的半導(dǎo)體材料氟化氬具有193nm的光波長(zhǎng)。波長(zhǎng)越短,可以雕刻出更精細(xì)的電路。使用氟化氬,以某種方式可以實(shí)現(xiàn)7nm的制程工藝。但在這之下就很難了。由于臺(tái)積電、三星等主要代工企業(yè)已達(dá)到5nm及以下的工藝,氟化氬曝光設(shè)備面臨限制。
EUV設(shè)備克服了這一限制。EUV的波長(zhǎng)為13.5nm,可以實(shí)現(xiàn)5nm以下的工藝。因此,全球生產(chǎn)先進(jìn)制程(10nm以下)的芯片代工企業(yè)都在努力引進(jìn) EUV 設(shè)備,這使得EUV供給非常緊張。如果有需求,可以通過(guò)增加供應(yīng)來(lái)平衡。然而,EUV設(shè)備開發(fā)難度很大,一年只能生產(chǎn)十幾臺(tái),ASML今年要生產(chǎn)的EUV設(shè)備數(shù)量約為40臺(tái)。這40臺(tái)被臺(tái)積電、三星電子和英特爾瓜分。2019年,EUV占ASML銷售額的31%,但到2020年,就占到了43%,成為最“賺錢”的產(chǎn)品線。
一臺(tái)EUV設(shè)備的高度可以達(dá)到4到5米,重量接近180噸。這樣的高科技設(shè)備,其中的零部件數(shù)量也是巨大的,大約有10萬(wàn)個(gè)。EUV設(shè)備曝光是在真空室中完成的。還需要以0.005℃為單位精細(xì)控制溫度的技術(shù)。由于光學(xué)系統(tǒng)對(duì)污染物非常敏感,因此還必須實(shí)時(shí)進(jìn)行內(nèi)部監(jiān)控。由于這些特點(diǎn),生產(chǎn)EUV設(shè)備并不容易。
EUV 設(shè)備的性能取決于鏡頭和反射鏡的分辨率。分辨率通常與鏡頭像差 (NA) 成正比。出于這個(gè)原因,努力增加 NA 是絕對(duì)必要的。當(dāng)NA值高時(shí),分辨率提高,光線變得更清晰,可以實(shí)現(xiàn)更精細(xì)的半導(dǎo)體電路。正是出于這個(gè)原因,ASML 收購(gòu)了全球光學(xué)公司蔡司的股份。
目前,EUV設(shè)備NA值為0.33。ASML 計(jì)劃通過(guò)研發(fā)將下一代 EUV 設(shè)備的 NA 提高到 0.55。這稱為高NA。高 NA 可最大限度地減少光失真并允許更精細(xì)的電路實(shí)現(xiàn)。ASML 計(jì)劃在 2023 年推出基于高數(shù)值孔徑的 EUV 設(shè)備原型。下一代EUV設(shè)備的開發(fā)有望進(jìn)一步鞏固其在微納制程半導(dǎo)體曝光設(shè)備市場(chǎng)的壟斷地位。
隨著半導(dǎo)體制造商將基礎(chǔ)設(shè)施轉(zhuǎn)向EUV設(shè)備,需求猛增,但供應(yīng)卻跟不上。即使有生產(chǎn)目標(biāo),不能按時(shí)交貨也是很常見的。即便是現(xiàn)在,如果要采購(gòu)ASML EUV設(shè)備,也要等上一年多。
通常,一臺(tái)EUV 設(shè)備的價(jià)格在1億至2億美元之間。雖然非常貴,但半導(dǎo)體廠商即使付出更多,也想盡快拿到EUV設(shè)備。
NIL比拼EUV
由于EUV設(shè)備太過(guò)昂貴,且生產(chǎn)難度很高,近些年,業(yè)界一直在尋找其它辦法,不用EUV光刻機(jī),能不能生產(chǎn)7nm及以下的芯片?事實(shí)上,也有廠商是這么想并打算這么干的,因?yàn)橥ㄟ^(guò)DUV光刻機(jī)進(jìn)行多重曝光,理論上也能達(dá)到7nm。但這種辦法非常復(fù)雜,對(duì)技術(shù)要求非常高,同時(shí)良率低,晶圓的損耗比較大,所以如果能夠買到EUV光刻機(jī),就不可能用這種辦法,這種辦法生產(chǎn)出來(lái)的芯片,完全沒(méi)有市場(chǎng)競(jìng)爭(zhēng)力。
納米壓印光刻 (NIL)、定向自組裝 (DSA) 和等離子激光等技術(shù)被認(rèn)為是EUV的替代品。NIL 是一種將納米圖案印章轉(zhuǎn)移到晶圓上的方法,就像它被涂漆一樣。它被提出作為一種繪制 32nm 以下電路的方法。它比 EUV 更經(jīng)濟(jì),因?yàn)樗皇褂苗R頭。佳能等廠商在 EUV 研發(fā)如火如荼的時(shí)候就開始開發(fā) NIL。
DSA是一種通過(guò)將具有不同特性的聚合物合成為單個(gè)分子,將其涂覆在晶圓上并加熱來(lái)獲得精細(xì)圖案的技術(shù)。由于不使用掩模,可以減少工藝數(shù)量,從而可以降低成本。然而,就所使用的技術(shù)而言,它不如 NIL。此外,無(wú)掩模等離子激光納米技術(shù)被認(rèn)為是一種替代方案,因?yàn)樗哂凶杂筛淖冸娐穲D案的能力。然而,它仍達(dá)不到 EUV的效果。
總體來(lái)看,NIL是一個(gè)不錯(cuò)的發(fā)展方向。
NIL技術(shù)比光刻的起步晚,最早追述到上個(gè)世紀(jì)末,由華裔科學(xué)家周郁(Stephen Chou)教授在1995年首次提出納米壓印概念。該技術(shù)將微電子加工工藝融合于印刷技術(shù)中,解決了光學(xué)曝光技術(shù)中光衍射現(xiàn)象造成的分辨率極限問(wèn)題,因此理論上具備比光刻更高的分辨率,可生產(chǎn)出電路線寬更窄的器件。除此之外,高效率、低成本、適合工業(yè)化生產(chǎn)等優(yōu)勢(shì),也使得NIL一直受到業(yè)界的重視,被稱為是微納加工領(lǐng)域中第三代最有前景的光刻技術(shù)之一。
NIL 基于機(jī)械復(fù)制,不受光學(xué)衍射的限制。它可以潛在地實(shí)現(xiàn)低于 5nm 的分辨率,并且以非常低的成本實(shí)現(xiàn)非常好的關(guān)鍵缺陷 (CD) 控制。由于其優(yōu)異的性能,NIL 可以滿足廣泛的半導(dǎo)體應(yīng)用。它可以大幅度降低光刻成本,可與EUV一戰(zhàn)。

圖:EUV與NIL的對(duì)比(來(lái)源:DIGITIMES)
據(jù)Yole統(tǒng)計(jì),NIL設(shè)備復(fù)合年增長(zhǎng)率將超過(guò) 20%,到 2024 年生產(chǎn)的年收入將達(dá)到約 1.45 億美元。目前,NIL主要用于增強(qiáng)現(xiàn)實(shí)、3D傳感和數(shù)據(jù)通信/電信中需要嚴(yán)格和復(fù)雜模式的光學(xué)光子元件。同時(shí),NIL工藝也引起了存儲(chǔ)器廠商的興趣,特別是20nm以下先進(jìn)制程,目前的光刻方案成本太高。因此,對(duì)于下一代 3D NAND 存儲(chǔ)器,NIL是非常有競(jìng)爭(zhēng)力的成本效益選擇。

NIL 供應(yīng)商在每個(gè)特征尺寸范圍內(nèi)都有一個(gè)明顯的領(lǐng)導(dǎo)者。在納米范圍內(nèi),EVG 占主導(dǎo)地位,尤其是在衍射光學(xué)元件 (DOE) 中。SUSS MicroTec 在微尺度范圍內(nèi)占據(jù)了強(qiáng)大的市場(chǎng)份額。
下面看一下NIL的技術(shù)細(xì)節(jié)。
一般情況下,NIL使用電子束刻蝕等手段,在襯底上加工出所需要的結(jié)構(gòu)作為模板。由于電子的衍射極限遠(yuǎn)小于光子,因此可以達(dá)到遠(yuǎn)高于光刻的分辨率。
NIL制造設(shè)備利用圖案化技術(shù),涉及現(xiàn)場(chǎng)/逐場(chǎng)/單次沉積和通過(guò)噴射技術(shù)沉積到基板上的低粘度抗蝕劑的曝光。帶圖案的掩模下降到流體中,然后通過(guò)毛細(xì)作用迅速流入掩模中的浮雕圖案。在此填充步驟之后,抗蝕劑在紫外線輻射下交聯(lián),然后去除掩模,在基板上留下圖案化抗蝕劑。
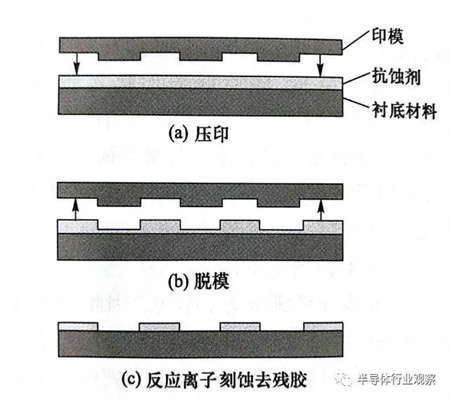
與EUV光刻設(shè)備產(chǎn)生的圖案相比,NIL以更高的分辨率和更高的均勻性忠實(shí)地再現(xiàn)圖案。此外,由于這項(xiàng)技術(shù)不需要先進(jìn)光刻設(shè)備所需的一系列寬直徑鏡頭和昂貴的光源,NIL 設(shè)備實(shí)現(xiàn)了更簡(jiǎn)單、更緊湊的設(shè)計(jì),允許將多個(gè)單元聚集在一起,以提高生產(chǎn)力。
研究已經(jīng)證明 NIL 分辨率優(yōu)于 10nm,使該技術(shù)適用于使用單個(gè)掩模打印幾代關(guān)鍵內(nèi)存級(jí)別。此外,僅在必要時(shí)才使用抗蝕劑,從而消除材料浪費(fèi)。鑒于壓印系統(tǒng)中沒(méi)有復(fù)雜的光學(xué)器件,當(dāng)與簡(jiǎn)單的單級(jí)處理和零浪費(fèi)相結(jié)合時(shí),工具成本的降低使其成本模型非常適用于半導(dǎo)體存儲(chǔ)器應(yīng)用。
DRAM 和相變存儲(chǔ)器等高級(jí)存儲(chǔ)器具有挑戰(zhàn)性,因?yàn)檫@些設(shè)備的路線圖要求持續(xù)縮放,達(dá)到14nm,甚至更先進(jìn)制程。縮放也會(huì)影響覆蓋預(yù)算。例如,對(duì)于 DRAM,某些關(guān)鍵層上的疊加比 NAND 閃存緊密得多,誤差預(yù)算為最小半間距的 15-20%。對(duì)于 14nm,這意味著 2.1nm - 2.8nm。DRAM 器件設(shè)計(jì)也具有挑戰(zhàn)性,并且布局并不總是有利于間距劃分方法,例如自對(duì)準(zhǔn)雙圖案化 (SADP) 和自對(duì)準(zhǔn)四重圖案化 (SAQP)。這使得直接印刷工藝NIL成為一種很有競(jìng)爭(zhēng)力的解決方案
NIL的進(jìn)展
日本存儲(chǔ)器大廠鎧俠(Kioxia)與佳能,以及光罩/半導(dǎo)體廠商大日本印刷株式會(huì)社(DNP),經(jīng)過(guò)了4年的研發(fā),于近期研發(fā)出了NIL的量產(chǎn)技術(shù)。
目前,鎧俠已將其應(yīng)用到了15nm的NAND閃存制造上,并表示到2025年應(yīng)該可以應(yīng)用到5nm的芯片制造上。
鎧俠表示,NIL 技術(shù)與EUV光刻技術(shù)相比,可以大幅度的減少能耗,轉(zhuǎn)化效率高,耗電量可壓低至EUV 技術(shù)的10%,同時(shí),NIL設(shè)備也很便宜,投資可降低至EUV光刻機(jī)的40%。
有專業(yè)人士指出,NIL技術(shù)也許能夠推進(jìn)芯片制程至5nm,但可能更適應(yīng)于NAND這種3D堆疊的閃存芯片,不一定適用于所有芯片。
合作廠商之一的佳能,則表示要努力將NIL 量產(chǎn)技術(shù)廣泛應(yīng)用于制造DRAM 及PC 用的CPU 等邏輯芯片的設(shè)備上。


